Cu CMP产生的缺陷
发布时间:2017/11/11 18:17:51 访问次数:2100
降低缺陷是CMP工艺,乃至整个芯片制造的永恒话题c随着器件特征K寸的不断缩、缺陷对于I艺控制和最终良率的影响愈发明形,致命缺陷的大小至少要求小于器件尺寸的50%。
金属残余物QAMI5516AUA
Cu CMP一个皋本的问题便是氧化硅介质上的金属残余物(residue),这会导致电学短路。这种金属残留主要是由于介质层的表面不平引起的,土一层铜抛光所产生的凹陷(dishing)和侵蚀(er°sion),则会在下一层铜抛光屮形成金属残留。
铜自白谓蚜饣虫(corrosion)
铜的腐蚀(corrosion)是一种常见而棘手的缺陷。引起腐蚀的原因有很多种。
1)电偶腐蚀(ga1mnic corrosion)
电偶腐蚀是一种电化学过程,两种不同的金属连接在一起浸在电解液中形成一个电势差,阳极金属离子通过电解液向负极迁移,阳极金属发生腐蚀。一个普通的例子是:碳锌电池中,锌发生腐蚀并产生电流。在Cu CMP的过程中,铜和阻挡层金属钽(tan1alum)恰好形成电偶,而含有硫、氯或氟的去离子水(DIW).研磨液或清洗液则正好是电解液。
2)隙问腐蚀(crevicc corrosion)
隙问腐蚀是由渗透在铜和钽((lu/Ta)之门微小间隙中的电解液引起的,见图11,1o。来自于铜中的硫或FTα)S中的氟,溶解于电解液后则会加强此效应。
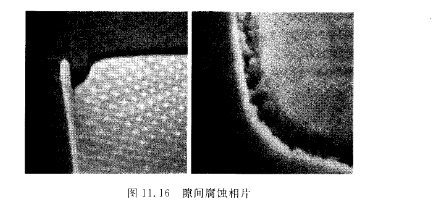
降低缺陷是CMP工艺,乃至整个芯片制造的永恒话题c随着器件特征K寸的不断缩、缺陷对于I艺控制和最终良率的影响愈发明形,致命缺陷的大小至少要求小于器件尺寸的50%。
金属残余物QAMI5516AUA
Cu CMP一个皋本的问题便是氧化硅介质上的金属残余物(residue),这会导致电学短路。这种金属残留主要是由于介质层的表面不平引起的,土一层铜抛光所产生的凹陷(dishing)和侵蚀(er°sion),则会在下一层铜抛光屮形成金属残留。
铜自白谓蚜饣虫(corrosion)
铜的腐蚀(corrosion)是一种常见而棘手的缺陷。引起腐蚀的原因有很多种。
1)电偶腐蚀(ga1mnic corrosion)
电偶腐蚀是一种电化学过程,两种不同的金属连接在一起浸在电解液中形成一个电势差,阳极金属离子通过电解液向负极迁移,阳极金属发生腐蚀。一个普通的例子是:碳锌电池中,锌发生腐蚀并产生电流。在Cu CMP的过程中,铜和阻挡层金属钽(tan1alum)恰好形成电偶,而含有硫、氯或氟的去离子水(DIW).研磨液或清洗液则正好是电解液。
2)隙问腐蚀(crevicc corrosion)
隙问腐蚀是由渗透在铜和钽((lu/Ta)之门微小间隙中的电解液引起的,见图11,1o。来自于铜中的硫或FTα)S中的氟,溶解于电解液后则会加强此效应。
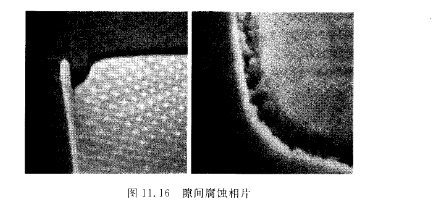
上一篇:采用低霪材料做介质成为发展的方向
上一篇:光助铜腐蚀
 热门点击
热门点击
- 互连层RC延迟的降低
- Cu CMP产生的缺陷
- 俄歇电子
- 热点检测失效定位
- 先进工艺对Cu cMP的挑战
- 相位衬度
- 应力记忆技术的刻蚀
- 具有高MEEF的图形会减少全芯片的工艺窗口
- 与常规CMOS工艺兼容的镍的全硅化工艺是自对
- 水罩相对硅片禁止时的接触角
 推荐技术资料
推荐技术资料
- 自制经典的1875功放
- 平时我也经常逛一些音响DIY论坛,发现有很多人喜欢LM... [详细]

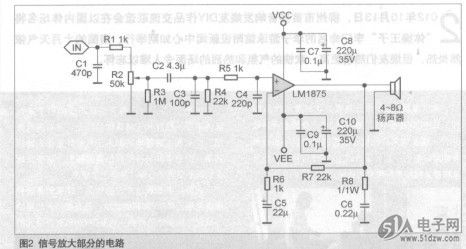
 公网安备44030402000607
公网安备44030402000607





