MPRS3D展示了在一个圆筒形反应器内
发布时间:2017/11/2 19:56:11 访问次数:602
如图8,7所示,MPRS3D展示了在一个圆筒形反应器内,由进气口、抽气口和非均匀功率沉积所造成的硅刻蚀的方位角不均匀性。VN1160基本条件包括:压力10mT°rr,⒛00W的13.56MHz射频功率沉积,500K的气体温度,79sccm的纯氯气。在上述条件下,进行了四组模拟比较,研究了方位角的非对称性。这是第一次研究聚焦环对刻蚀均匀性的影响。均匀的功率沉积在这里是指线圈中的电流保持方位角均匀,仅在径向卜有变化。非均匀功率沉积假设电流沿着线圈的路径线性增加,最终发生了径向和方位角方向⒈的电流变化。包含有氯原子吸附的简单离子辅助表面反应和离子辅助刻蚀被设定为其中,表示在鞘与前鞘边界处中性粒子密度,Tg是气体温度,″、是中性粒子的质量,r代表中性粒子的反应几率。模拟结果揭示出在均匀能量沉积的情形下,离子驱动刻蚀在晶圆上的刻蚀速率分布受到了抽气口的扰动。然而,图8.7(c)和图8.7(d)的情形主要是由非均匀功率沉积的影响造成的。在带有聚焦环的情形下,刻蚀速率略低,这是由于在环的表面产生了复合损失。聚焦环在某种程度L减弱了方位角不均匀性。在四组模拟中,气体的进气口甚至都没有引起局部的扰动。
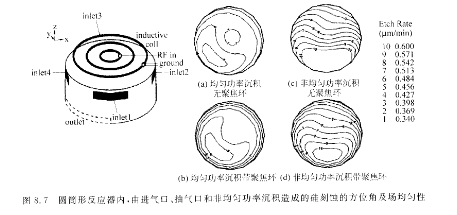
如图8,7所示,MPRS3D展示了在一个圆筒形反应器内,由进气口、抽气口和非均匀功率沉积所造成的硅刻蚀的方位角不均匀性。VN1160基本条件包括:压力10mT°rr,⒛00W的13.56MHz射频功率沉积,500K的气体温度,79sccm的纯氯气。在上述条件下,进行了四组模拟比较,研究了方位角的非对称性。这是第一次研究聚焦环对刻蚀均匀性的影响。均匀的功率沉积在这里是指线圈中的电流保持方位角均匀,仅在径向卜有变化。非均匀功率沉积假设电流沿着线圈的路径线性增加,最终发生了径向和方位角方向⒈的电流变化。包含有氯原子吸附的简单离子辅助表面反应和离子辅助刻蚀被设定为其中,表示在鞘与前鞘边界处中性粒子密度,Tg是气体温度,″、是中性粒子的质量,r代表中性粒子的反应几率。模拟结果揭示出在均匀能量沉积的情形下,离子驱动刻蚀在晶圆上的刻蚀速率分布受到了抽气口的扰动。然而,图8.7(c)和图8.7(d)的情形主要是由非均匀功率沉积的影响造成的。在带有聚焦环的情形下,刻蚀速率略低,这是由于在环的表面产生了复合损失。聚焦环在某种程度L减弱了方位角不均匀性。在四组模拟中,气体的进气口甚至都没有引起局部的扰动。
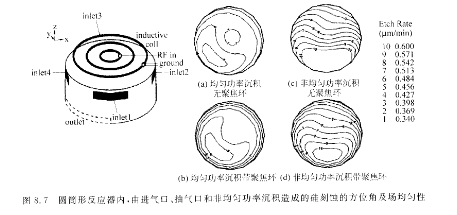
上一篇:模拟器中包含有复杂的等离子反应
上一篇:经验模型
 热门点击
热门点击


 公网安备44030402000607
公网安备44030402000607





