封装尺寸与裸芯片
发布时间:2012/10/3 17:56:20 访问次数:1246
CSP是BGA进一步微型化AP163-3176FAP163-3176FAP163-3176F的产物,于20世纪90年代中期问世。它的含义是封装尺寸接近裸芯片(通常封装尺寸与裸芯片之比约为1.2:1),CSP外部端子间距大于0.5mm,并能适应再流焊组装。
CSP器件具有下列优点:
①CSP是一种品质能保证的器件,即它在出厂时半导体制造厂家均经过性能测试,确保器件质量是可靠的(又称为KGD器件)。
②封装尺寸比BGA小,如Xilink公司的XC953b新封装,尺寸为7mm×7mm,有48个I/O,0.8mm中心距。美国国家半导体的双运算放大口采用的CSP封装,尺寸为1.6mm×1.6mm,有8个I/O,0.5mm中心距;安装高度低,可达Imm; CSP虽然是更小型化的封装,但比BGA更平,更易于贴装:贴装公差小于±0.3mm(当球中心距为0.8mm和Imm时)。
③它比QFP提供了更短的互连,因此电性能更好,即阻扰低、干扰小、噪声低、屏蔽效果好,更适合在高频领域应用。图2.82为不同封装对应的工作频率。
④CSP器件本体薄,故具有良好的导热性,易散热。
缺点:同BGA -样,CSP也存在着焊接后焊点质量测试问题和热膨胀系数匹配问题,由于本体刚性差,易出现焊点开裂缺陷,使用时应在焊接后补加“底部填充料”以增强器件的刚性。此外制造过程中基板的超细过孔制造困难,也给大量推广应用带来一定难度。
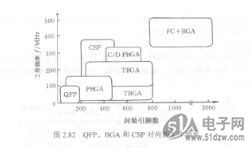
CSP是BGA进一步微型化AP163-3176FAP163-3176FAP163-3176F的产物,于20世纪90年代中期问世。它的含义是封装尺寸接近裸芯片(通常封装尺寸与裸芯片之比约为1.2:1),CSP外部端子间距大于0.5mm,并能适应再流焊组装。
CSP器件具有下列优点:
①CSP是一种品质能保证的器件,即它在出厂时半导体制造厂家均经过性能测试,确保器件质量是可靠的(又称为KGD器件)。
②封装尺寸比BGA小,如Xilink公司的XC953b新封装,尺寸为7mm×7mm,有48个I/O,0.8mm中心距。美国国家半导体的双运算放大口采用的CSP封装,尺寸为1.6mm×1.6mm,有8个I/O,0.5mm中心距;安装高度低,可达Imm; CSP虽然是更小型化的封装,但比BGA更平,更易于贴装:贴装公差小于±0.3mm(当球中心距为0.8mm和Imm时)。
③它比QFP提供了更短的互连,因此电性能更好,即阻扰低、干扰小、噪声低、屏蔽效果好,更适合在高频领域应用。图2.82为不同封装对应的工作频率。
④CSP器件本体薄,故具有良好的导热性,易散热。
缺点:同BGA -样,CSP也存在着焊接后焊点质量测试问题和热膨胀系数匹配问题,由于本体刚性差,易出现焊点开裂缺陷,使用时应在焊接后补加“底部填充料”以增强器件的刚性。此外制造过程中基板的超细过孔制造困难,也给大量推广应用带来一定难度。
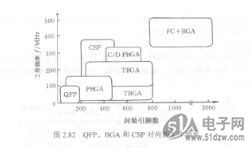
 热门点击
热门点击
- 有机焊接保护剂(OSP/HT-OSP)
- RLC串联电路的谐振特性
- 线性有源二端网络等效参数测量
- 重复精度
- 方波一三角波发生器设计与研究(设计性实验)
- BGA的焊接
- 乒乓球模拟比赛(综合性实验)
- 焊锡膏的分类及标识
- 丝网,模板印刷
- 焊锡膏印刷的缺陷、产生原因及对策
 推荐技术资料
推荐技术资料
- 泰克新发布的DSA830
- 泰克新发布的DSA8300在一台仪器中同时实现时域和频域分析,DS... [详细]



 公网安备44030402000607
公网安备44030402000607





