陶瓷球栅阵列
发布时间:2012/10/3 17:48:14 访问次数:1542
CBGA是BGA封装的第二AP1501-50K5LA
种类型,是为解决PBGA吸潮性而改进的品种,它与CCGA的结构比较如图2.80所示。
CBGA的芯片连接在多层陶瓷载体的上表面,芯片与多层陶瓷载体的连接可以有两种形式:一种是芯片线路朝上采用金属丝压焊的方式实现连接;另一种则是芯片的线路层朝下,采用倒装片结构方式实现芯片与载体的连接。芯片连接完成之后,对芯片采用环氧树脂等进行填充,从而提高可靠性和必要的机械防护。在陶瓷载体的下表面,焊球阵列的分布有完全分布或部分分布两种形式,焊球尺寸通常约为0.89mm,常见的间距有l.Omm和1.27mm。焊球阵列的成分早期为90Pb/lOSn而无铅化以后则已改为SnAgCu焊球,并在塑料封体的顶端标有“ei”标记。
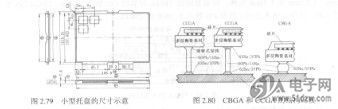
(2) CBGA封装的优点及不足
优点:具有优良的电性能和热性能;具有良好的密封性能:和PQFP相比,不易受到机械损伤;适用于I/O数大于250的电子组装应用。
不足之处:当封装尺寸大于32mm×32mm时,PCB和CBGA的多层陶瓷载体之间的热膨胀系数(CTE)不同,导致热循环中焊点失效。因此,目前CBGA的I/O数限制在625下,若尺寸大于32mmX 32mm,则考虑采用其他类型的BGA。
(3) CBGA的外形尺寸及包装
同PBGA。
3.陶瓷柱栅阵列(Ceramic Cloumn Grid Array.CCGA)
(1)结构
CCGA是CBGA在陶瓷尺寸大于32mm×32mm时的另一种形式,和CBGA不同的是在陶瓷载体的下表面连接的不是焊球而是90Pb/lOSn的焊料柱,无铅化以后已改为SnAgCu,焊料柱阵列可以是完全分布或部分分布。常见的焊料柱直径约为0.5mm,高度约为2.21mm,典型的柱阵列间距为1.27mm。CCGA有两种形式:一种是焊料柱与陶瓷底部采用共晶焊料连接;另一种则采用浇注式固定结构。
(2)优点及不足
CCGA的优缺点同CBGA相似,它优于CBGA之处是它的焊料柱可以承受因PCB和陶瓷载体的CTE不同所产生的应力,试验表明尺寸小于44mm×44mm的CCGA均可满足工业标准的热循环试验规范。不足之处是组装过程中焊料柱比焊球易受机械损伤。
(3) CCGA的外形尺寸及包装
同PBGA。
CBGA是BGA封装的第二AP1501-50K5LA
种类型,是为解决PBGA吸潮性而改进的品种,它与CCGA的结构比较如图2.80所示。
CBGA的芯片连接在多层陶瓷载体的上表面,芯片与多层陶瓷载体的连接可以有两种形式:一种是芯片线路朝上采用金属丝压焊的方式实现连接;另一种则是芯片的线路层朝下,采用倒装片结构方式实现芯片与载体的连接。芯片连接完成之后,对芯片采用环氧树脂等进行填充,从而提高可靠性和必要的机械防护。在陶瓷载体的下表面,焊球阵列的分布有完全分布或部分分布两种形式,焊球尺寸通常约为0.89mm,常见的间距有l.Omm和1.27mm。焊球阵列的成分早期为90Pb/lOSn而无铅化以后则已改为SnAgCu焊球,并在塑料封体的顶端标有“ei”标记。
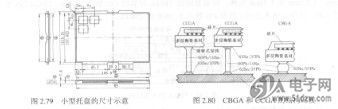
(2) CBGA封装的优点及不足
优点:具有优良的电性能和热性能;具有良好的密封性能:和PQFP相比,不易受到机械损伤;适用于I/O数大于250的电子组装应用。
不足之处:当封装尺寸大于32mm×32mm时,PCB和CBGA的多层陶瓷载体之间的热膨胀系数(CTE)不同,导致热循环中焊点失效。因此,目前CBGA的I/O数限制在625下,若尺寸大于32mmX 32mm,则考虑采用其他类型的BGA。
(3) CBGA的外形尺寸及包装
同PBGA。
3.陶瓷柱栅阵列(Ceramic Cloumn Grid Array.CCGA)
(1)结构
CCGA是CBGA在陶瓷尺寸大于32mm×32mm时的另一种形式,和CBGA不同的是在陶瓷载体的下表面连接的不是焊球而是90Pb/lOSn的焊料柱,无铅化以后已改为SnAgCu,焊料柱阵列可以是完全分布或部分分布。常见的焊料柱直径约为0.5mm,高度约为2.21mm,典型的柱阵列间距为1.27mm。CCGA有两种形式:一种是焊料柱与陶瓷底部采用共晶焊料连接;另一种则采用浇注式固定结构。
(2)优点及不足
CCGA的优缺点同CBGA相似,它优于CBGA之处是它的焊料柱可以承受因PCB和陶瓷载体的CTE不同所产生的应力,试验表明尺寸小于44mm×44mm的CCGA均可满足工业标准的热循环试验规范。不足之处是组装过程中焊料柱比焊球易受机械损伤。
(3) CCGA的外形尺寸及包装
同PBGA。
上一篇: PBGA封装的优点和不足
上一篇:载带球栅阵列
 热门点击
热门点击

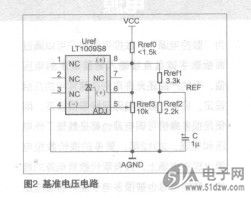
 公网安备44030402000607
公网安备44030402000607





