PBGA封装的优点和不足
发布时间:2012/10/3 17:43:51 访问次数:935
PBGA封装的优点:可以AOD454A
利用现有的组装技术和原材料制造PBGA,整个封装的费用相对较低;和PQFP器件相比,不易受到机械损伤,占用PCB面积小,可适用于大批量的电子组装。
不足之处:易吸潮,焊点的热应力大,以及焊接后检验与维修困难。
(3)外形尺寸

PBGA的外形尺寸如图2.77所示。
●封装尺寸厶7~50mm;
●球中心J距d:Imm,1.27mm,1.5mm;
.锡球直径D: 0.6~l.Omm;
锡球成分:早期在载体的下表面连接有共晶组份( Sn37Pb)的焊球阵列,而无铅化以后则已改为SnAgCu焊球,并在塑料封体的顶端标有“ei”标记。焊球阵列在器件底面上可以呈完全分布或部分分布,
如图2.78所示。
(4)包装
BGA昀包装一般采用JEDEC标准托盘和小型芯片专用托盘,使用JEDEC托盘的优点是在器件成品筛选、包装时适合自动装入器的自动操作与贴片机的供料架相匹配。托盘承料凹腔和四周都有保护的凸点,包装时不会压坏成品的
球形端子。已有标准尺寸的BGA包装用托盘分别如图2.78和图2.79所示。
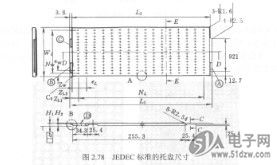
BGA的包装一定要使用密封方式,包装开封后应在规定的时间内完成贴装与焊接,如果超过了规定的时间,则贴装前应将器件烘干后使用。有关烘干工艺参数可参考2.8.3节的内容。
PBGA封装的优点:可以AOD454A
利用现有的组装技术和原材料制造PBGA,整个封装的费用相对较低;和PQFP器件相比,不易受到机械损伤,占用PCB面积小,可适用于大批量的电子组装。
不足之处:易吸潮,焊点的热应力大,以及焊接后检验与维修困难。
(3)外形尺寸

PBGA的外形尺寸如图2.77所示。
●封装尺寸厶7~50mm;
●球中心J距d:Imm,1.27mm,1.5mm;
.锡球直径D: 0.6~l.Omm;
锡球成分:早期在载体的下表面连接有共晶组份( Sn37Pb)的焊球阵列,而无铅化以后则已改为SnAgCu焊球,并在塑料封体的顶端标有“ei”标记。焊球阵列在器件底面上可以呈完全分布或部分分布,
如图2.78所示。
(4)包装
BGA昀包装一般采用JEDEC标准托盘和小型芯片专用托盘,使用JEDEC托盘的优点是在器件成品筛选、包装时适合自动装入器的自动操作与贴片机的供料架相匹配。托盘承料凹腔和四周都有保护的凸点,包装时不会压坏成品的
球形端子。已有标准尺寸的BGA包装用托盘分别如图2.78和图2.79所示。
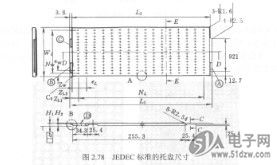
BGA的包装一定要使用密封方式,包装开封后应在规定的时间内完成贴装与焊接,如果超过了规定的时间,则贴装前应将器件烘干后使用。有关烘干工艺参数可参考2.8.3节的内容。



 公网安备44030402000607
公网安备44030402000607





