统计过程控制在集成电路生产中的应用
发布时间:2017/11/19 17:14:46 访问次数:431
在集成电路制造生产过程中,每一个主要的生产步骤之后都会进行一些测量或监控,例HCF4538M013TR如所沉积的薄膜的厚度,化学机械抛光之后金属或绝缘体薄膜的厚度,刻蚀之后沟槽、通孔、有源lx、栅极的宽度等,以确保该△艺步骤是合格的,避免不合格品流落到下一道T∶序继续生产。把这些测量值以适当的方式放人到sPC Chart中,并开启没定的判异准则,则可以提 前发现产线的异常,在异常还未对产品产生不可接受的影响之前,就把问题显现出来.SPC的执行系统会产生一个OCAP(out of c°ntrol acti°n plan),由生产或I程人员按照OCAP的流程对异常进行处理,从而有效避免不合格品的发生。考虑到所测量参数的固有物理性质、对产品的影响程度以及判异发生时故障排查的难易程度,通常只选择8个判异准则中的一个或几个,避免虚发警报的概率过高,如果只选一个,通常选择WEtΓ()rule1,即单点超出控制限。
不断提高过程能力指数(C淤)是统计过程控制在集成电路生产中应用的重要环节。在同样的条件下,过程能力指数越大,测量参数落在公差界限之外的概率越小,通常泌达到已经是比较理想的状态,继续提高C泌可能意味着巨大的投人但收益很小。如果把作为改进的目标,公差界限设置合理是重要的前提条件。
在集成电路制造生产过程中,每一个主要的生产步骤之后都会进行一些测量或监控,例HCF4538M013TR如所沉积的薄膜的厚度,化学机械抛光之后金属或绝缘体薄膜的厚度,刻蚀之后沟槽、通孔、有源lx、栅极的宽度等,以确保该△艺步骤是合格的,避免不合格品流落到下一道T∶序继续生产。把这些测量值以适当的方式放人到sPC Chart中,并开启没定的判异准则,则可以提 前发现产线的异常,在异常还未对产品产生不可接受的影响之前,就把问题显现出来.SPC的执行系统会产生一个OCAP(out of c°ntrol acti°n plan),由生产或I程人员按照OCAP的流程对异常进行处理,从而有效避免不合格品的发生。考虑到所测量参数的固有物理性质、对产品的影响程度以及判异发生时故障排查的难易程度,通常只选择8个判异准则中的一个或几个,避免虚发警报的概率过高,如果只选一个,通常选择WEtΓ()rule1,即单点超出控制限。
不断提高过程能力指数(C淤)是统计过程控制在集成电路生产中应用的重要环节。在同样的条件下,过程能力指数越大,测量参数落在公差界限之外的概率越小,通常泌达到已经是比较理想的状态,继续提高C泌可能意味着巨大的投人但收益很小。如果把作为改进的目标,公差界限设置合理是重要的前提条件。
上一篇:常用控制图的分类
上一篇:yield的基本定义及扩展
 热门点击
热门点击
- 扫描电镜的分辨率
- Cu CMP产生的缺陷
- 使用共金贴片工艺的示意图
- 俄歇电子
- 热点检测失效定位
- 先进工艺对Cu cMP的挑战
- 关键区域(criticaI area)简介
- 相位衬度
- 应力记忆技术的刻蚀
- 具有高MEEF的图形会减少全芯片的工艺窗口
 推荐技术资料
推荐技术资料
- 自制经典的1875功放
- 平时我也经常逛一些音响DIY论坛,发现有很多人喜欢LM... [详细]

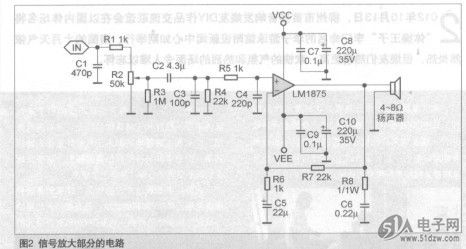
 公网安备44030402000607
公网安备44030402000607





