HCI的机理
发布时间:2017/11/17 21:41:57 访问次数:831
当MOS器件丁作时,载流子(电子或空穴)从源向漏移动,在漏端高电场区获得动能。 UC3524ADWTR随着能量的累积,这些高能载流子不再与晶格保持热平衡状态,而是具有高于品格热能(KT)的能量,称热载流子。当热载流子的能量超过一定的阈值就会产生碰撞电离(impactionization〉。碰撞电离产生的电子空穴对会产生更多的电子空穴对,从而发生雪崩效应。有一部分热载流子具有较高能董,能够克服⒏/sOJ接口势垒注人靠近漏端的氧化层。这些注人的载流子会被俘获在栅氧化层中,或si/Si()2界面,或损坏Si∷/si()J(打断Si―H键)G 从I阿导致器件的电学性能退化,器件不能正常工作。
HcI寿命模型
常用的H()I寿命模型有Ib模型,Ib/Id模型及1/Vd模型。
Ib模型和Ib/Id模型是建立于一定的⒕条件下可以在Jbˉy#Hh线上找到rb的最大值。但通常在沟道长度小于0,1um的器件,应力条件一般采用来推理。
当MOS器件丁作时,载流子(电子或空穴)从源向漏移动,在漏端高电场区获得动能。 UC3524ADWTR随着能量的累积,这些高能载流子不再与晶格保持热平衡状态,而是具有高于品格热能(KT)的能量,称热载流子。当热载流子的能量超过一定的阈值就会产生碰撞电离(impactionization〉。碰撞电离产生的电子空穴对会产生更多的电子空穴对,从而发生雪崩效应。有一部分热载流子具有较高能董,能够克服⒏/sOJ接口势垒注人靠近漏端的氧化层。这些注人的载流子会被俘获在栅氧化层中,或si/Si()2界面,或损坏Si∷/si()J(打断Si―H键)G 从I阿导致器件的电学性能退化,器件不能正常工作。
HcI寿命模型
常用的H()I寿命模型有Ib模型,Ib/Id模型及1/Vd模型。
Ib模型和Ib/Id模型是建立于一定的⒕条件下可以在Jbˉy#Hh线上找到rb的最大值。但通常在沟道长度小于0,1um的器件,应力条件一般采用来推理。
上一篇:热载流子效应(HCl)
上一篇:HCI的机理
 热门点击
热门点击
- 扫描电镜的分辨率
- 互连层RC延迟的降低
- Cu CMP产生的缺陷
- 俄歇电子
- 热点检测失效定位
- 先进工艺对Cu cMP的挑战
- 关键区域(criticaI area)简介
- 相位衬度
- 应力记忆技术的刻蚀
- 具有高MEEF的图形会减少全芯片的工艺窗口
 推荐技术资料
推荐技术资料
- 自制经典的1875功放
- 平时我也经常逛一些音响DIY论坛,发现有很多人喜欢LM... [详细]

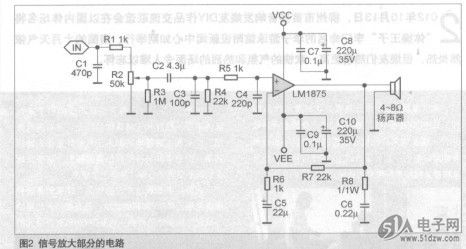
 公网安备44030402000607
公网安备44030402000607





