氮化硅HF/EG湿法刻蚀
发布时间:2017/11/7 21:26:53 访问次数:2366
H吖EG在氧化硅湿法刻蚀部分提过,它对氮化硅刻蚀率比氧化硅要快,比率约1.5:1,也不侵蚀硅,有时应用于CM()S的STI沟渠形成后氮化硅湿法回蚀步骤。W005G
氮化硅HF湿法刻蚀
49%HF对氮化硅(炉管或CVI))有高的刻蚀率,对氧化硅更高,因而不适宜制程应用。也正是l,xl为它的高刻蚀率,对去除挡控片上的氮化硅很有效。其反应如下ΙISi、NI+18H「―→H2SiFb+2(NHl)j SiFⅡ以炉管氮化硅(SiN)为幕罩的刻蚀,如浅沟渠隔离(s'I′I)刻蚀、侧壁(()FFSET)刻蚀、主问隙壁(SPACER)刻蚀,在刻蚀后,留下的残留物一般含Θ、Si等元素,常用稀HF(浓度H20:HF约100:1或更稀)清除。对于CVD SiN为幕罩的刻蚀,阵i于稀HF对CVD⒏N的刻蚀率本身就比炉管siN大,加上刻蚀电浆对幕罩的表面轰击,相对讲这种膜刻蚀率就更大,因此刻蚀后残留物的去除,需用更稀的HF,以避免高浓度HF过刻蚀影响关键尺寸的控制。
H吖EG在氧化硅湿法刻蚀部分提过,它对氮化硅刻蚀率比氧化硅要快,比率约1.5:1,也不侵蚀硅,有时应用于CM()S的STI沟渠形成后氮化硅湿法回蚀步骤。W005G
氮化硅HF湿法刻蚀
49%HF对氮化硅(炉管或CVI))有高的刻蚀率,对氧化硅更高,因而不适宜制程应用。也正是l,xl为它的高刻蚀率,对去除挡控片上的氮化硅很有效。其反应如下ΙISi、NI+18H「―→H2SiFb+2(NHl)j SiFⅡ以炉管氮化硅(SiN)为幕罩的刻蚀,如浅沟渠隔离(s'I′I)刻蚀、侧壁(()FFSET)刻蚀、主问隙壁(SPACER)刻蚀,在刻蚀后,留下的残留物一般含Θ、Si等元素,常用稀HF(浓度H20:HF约100:1或更稀)清除。对于CVD SiN为幕罩的刻蚀,阵i于稀HF对CVD⒏N的刻蚀率本身就比炉管siN大,加上刻蚀电浆对幕罩的表面轰击,相对讲这种膜刻蚀率就更大,因此刻蚀后残留物的去除,需用更稀的HF,以避免高浓度HF过刻蚀影响关键尺寸的控制。


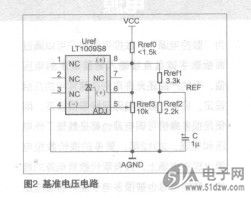
 公网安备44030402000607
公网安备44030402000607





