晶边刻蚀和晶边上潜在的缺陷源
发布时间:2017/11/5 17:14:56 访问次数:956
如图8,57(a)所示,在晶边刻蚀中,遮挡盘用来实现除去晶边边部分(最大到1mm宽)。 QT2022C2遮挡盘比晶圆本身小几个毫米,可以保护晶圆的绝大部分不被刻蚀。图8.57(b)显示的是可能的缺陷源,在晶圆边缘较低的等离子密度容易引起聚合物在晶边的顶部和底部表面积累,这种聚合物常常由碳、氧、氮、氟组成。而且,来自不同的刻蚀I艺的多层聚合物能够形成强而黏的有机键,这些键在后续的工艺步骤中将变弱。因此,从理论上讲,所形成的这些聚合物层在后面的处理过程中将会剥离或脱落,ILD残余物主要来自不良的光刻去边(EBR),通常在晶圆边缘的顶部,ILD沉积和刻蚀生成的聚合物可以在标准的刻蚀工艺中除去。然而,二者在晶边底部时就不能被除去,形成可能的脱落源,导致缺陷生成。从晶圆的边缘起,晶边刻蚀最大的距离是0,9mm,这在光刻去边的限制范围内。通常在晶边刻蚀中,C02被用作聚合物去除,NF3被用作介质去除。前者是被设计用来避免可能的低虑损伤,在晶边刻蚀中一个要考虑的问题是处于后端I艺的晶圆可能会遭遇电弧放电,这个问题可以通过在晶边刻蚀中优化压力、功率和化学气体,在晶圆上得到较低的RF电斥而被消除。
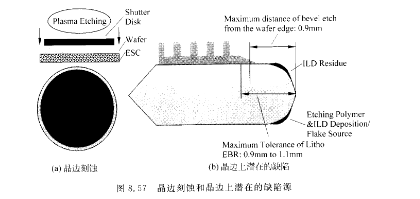
如图8,57(a)所示,在晶边刻蚀中,遮挡盘用来实现除去晶边边部分(最大到1mm宽)。 QT2022C2遮挡盘比晶圆本身小几个毫米,可以保护晶圆的绝大部分不被刻蚀。图8.57(b)显示的是可能的缺陷源,在晶圆边缘较低的等离子密度容易引起聚合物在晶边的顶部和底部表面积累,这种聚合物常常由碳、氧、氮、氟组成。而且,来自不同的刻蚀I艺的多层聚合物能够形成强而黏的有机键,这些键在后续的工艺步骤中将变弱。因此,从理论上讲,所形成的这些聚合物层在后面的处理过程中将会剥离或脱落,ILD残余物主要来自不良的光刻去边(EBR),通常在晶圆边缘的顶部,ILD沉积和刻蚀生成的聚合物可以在标准的刻蚀工艺中除去。然而,二者在晶边底部时就不能被除去,形成可能的脱落源,导致缺陷生成。从晶圆的边缘起,晶边刻蚀最大的距离是0,9mm,这在光刻去边的限制范围内。通常在晶边刻蚀中,C02被用作聚合物去除,NF3被用作介质去除。前者是被设计用来避免可能的低虑损伤,在晶边刻蚀中一个要考虑的问题是处于后端I艺的晶圆可能会遭遇电弧放电,这个问题可以通过在晶边刻蚀中优化压力、功率和化学气体,在晶圆上得到较低的RF电斥而被消除。
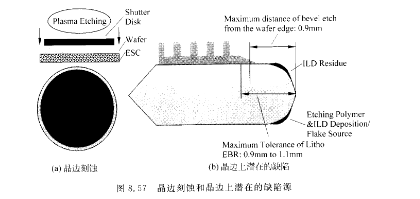



 公网安备44030402000607
公网安备44030402000607





