硅凹槽刻蚀
发布时间:2017/11/5 16:58:43 访问次数:1566
在高速IC产品中,通过将具有压缩应变的⒏Gc「2-l薄膜嵌人到PM()S的源漏区,首次将其引人到了90nm△艺技术中。在PMOS沟道中的⒏Gc提供了一种调节阈值电压的途径,PCF7991AT由于其明显地改善了空穴迁移率和降低了接触电阻,在平面和多种栅(多晶硅栅和高勿/金属栅)中都已经观察到器件性能显著地增强了(20%~65%)。如图8.52所示,这项技术需要在侧墙刚刚形成后,在PMOS区引入衬底凹槽刻蚀和选择性外延SiGe沉积。硅的凹槽刻蚀通常采用HBr/o2气体,在导体刻蚀机中进行。在硅凹槽刻蚀过程中,一个主要要考虑的问题是就是保护多晶硅栅的上表面。由于HBr o2在多晶硅栅和硅之问的低刻蚀选择性,通常要在多晶硅栅的顶部增加一个附加层,比如SiN层。这个附加的SiN层也可以集成为侧墙的一部分,硅槽的深度由OCD监控,这意味着这个深度是可调的.
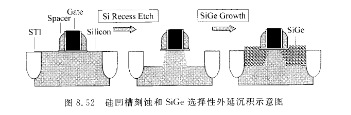
图8,53所示为从空穴迁移率、短沟效应和源/漏电阻的角度来看硅沟槽形状的变迁。Σ型的Si(le源/漏由于其100%的应力增强,从而优于常规的⒏Ge源/漏。然而,Σ型的SiGe源/漏无法提供在32nm及其以下I艺节点所需要的应变水平,人们又提出了两层台阶式⒏Ge源/漏的方案,这种形状显示出了对PMOS器件在空穴迁移率、短沟效应和源/漏
电阻等方面的改善。Σ型和两层台阶式SlGc源/漏的结构可用干法刻蚀形成,前者在硅凹槽刻蚀后需要后处理,后者利用了不同的侧墙宽度。多种方法可以用来定义各个台阶的宽度,举例来说,第一个深的硅沟槽用常规的硅凹槽刻蚀形成,接着是侧墙CD的收缩,这种收缩可以用干法刻蚀,或者是双侧墙方案(夕卜侧墙是可灰化的)。然后制作出第二个浅硅槽,从而形成有两层台阶的硅沟槽。
在高速IC产品中,通过将具有压缩应变的⒏Gc「2-l薄膜嵌人到PM()S的源漏区,首次将其引人到了90nm△艺技术中。在PMOS沟道中的⒏Gc提供了一种调节阈值电压的途径,PCF7991AT由于其明显地改善了空穴迁移率和降低了接触电阻,在平面和多种栅(多晶硅栅和高勿/金属栅)中都已经观察到器件性能显著地增强了(20%~65%)。如图8.52所示,这项技术需要在侧墙刚刚形成后,在PMOS区引入衬底凹槽刻蚀和选择性外延SiGe沉积。硅的凹槽刻蚀通常采用HBr/o2气体,在导体刻蚀机中进行。在硅凹槽刻蚀过程中,一个主要要考虑的问题是就是保护多晶硅栅的上表面。由于HBr o2在多晶硅栅和硅之问的低刻蚀选择性,通常要在多晶硅栅的顶部增加一个附加层,比如SiN层。这个附加的SiN层也可以集成为侧墙的一部分,硅槽的深度由OCD监控,这意味着这个深度是可调的.
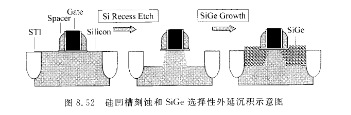
图8,53所示为从空穴迁移率、短沟效应和源/漏电阻的角度来看硅沟槽形状的变迁。Σ型的Si(le源/漏由于其100%的应力增强,从而优于常规的⒏Ge源/漏。然而,Σ型的SiGe源/漏无法提供在32nm及其以下I艺节点所需要的应变水平,人们又提出了两层台阶式⒏Ge源/漏的方案,这种形状显示出了对PMOS器件在空穴迁移率、短沟效应和源/漏
电阻等方面的改善。Σ型和两层台阶式SlGc源/漏的结构可用干法刻蚀形成,前者在硅凹槽刻蚀后需要后处理,后者利用了不同的侧墙宽度。多种方法可以用来定义各个台阶的宽度,举例来说,第一个深的硅沟槽用常规的硅凹槽刻蚀形成,接着是侧墙CD的收缩,这种收缩可以用干法刻蚀,或者是双侧墙方案(夕卜侧墙是可灰化的)。然后制作出第二个浅硅槽,从而形成有两层台阶的硅沟槽。
上一篇:应力记忆技术的刻蚀
 热门点击
热门点击
- 编制工艺文件的原则与要求
- 普通晶闸管是由四层半导体材料组成的
- HDP-CVD工艺重要参数-沉积刻蚀比
- 在PNL的基础上叉有两个改进工艺LRW(lo
- 影响对焦深度的因素主要有几点
- 增大晶圆的尺寸
- 第一级采用差分放大电路
- 钨接触孔刻蚀
- 硅凹槽刻蚀
- 泛林半导体
 推荐技术资料
推荐技术资料
- 硬盘式MP3播放器终级改
- 一次偶然的机会我结识了NE0 2511,那是一个远方的... [详细]


 公网安备44030402000607
公网安备44030402000607





