选择性锗硅外延工艺
发布时间:2017/10/21 13:05:09 访问次数:2185
选择性锗硅工艺可以分为两种工艺流程,一种是K4S561632N-LC75在形成侧墙offsct工艺之前嵌人锗硅(SiGe伍rst process),另一种是在源漏扩展区和侧墙工艺形成后嵌人锗硅(SiGe lastprocess),如图5.2所示[4]。
选择性锗硅外延工艺(Selective Epitaxy Growth,SiGe SEG)一般包含酸槽预处理、原位氢气烘焙(ill situ H2bake)、选择性锗硅外延三个步骤。酸槽预处理采用HF和RCA清洗的方法,去除硅刻蚀后表面的杂质。在原位氢气烘焙过程中,原生氧化物被去除,使得碳氧含量低于3e1:ato血/cm3。然后进行选择性锗硅的外延,所采用的硅源有siH1、SiH2α2 (0CS),锗源有GeH|,HCl用于抑制锗硅形成于保护层△,氢气作为载气。在酸槽预处理后,需要控制在一定的时间内(如(90min)进入原位烘焙腔体中,否则硅表面会产生氧化物,使得外延出来的锗硅有位错(dislocation)和堆栈缺陷(stacking hults〉,导致五realcakage偏高「3]。原位氢气烘焙的温度在800℃以下不足以去除硅表面的碳氧杂质,使得area leakage偏高。
选择性锗硅外延I艺使用的凹穴(recess∞访ty)形状(见图5.3)有:反向盂grllta hke∑Ⅱ,boxhkc L」,r。und hke`,(111>hke L等。其中<111)hke的凹穴形状难于形成堆栈缺陷。
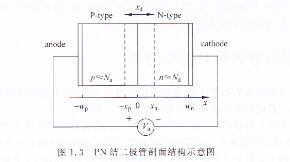
选择性锗硅工艺可以分为两种工艺流程,一种是K4S561632N-LC75在形成侧墙offsct工艺之前嵌人锗硅(SiGe伍rst process),另一种是在源漏扩展区和侧墙工艺形成后嵌人锗硅(SiGe lastprocess),如图5.2所示[4]。
选择性锗硅外延工艺(Selective Epitaxy Growth,SiGe SEG)一般包含酸槽预处理、原位氢气烘焙(ill situ H2bake)、选择性锗硅外延三个步骤。酸槽预处理采用HF和RCA清洗的方法,去除硅刻蚀后表面的杂质。在原位氢气烘焙过程中,原生氧化物被去除,使得碳氧含量低于3e1:ato血/cm3。然后进行选择性锗硅的外延,所采用的硅源有siH1、SiH2α2 (0CS),锗源有GeH|,HCl用于抑制锗硅形成于保护层△,氢气作为载气。在酸槽预处理后,需要控制在一定的时间内(如(90min)进入原位烘焙腔体中,否则硅表面会产生氧化物,使得外延出来的锗硅有位错(dislocation)和堆栈缺陷(stacking hults〉,导致五realcakage偏高「3]。原位氢气烘焙的温度在800℃以下不足以去除硅表面的碳氧杂质,使得area leakage偏高。
选择性锗硅外延I艺使用的凹穴(recess∞访ty)形状(见图5.3)有:反向盂grllta hke∑Ⅱ,boxhkc L」,r。und hke`,(111>hke L等。其中<111)hke的凹穴形状难于形成堆栈缺陷。
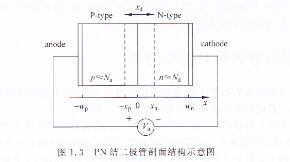



 公网安备44030402000607
公网安备44030402000607





