0.18um CMOS后段铜互连工艺
发布时间:2016/6/19 18:17:54 访问次数:1619
铜互连工艺与铝互连不同之处在于金属互连采用铜互连,同时为了降低寄生电容,EP1C6Q240C8N金属层间的介质隔离采用低肟介质。由于金属铜难以腐蚀,因此采用大马士革(DamⅡccnc)的铜CMP工艺。
1.金属前介质沉积
首先沉积未掺杂的TEOS,随后沉积BPSG,经过高温致密化及平坦化处理。
接着沉积未掺杂的TEOs,形成金属前介质,如图4.”所示。
2. 接角虫孑L
金属前介质沉积后进行接触孔光刻和腐蚀,形成接触孔。接着采用CVD方法沉积一层薄的△和TiN,随后采用CVD方法沉积W,进行W填充,然后进行WCMP。去除掉表面的W,保留接触孔内的W,如图4。⒛所示。
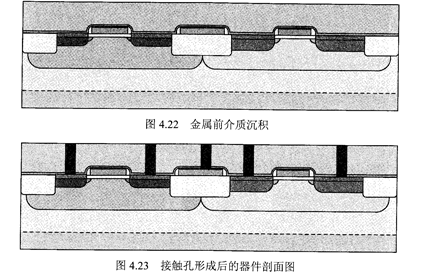
铜互连工艺与铝互连不同之处在于金属互连采用铜互连,同时为了降低寄生电容,EP1C6Q240C8N金属层间的介质隔离采用低肟介质。由于金属铜难以腐蚀,因此采用大马士革(DamⅡccnc)的铜CMP工艺。
1.金属前介质沉积
首先沉积未掺杂的TEOS,随后沉积BPSG,经过高温致密化及平坦化处理。
接着沉积未掺杂的TEOs,形成金属前介质,如图4.”所示。
2. 接角虫孑L
金属前介质沉积后进行接触孔光刻和腐蚀,形成接触孔。接着采用CVD方法沉积一层薄的△和TiN,随后采用CVD方法沉积W,进行W填充,然后进行WCMP。去除掉表面的W,保留接触孔内的W,如图4。⒛所示。
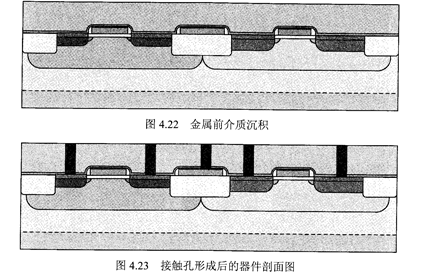
 热门点击
热门点击


 公网安备44030402000607
公网安备44030402000607





