Spacer
发布时间:2016/6/18 20:53:03 访问次数:4599
LDD完成后,在圆片上沉积TEOs,随后进行各向同性的干法腐蚀,栅极多晶硅侧壁的TEOs被保留下来,OP220GSZ-REEL而其他地方的TEOs被去掉。接着对注入后的LDD进行高温快速热退火(Rapid Thcmal Anncal,RTA),如图4,11所示。spaccr可为随后的源漏注入做阻挡,这一工艺称之为自对准工艺。
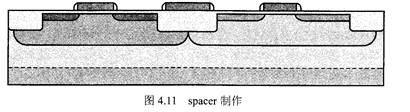
NMOS、PMOs源漏
Spacer工序完成后,下一步热生长一层薄氧化层,作为随后进行的源漏离子注入的注入阻挡层。然后采用7#光刻版进行NMOs源(Sourcc)漏(Dr缸n)的光刻以及离子注入,如图4。⒓所示。注入元素为As,剂量约为1015量级,注入能量约为60KcⅤ,离子注入形blMOs的源漏区域。注入完成后去除光刻胶并进行清洗。

LDD完成后,在圆片上沉积TEOs,随后进行各向同性的干法腐蚀,栅极多晶硅侧壁的TEOs被保留下来,OP220GSZ-REEL而其他地方的TEOs被去掉。接着对注入后的LDD进行高温快速热退火(Rapid Thcmal Anncal,RTA),如图4,11所示。spaccr可为随后的源漏注入做阻挡,这一工艺称之为自对准工艺。
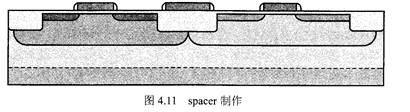
NMOS、PMOs源漏
Spacer工序完成后,下一步热生长一层薄氧化层,作为随后进行的源漏离子注入的注入阻挡层。然后采用7#光刻版进行NMOs源(Sourcc)漏(Dr缸n)的光刻以及离子注入,如图4。⒓所示。注入元素为As,剂量约为1015量级,注入能量约为60KcⅤ,离子注入形blMOs的源漏区域。注入完成后去除光刻胶并进行清洗。

上一篇:轻掺杂源漏(LDD)
上一篇:硅化物形成
 热门点击
热门点击


 公网安备44030402000607
公网安备44030402000607





