划片
发布时间:2015/11/15 14:09:20 访问次数:1710
传统芯片的封装工艺始于将晶圆分离成单个的芯片。划片有两种方法: TMS320DM6437ZWT6划片分离或锯片分离(见图18. 15).,对于凸点或焊球工艺,划片是在晶圆上建立凸点或焊殊系统之后。
锯片法:较厚的晶圆使得锯片法发展成为划片工艺的首选方法。锯片机由下列部分组成:可旋转的晶圆载台,自动或手动的划痕定位影像系统和一一个镶有钻石的圆形锯片。此工艺使用_『两种技术,且每种技术开始都用钻石锯片从芯片划线上经过。对于薄的晶片,锯片降低到晶片的表面划出一条深入晶片厚度1/3的浅槽。芯片分离的方法仍沿用划片法中所述的圆柱滚轴加压法。第二种划片的方法是用锯片将晶圆完全锯开成单个芯片。
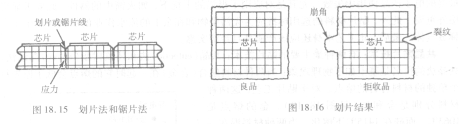
通常,对要被完全锯开的晶圆,首先将其贴在一张弹性较好的塑料膜上。在芯片被分离后,还会继续贴在塑料膜上,这样会对下一步提取芯片的工艺有所帮助。由于锯片法划出的芯片边缘效果较好,同时芯片的侧面也较少产生裂纹和崩角(见图18. 16),所以锯片法一直是划片工艺的首选方法。
划片法:划片法(scribing)或钻石划片法(diamond scribing)是工业界开发的第一代划片技术。此方法要求用镶有钻石尖端的划片器从划线的中心划逑,并通过折弯晶圆将芯片分离。当晶片厚度超过lo mil时,划片法的可靠性就会降低。
传统芯片的封装工艺始于将晶圆分离成单个的芯片。划片有两种方法: TMS320DM6437ZWT6划片分离或锯片分离(见图18. 15).,对于凸点或焊球工艺,划片是在晶圆上建立凸点或焊殊系统之后。
锯片法:较厚的晶圆使得锯片法发展成为划片工艺的首选方法。锯片机由下列部分组成:可旋转的晶圆载台,自动或手动的划痕定位影像系统和一一个镶有钻石的圆形锯片。此工艺使用_『两种技术,且每种技术开始都用钻石锯片从芯片划线上经过。对于薄的晶片,锯片降低到晶片的表面划出一条深入晶片厚度1/3的浅槽。芯片分离的方法仍沿用划片法中所述的圆柱滚轴加压法。第二种划片的方法是用锯片将晶圆完全锯开成单个芯片。
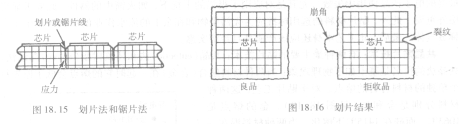
通常,对要被完全锯开的晶圆,首先将其贴在一张弹性较好的塑料膜上。在芯片被分离后,还会继续贴在塑料膜上,这样会对下一步提取芯片的工艺有所帮助。由于锯片法划出的芯片边缘效果较好,同时芯片的侧面也较少产生裂纹和崩角(见图18. 16),所以锯片法一直是划片工艺的首选方法。
划片法:划片法(scribing)或钻石划片法(diamond scribing)是工业界开发的第一代划片技术。此方法要求用镶有钻石尖端的划片器从划线的中心划逑,并通过折弯晶圆将芯片分离。当晶片厚度超过lo mil时,划片法的可靠性就会降低。
上一篇:取放芯片



 公网安备44030402000607
公网安备44030402000607





