难熔金属和难熔金属硅化物
发布时间:2015/11/8 18:47:31 访问次数:1161
虽然通过采用铝合金和阻挡层金属技术,电迁徙和共晶合金的限制已被缓解,HIP6004CB接触电阻的问题或许成为铝金属化的最终限制。金属系统的全面效果由电阻率、长度、厚度和全部金属和晶圆互连的总的接触电阻所决定。在简单的铝系统中,有两个接触:硅一铝互连和铝互连一压焊线。在具有多层金属层、阻挡层、填塞、多晶硅栅和导体及其他中间导电层的ULSI电路中,连接的数目变得非常大。全部单个接触电阻加起来可能主导金属系统的导电性(见图13.2),
接触电阻受材料、衬底掺杂和接触孔尺寸的影响。接触孔尺寸越小,电阻越高。遗憾的是,U LSI芯片有更小的接触孔,并且大的f]阵列芯片表面可能占接触面积的80%7ii。这两项使接触电阻在VLSI金属系统性能中成为决定因素。铝硅接触电阻及合金问题已导致开始为VLSI金属化研究其他金属。与铝相比,多晶硅有更低的接触电阻,并用在MOS电路中(见图13.5)。这是传奇式的畦栅(silicon gate) MOS器件结构。
难熔金属和它们的硅化物提供了低的接触电阻。有意义的难熔金属是钛( Ti)、钨(W)、钽( Ta)和钼(Mo)。当它们在硅表面被合金时,分别形成它们的硅化物(TiS12、WSi,、TaSi2和MoS12),在20世纪50年代第一次提出将难熔金属用于金属化,但是由于缺乏可靠的淀积方法,使用它们的技术一直停滞。随着LPCVD和溅射工艺的开发,情况才发生了改变。
所有的现代电路设计,尤其是MOS电路,使用难熔金属或它们的硅化物作为中间层(塞)、阻挡层或导电层。更低的电阻率和更低的接触电阻(见图13.6)使它们作为导电膜更具吸引力,但是杂质和淀积均匀性问题使它们作为MOS栅电极的吸引力降低。对此问题的解决方法是多晶硅化物和硅化物栅结构,它是在硅栅上做一个硅化物的结合、这种结构的细节将在第16章解释。
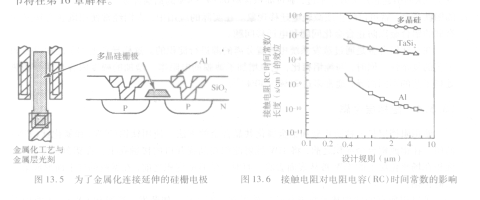
虽然通过采用铝合金和阻挡层金属技术,电迁徙和共晶合金的限制已被缓解,HIP6004CB接触电阻的问题或许成为铝金属化的最终限制。金属系统的全面效果由电阻率、长度、厚度和全部金属和晶圆互连的总的接触电阻所决定。在简单的铝系统中,有两个接触:硅一铝互连和铝互连一压焊线。在具有多层金属层、阻挡层、填塞、多晶硅栅和导体及其他中间导电层的ULSI电路中,连接的数目变得非常大。全部单个接触电阻加起来可能主导金属系统的导电性(见图13.2),
接触电阻受材料、衬底掺杂和接触孔尺寸的影响。接触孔尺寸越小,电阻越高。遗憾的是,U LSI芯片有更小的接触孔,并且大的f]阵列芯片表面可能占接触面积的80%7ii。这两项使接触电阻在VLSI金属系统性能中成为决定因素。铝硅接触电阻及合金问题已导致开始为VLSI金属化研究其他金属。与铝相比,多晶硅有更低的接触电阻,并用在MOS电路中(见图13.5)。这是传奇式的畦栅(silicon gate) MOS器件结构。
难熔金属和它们的硅化物提供了低的接触电阻。有意义的难熔金属是钛( Ti)、钨(W)、钽( Ta)和钼(Mo)。当它们在硅表面被合金时,分别形成它们的硅化物(TiS12、WSi,、TaSi2和MoS12),在20世纪50年代第一次提出将难熔金属用于金属化,但是由于缺乏可靠的淀积方法,使用它们的技术一直停滞。随着LPCVD和溅射工艺的开发,情况才发生了改变。
所有的现代电路设计,尤其是MOS电路,使用难熔金属或它们的硅化物作为中间层(塞)、阻挡层或导电层。更低的电阻率和更低的接触电阻(见图13.6)使它们作为导电膜更具吸引力,但是杂质和淀积均匀性问题使它们作为MOS栅电极的吸引力降低。对此问题的解决方法是多晶硅化物和硅化物栅结构,它是在硅栅上做一个硅化物的结合、这种结构的细节将在第16章解释。
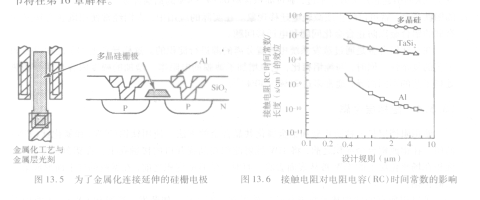



 公网安备44030402000607
公网安备44030402000607





