金属塞
发布时间:2015/11/8 18:49:27 访问次数:783
难熔金属最广泛的用途是在多层金属结构中的通孔填充。这个工艺称为塞填充( plug filling),填充的通孑L称为塞(见图13.7)。 HIP6006CB或者用选择性钨淀积通过表面的孔到第一层金属,或者用CVD技术填充这种通孔8。在可用的难熔金属中,大量使用钨是作为铝硅的阻挡层、MOS栅互连和作为通孔塞。钨依靠其良好的台阶覆盖、降低电阻、抗电迁移和耐高温而受到青睐。然而,它与硅的接触电阻和黏附性的挑战需要额外的层,形成典型的钨堆叠( stack)。在钨淀积之前,Ti首先(接触)被淀积,其次是
TiN(增加黏附性)。此外,通孔可用钨填充,反蚀刻或用化学机械处理(CMP)工艺进行平坦化。
溅射淀积
历史悠久的金属淀积工艺是真空蒸发9。蒸发发生在一个不锈钢罩中,晶圆固定在由电子流加热蒸发的金属源土方的旋转的圆顶七(见图13.8)。随着铝合金和深宽比的通孔覆盖台阶的引入,这种方法遇到厂限制。不同的金属以不同的速率蒸发,它使得淀积均匀的合金很困难。更大直径晶圆的到来限制了蒸发系统的生产速率。溅射淀积(溅射)解决了这些问题,并成为标准的金属淀积方法。
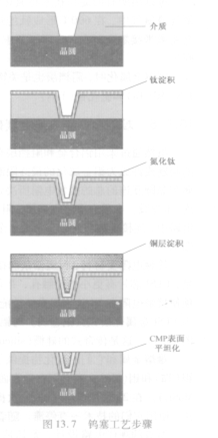
难熔金属最广泛的用途是在多层金属结构中的通孔填充。这个工艺称为塞填充( plug filling),填充的通孑L称为塞(见图13.7)。 HIP6006CB或者用选择性钨淀积通过表面的孔到第一层金属,或者用CVD技术填充这种通孔8。在可用的难熔金属中,大量使用钨是作为铝硅的阻挡层、MOS栅互连和作为通孔塞。钨依靠其良好的台阶覆盖、降低电阻、抗电迁移和耐高温而受到青睐。然而,它与硅的接触电阻和黏附性的挑战需要额外的层,形成典型的钨堆叠( stack)。在钨淀积之前,Ti首先(接触)被淀积,其次是
TiN(增加黏附性)。此外,通孔可用钨填充,反蚀刻或用化学机械处理(CMP)工艺进行平坦化。
溅射淀积
历史悠久的金属淀积工艺是真空蒸发9。蒸发发生在一个不锈钢罩中,晶圆固定在由电子流加热蒸发的金属源土方的旋转的圆顶七(见图13.8)。随着铝合金和深宽比的通孔覆盖台阶的引入,这种方法遇到厂限制。不同的金属以不同的速率蒸发,它使得淀积均匀的合金很困难。更大直径晶圆的到来限制了蒸发系统的生产速率。溅射淀积(溅射)解决了这些问题,并成为标准的金属淀积方法。
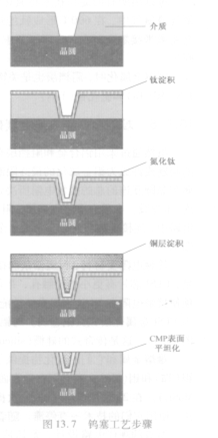
上一篇:难熔金属和难熔金属硅化物
上一篇:溅射工艺的原理
 热门点击
热门点击
- 电容一电压曲线
- 双大马士革工艺
- 溅射工艺的原理
- 步进式光刻机
- 离子束刻蚀
- 管、盒跨接地线
- 电力电缆接头的布置应符合下列要求
- 干氧氧化( dryox)
- 半导体材料的独特性质之一
- 选择性是等离子体刻蚀工艺的一个主要的考虑事项
 推荐技术资料
推荐技术资料
- 泰克新发布的DSA830
- 泰克新发布的DSA8300在一台仪器中同时实现时域和频域分析,DS... [详细]



 公网安备44030402000607
公网安备44030402000607





