BGA封装
发布时间:2012/10/3 17:38:51 访问次数:1503
BGA封装在具有上述优点的同时,也存在下列问题:
①BGA焊后检查和维AO6704修比较困难,必须使用X射线透视或X射线分层检测,才能确保焊接连接的可靠性,设备费用大。
②易吸湿,使用前应经烘干处理。
BGA通常由芯片、基座、封壳和引脚等组成,根据芯片的位置、引脚的排列、基座的材料和密封方式的不同,BGA的封装结构也不同。按芯片放置方式分类,分为芯片表面向上和向下两种;按引脚排列分类,分为球栅阵列均匀全分布、球栅阵列交错全分布、球栅阵列周边分布、球栅阵列带中心散热和接地点的周边分布等;按密封方式分类,分为模制密封和浇注密封等;从散热角度分类,分为热增强型、膜腔向下型和金属体BGA (MBGA);以基座材料不同,BGA可分为PBGA,CBGA,CCGA和TBGA四种,以下将以这四种类型为例介绍BGA的结构和特点。
1.塑封球栅阵列( Plastic Ball Grid Array,PBGA)
(1)结构
PBGA是最普通的BGA封装类型,其结构如图2.75所示。
PBGA的载体是普通的印制板基材,如FR-4、BT树脂等。芯片通过金属丝压焊方式连接到载体的上表面,然后用塑料模压成型,在载体的下表而连接有焊球阵列,焊球合金早期以SnPb居多,现逐步被SnAgCu无铅焊料取代。焊球阵列在器件底面上可以呈完全分布或部分分布,如图2.76所示。
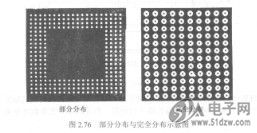
焊球的尺寸为0.75~0.89mm,焊球间距有l.Omm、1.27mm和1.5mm几种。目前I/O数在169~313的已有批量生产,随着各大公司的不断开发,预计近两年内I/O数可达600~1000个。
BGA封装在具有上述优点的同时,也存在下列问题:
①BGA焊后检查和维AO6704修比较困难,必须使用X射线透视或X射线分层检测,才能确保焊接连接的可靠性,设备费用大。
②易吸湿,使用前应经烘干处理。
BGA通常由芯片、基座、封壳和引脚等组成,根据芯片的位置、引脚的排列、基座的材料和密封方式的不同,BGA的封装结构也不同。按芯片放置方式分类,分为芯片表面向上和向下两种;按引脚排列分类,分为球栅阵列均匀全分布、球栅阵列交错全分布、球栅阵列周边分布、球栅阵列带中心散热和接地点的周边分布等;按密封方式分类,分为模制密封和浇注密封等;从散热角度分类,分为热增强型、膜腔向下型和金属体BGA (MBGA);以基座材料不同,BGA可分为PBGA,CBGA,CCGA和TBGA四种,以下将以这四种类型为例介绍BGA的结构和特点。
1.塑封球栅阵列( Plastic Ball Grid Array,PBGA)
(1)结构
PBGA是最普通的BGA封装类型,其结构如图2.75所示。
PBGA的载体是普通的印制板基材,如FR-4、BT树脂等。芯片通过金属丝压焊方式连接到载体的上表面,然后用塑料模压成型,在载体的下表而连接有焊球阵列,焊球合金早期以SnPb居多,现逐步被SnAgCu无铅焊料取代。焊球阵列在器件底面上可以呈完全分布或部分分布,如图2.76所示。
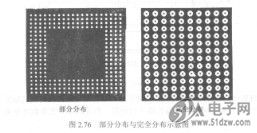
焊球的尺寸为0.75~0.89mm,焊球间距有l.Omm、1.27mm和1.5mm几种。目前I/O数在169~313的已有批量生产,随着各大公司的不断开发,预计近两年内I/O数可达600~1000个。
上一篇: PBGA封装的优点和不足
 热门点击
热门点击
- 三相异步电动机启停的PLC控制
- 简单的方波一三角波产生电路
- 直插式元器件引脚处理
- 兆欧表的工作原理
- 环形多谐振荡器
- 正负误差补偿法
- 交流电路的戴维南等效电路(综合性实验)
- 表面张力与润湿力
- 测量三极管集电结反向电阻
- SMC/SMD焊盘设计
 推荐技术资料
推荐技术资料
- 单片机版光立方的制作
- N视频: http://v.youku.comN_sh... [详细]


 公网安备44030402000607
公网安备44030402000607





