BGA (Ball Grid Array)
发布时间:2012/10/3 17:33:59 访问次数:1069
20世纪80年代中AO6408L后期至90年代,周边端子型的IC(以QPF为代表)得到了巨大的发展和广泛的应用,但由于组装工艺的限制,QFP的尺寸(40rTrm2)、引脚数目(360根)和引脚间距( 0.3mm)已达到了极限,为了适应I/O数的快速增长,由美国Motorola和日本Citigen Watch公司共同开发的新型封装形式――门阵列式球形封装(Ball Grid Array,BGA)于20世纪90年代初投入实际使用。
BGA的引脚成球形阵列状分布在封装的底面,因此它可以有较多的引脚且引脚间距较大。现将具有相同外形尺寸但端子数存在差异的BGA和QFP进行比较,如表2.58所示。

通常BGA的安装高度低、引脚间距大、引脚共面性好,这些都极大地改善了组装的工艺性;由于它的引脚更短,组装密度更高,因此电气性能更优越,特别适合在高频电路中使用。
此外,BGA的散热性良好,由图2.74可见,BGA在工作时芯片的温度更接近环境温度。

20世纪80年代中AO6408L后期至90年代,周边端子型的IC(以QPF为代表)得到了巨大的发展和广泛的应用,但由于组装工艺的限制,QFP的尺寸(40rTrm2)、引脚数目(360根)和引脚间距( 0.3mm)已达到了极限,为了适应I/O数的快速增长,由美国Motorola和日本Citigen Watch公司共同开发的新型封装形式――门阵列式球形封装(Ball Grid Array,BGA)于20世纪90年代初投入实际使用。
BGA的引脚成球形阵列状分布在封装的底面,因此它可以有较多的引脚且引脚间距较大。现将具有相同外形尺寸但端子数存在差异的BGA和QFP进行比较,如表2.58所示。

通常BGA的安装高度低、引脚间距大、引脚共面性好,这些都极大地改善了组装的工艺性;由于它的引脚更短,组装密度更高,因此电气性能更优越,特别适合在高频电路中使用。
此外,BGA的散热性良好,由图2.74可见,BGA在工作时芯片的温度更接近环境温度。

 热门点击
热门点击
- 要熟悉三相异步电动机的反接制动控制的原理
- 用指针式万用表开路检测电解电容器
- 集成电路的参数
- 无铅焊料的表面张力
- 贴片技术与贴片机
- 电脑电源中的三极管
- 多芯片模块(MCM)技术
- 锡须生长失效
- 识别电路板中的场效应管
- SOP型电阻网络
 推荐技术资料
推荐技术资料
- 绘制印制电路板的过程
- 绘制印制电路板是相当重要的过程,EPL2010新颖的理... [详细]

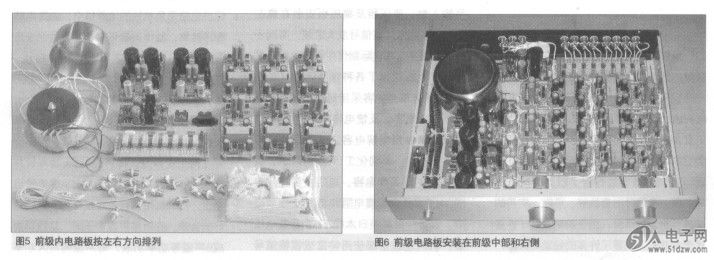
 公网安备44030402000607
公网安备44030402000607





