Al CMP的方法及使用的研磨液
发布时间:2017/11/11 18:44:08 访问次数:1744
主流AlCMP一般采用工步研磨法(见图11.25): QL8X12B-OPF100C
第一步:采用研磨粒为之氧化二铝(A1()3)的研磨液,去除大部分Al金属层,留下薄而均匀的Al金属层((10OOA)。
第二步:采用同样的研磨液,用较低的压力去除剩余的薄而均匀的Al金属层。
第三步:采用同样的研磨液,用较软的研磨垫去除金属阻挡层。
在二步研磨法中,如何控制Al金属层和介电层(si()2)的表面不平整性以及如何降低研磨中所产生的缺陷,是A1CMP的核Jb部分。Al CMP在研磨中所产生的缺陷主要包括表面划痕、腐蚀及点缺陷(pits),这些缺陷与A1CMP所采用的Al的沉积方式、沉积温度、掺杂浓度、AlCMP制程中所使用的研磨液及研磨垫、研磨液供应系统和管线的清洁程度都有很强的关联性。
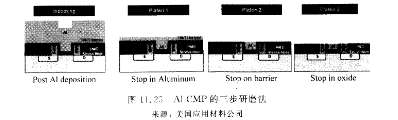
主流AlCMP一般采用工步研磨法(见图11.25): QL8X12B-OPF100C
第一步:采用研磨粒为之氧化二铝(A1()3)的研磨液,去除大部分Al金属层,留下薄而均匀的Al金属层((10OOA)。
第二步:采用同样的研磨液,用较低的压力去除剩余的薄而均匀的Al金属层。
第三步:采用同样的研磨液,用较软的研磨垫去除金属阻挡层。
在二步研磨法中,如何控制Al金属层和介电层(si()2)的表面不平整性以及如何降低研磨中所产生的缺陷,是A1CMP的核Jb部分。Al CMP在研磨中所产生的缺陷主要包括表面划痕、腐蚀及点缺陷(pits),这些缺陷与A1CMP所采用的Al的沉积方式、沉积温度、掺杂浓度、AlCMP制程中所使用的研磨液及研磨垫、研磨液供应系统和管线的清洁程度都有很强的关联性。
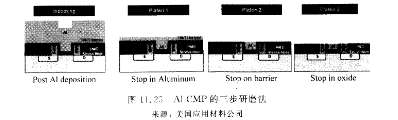
上一篇:GsT CMP的应用
 热门点击
热门点击
- 氮化硅湿法刻蚀
- FIB的原理与SEM相似,
- n-阱和p-阱的形成
- 自对准硅化物工艺
- sACVD薄膜生长的选择性
- 光刻胶形貌
- 源漏极及轻掺杂源漏极的掺杂浓度相对越来越高
- Al CMP的方法及使用的研磨液
- 集成电路制造中的污染和清洗技术
- PN结自建电压
 推荐技术资料
推荐技术资料
- 循线机器人是机器人入门和
- 循线机器人是机器人入门和比赛最常用的控制方式,E48S... [详细]


 公网安备44030402000607
公网安备44030402000607





