CMP在高K金属栅形成中的应用
发布时间:2017/11/11 18:37:56 访问次数:1338
在32nm及以下技术中,栅后方法(gate last approach)是形成高虑金属栅的主流方法之―,而CMP在栅后方法中担当着重要而富有挑战性的角色。 QL4016-3PF100C
图11.23描述了栅后方法的工艺流程。在此流程中有两次CMp的应用:第一次是DO CMP,用以研磨开多晶硅(poly);第二次是Al CMP,用以抛光铝金属。对于ILD0CMP,所涉及的抛光材料比较复杂,要求同时研磨二氧化硅、氮化硅以及多晶硅三种材料,而且它对抛光均匀性控制的要求很高。多晶硅的高度和均匀性控制,以及多晶硅(poly)和介电层(Si()2)的表面不平整性是ILDO CMP的难点。如果研磨不够,则会造成门的高宽比太高,影响随后的高虑金属填充,也可能会造成under etchcd col△tact。严重的研磨不够,留下氮化硅在poly上,则会造成随后p°ly去除不干净,高乃金属的填充就有问题了。多晶硅(poly)和介电层(Si()2)的表面不平整性对于后面的Al CMP也是很大的挑战,如果介电层(Si()2)的凹陷太大,易于在Al CMP后留下铝的残留,造成金属短路,参见表11,4。对于AlCMP,抛光材料是硬度极软的铝金属,在研磨中易于产生刮伤,铝金属是很活泼的金
属,很容易被腐蚀以及产生点缺陷(pits),同时Al CMP对抛光均匀性控制的要求也很高。如果研磨不够,则会造成金属短路;如果研磨过度,则会造成金属栅太低以及over etchedcontact,见表11.5。这些问题使H'DO CMP和Al CMP的工艺难度高,工艺窗口很窄。另外,囚为高虑金属栅的小尺度,使它的良率对CMP缺陷尤为敏感,对CMP缺陷的程度要求很高。总而言之,CMP均匀性控制的改进和CMP缺陷的减少对以栅后方法形成高虑金属门的技术至关重要。
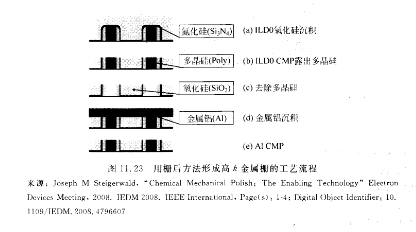
在32nm及以下技术中,栅后方法(gate last approach)是形成高虑金属栅的主流方法之―,而CMP在栅后方法中担当着重要而富有挑战性的角色。 QL4016-3PF100C
图11.23描述了栅后方法的工艺流程。在此流程中有两次CMp的应用:第一次是DO CMP,用以研磨开多晶硅(poly);第二次是Al CMP,用以抛光铝金属。对于ILD0CMP,所涉及的抛光材料比较复杂,要求同时研磨二氧化硅、氮化硅以及多晶硅三种材料,而且它对抛光均匀性控制的要求很高。多晶硅的高度和均匀性控制,以及多晶硅(poly)和介电层(Si()2)的表面不平整性是ILDO CMP的难点。如果研磨不够,则会造成门的高宽比太高,影响随后的高虑金属填充,也可能会造成under etchcd col△tact。严重的研磨不够,留下氮化硅在poly上,则会造成随后p°ly去除不干净,高乃金属的填充就有问题了。多晶硅(poly)和介电层(Si()2)的表面不平整性对于后面的Al CMP也是很大的挑战,如果介电层(Si()2)的凹陷太大,易于在Al CMP后留下铝的残留,造成金属短路,参见表11,4。对于AlCMP,抛光材料是硬度极软的铝金属,在研磨中易于产生刮伤,铝金属是很活泼的金
属,很容易被腐蚀以及产生点缺陷(pits),同时Al CMP对抛光均匀性控制的要求也很高。如果研磨不够,则会造成金属短路;如果研磨过度,则会造成金属栅太低以及over etchedcontact,见表11.5。这些问题使H'DO CMP和Al CMP的工艺难度高,工艺窗口很窄。另外,囚为高虑金属栅的小尺度,使它的良率对CMP缺陷尤为敏感,对CMP缺陷的程度要求很高。总而言之,CMP均匀性控制的改进和CMP缺陷的减少对以栅后方法形成高虑金属门的技术至关重要。
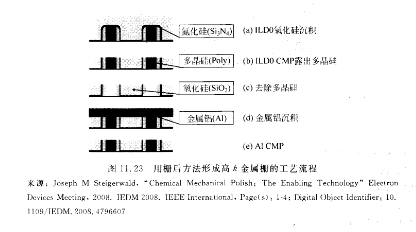
上一篇:划痕(scratches)



 公网安备44030402000607
公网安备44030402000607





