氧化铈研磨液的特点
发布时间:2017/11/10 22:45:26 访问次数:1594
不同于以机械作用为主导的氧化硅研磨液抛光,氧化铈(CcO3)研磨液抛光是以化学作用为主导,它具有以下几个特征: OP262GSZ
(1)平坦效率高,能选择性地磨平凸面,对沟槽的保护性好。
(2)对氮化硅具有较高的选择比,在一定程度上能实现自动终止抛光。
(3)最大限度地减少不同图形密度区域的膜厚差值。
为什么氧化铈研磨液具有平坦效率高和高选择比的特点呢?这要从氧化铈研磨液和浅槽隔离区的表面电荷说起。
在研磨液中研磨颗粒氧化铈粒子带正电荷,而这些研磨粒子是被带负电荷的添加剂粒子团团包围着的。在一定的外界压力下,研磨液碰到凸起的氧化硅表面时,因局部接触压力增高而产生挤压,把氧化铈粒子与添加剂粒子之间的结合力打破,释放出来的氧化铈粒子就对凸面产生磨削抛光效果,而浅槽隔离区表面因凹陷局部压力小,氧化铈始终被带负电荷的添加剂团团包围而很少或几乎没有磨削抛光效果,由此持续不断地就达到了选择性地平整凸面保护沟槽的效果,原理图如图11.4所示。在抛光的初期阶段,平坦效率是由凸面上的局部压力与研磨液中的添加剂相互作用共同主导的,直到晶片表面的台阶高度基本被磨平。当晶片表面的台阶高度基本平整后,来到了抛光的后期阶段,这时氧化硅逐渐磨完而抛光终止层氮化硅露出表面。氧化硅表面带负电荷,而氮化硅表面带正电荷。这个阶段的抛光效率是由研磨液中的氧化铈粒子和添加剂粒子主导的,氧化铈研磨液显示了它对氮化硅的高选择比,见图11.5。由于氮化硅表面带正电荷,它的表面吸附了一层带负电荷的添加剂粒子,形成了坚固的保护层;同时也由于带正电荷的氧化铈粒子与氮化硅表面的相互排斥,氧化铈研磨液对氮化硅的抛光速率要远远低于对氧化硅,所以抛光能自动终止在氮化硅层上。
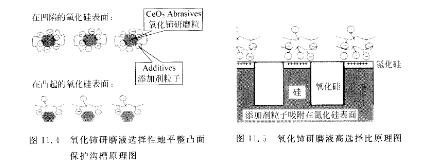
不同于以机械作用为主导的氧化硅研磨液抛光,氧化铈(CcO3)研磨液抛光是以化学作用为主导,它具有以下几个特征: OP262GSZ
(1)平坦效率高,能选择性地磨平凸面,对沟槽的保护性好。
(2)对氮化硅具有较高的选择比,在一定程度上能实现自动终止抛光。
(3)最大限度地减少不同图形密度区域的膜厚差值。
为什么氧化铈研磨液具有平坦效率高和高选择比的特点呢?这要从氧化铈研磨液和浅槽隔离区的表面电荷说起。
在研磨液中研磨颗粒氧化铈粒子带正电荷,而这些研磨粒子是被带负电荷的添加剂粒子团团包围着的。在一定的外界压力下,研磨液碰到凸起的氧化硅表面时,因局部接触压力增高而产生挤压,把氧化铈粒子与添加剂粒子之间的结合力打破,释放出来的氧化铈粒子就对凸面产生磨削抛光效果,而浅槽隔离区表面因凹陷局部压力小,氧化铈始终被带负电荷的添加剂团团包围而很少或几乎没有磨削抛光效果,由此持续不断地就达到了选择性地平整凸面保护沟槽的效果,原理图如图11.4所示。在抛光的初期阶段,平坦效率是由凸面上的局部压力与研磨液中的添加剂相互作用共同主导的,直到晶片表面的台阶高度基本被磨平。当晶片表面的台阶高度基本平整后,来到了抛光的后期阶段,这时氧化硅逐渐磨完而抛光终止层氮化硅露出表面。氧化硅表面带负电荷,而氮化硅表面带正电荷。这个阶段的抛光效率是由研磨液中的氧化铈粒子和添加剂粒子主导的,氧化铈研磨液显示了它对氮化硅的高选择比,见图11.5。由于氮化硅表面带正电荷,它的表面吸附了一层带负电荷的添加剂粒子,形成了坚固的保护层;同时也由于带正电荷的氧化铈粒子与氮化硅表面的相互排斥,氧化铈研磨液对氮化硅的抛光速率要远远低于对氧化硅,所以抛光能自动终止在氮化硅层上。
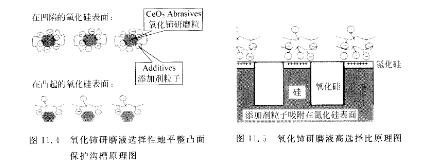
上一篇:一种革命性的抛光技术脱颖而出
上一篇:固定研磨粒抛光工艺



 公网安备44030402000607
公网安备44030402000607





