关键尺寸及套刻精度的测量
发布时间:2017/10/25 21:20:12 访问次数:1722
图7,12(a)为扫描电子显微镜所拍摄的尺寸测量截图,图中白色的双线和相对的箭头代表目标尺寸。 TA7505M扫描电子显微镜的像对比度由经过电子轰击所产生的二次电子发射和被收集形成的。可以看出,在线条的边缘,可以收集到较多的二次电子。原则上,收集到的电子越多,测量得也就越准确。可是,由于电子束对光刻胶的冲击不可忽略「I21,经过电子束照射,光刻胶会缩小,尤其以193nm的胶最严重。所以建立一个可测量性与小破坏性的平衡变得十分重要。
图7,12(b)为典型的套刻测量示意图,其中线条粗细一般为1~3um,外框边长一般为20~30um,内框边长一般为10~⒛um。在这张图里,内框和外框显示不同的色彩或者对比度是由于不同的层次薄膜厚度的不同所产生的反射光的色彩以及对比度的差异。套刻的测量通过确定内框中央点和外框中央点的空间差异来实现。实践证明,只要提供足够的信号强度,即便是光学显微镜,也能够实现1nm左右的测量精度。
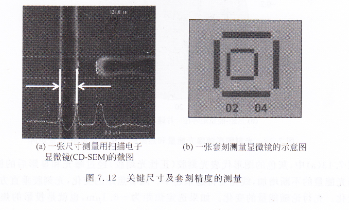
图7,12(a)为扫描电子显微镜所拍摄的尺寸测量截图,图中白色的双线和相对的箭头代表目标尺寸。 TA7505M扫描电子显微镜的像对比度由经过电子轰击所产生的二次电子发射和被收集形成的。可以看出,在线条的边缘,可以收集到较多的二次电子。原则上,收集到的电子越多,测量得也就越准确。可是,由于电子束对光刻胶的冲击不可忽略「I21,经过电子束照射,光刻胶会缩小,尤其以193nm的胶最严重。所以建立一个可测量性与小破坏性的平衡变得十分重要。
图7,12(b)为典型的套刻测量示意图,其中线条粗细一般为1~3um,外框边长一般为20~30um,内框边长一般为10~⒛um。在这张图里,内框和外框显示不同的色彩或者对比度是由于不同的层次薄膜厚度的不同所产生的反射光的色彩以及对比度的差异。套刻的测量通过确定内框中央点和外框中央点的空间差异来实现。实践证明,只要提供足够的信号强度,即便是光学显微镜,也能够实现1nm左右的测量精度。
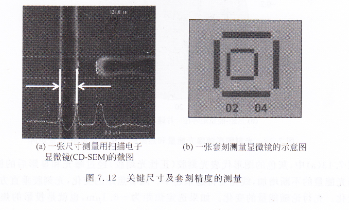
上一篇:显影后烘焙,坚膜烘焙



 公网安备44030402000607
公网安备44030402000607





