覆盖层
发布时间:2017/10/18 21:01:57 访问次数:494
高乃介质的另一个挑战是yt的调节。多晶硅栅极可以通过不同的掺杂实现(P型和N型),金属栅极则需要找到适合PMOS和NMOS的具有不同功函数的金属材料。 NCP3170ADR2G不幸的是大多数栅极金属材料在经过源/漏高温热处理后,功函数都会漂移到带隙中问,从而失去V1调节的功用(详述见金属栅极章节)。所以对于先栅极工艺,通常采用功函数位于带隙中间的金属(如TiN),而通过在高乃介质上(或下)沉积不同的覆盖层来调节V1。对NMOS,覆盖层需要含有更加电正性的原子(L助O3),而对PMOS,覆盖层需要含有更加电负性的原子(A12O3)。在高温热处理后,覆盖层会与高花介质/界面层发生互混,在高虍介质/界面层的界面上形成偶极子,从而起到V1调节的作用。图4.11表示不同覆盖层对平带电压的影响,可以看到这种方法对NMC)S的作用十分明显(La2()3),而对PM()S,效果则不显著(A1203),而且由于A1203的乃值较低,PMOS的EOT也会受到影响。
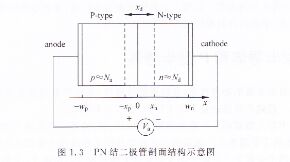
高乃介质的另一个挑战是yt的调节。多晶硅栅极可以通过不同的掺杂实现(P型和N型),金属栅极则需要找到适合PMOS和NMOS的具有不同功函数的金属材料。 NCP3170ADR2G不幸的是大多数栅极金属材料在经过源/漏高温热处理后,功函数都会漂移到带隙中问,从而失去V1调节的功用(详述见金属栅极章节)。所以对于先栅极工艺,通常采用功函数位于带隙中间的金属(如TiN),而通过在高乃介质上(或下)沉积不同的覆盖层来调节V1。对NMOS,覆盖层需要含有更加电正性的原子(L助O3),而对PMOS,覆盖层需要含有更加电负性的原子(A12O3)。在高温热处理后,覆盖层会与高花介质/界面层发生互混,在高虍介质/界面层的界面上形成偶极子,从而起到V1调节的作用。图4.11表示不同覆盖层对平带电压的影响,可以看到这种方法对NMC)S的作用十分明显(La2()3),而对PM()S,效果则不显著(A1203),而且由于A1203的乃值较低,PMOS的EOT也会受到影响。
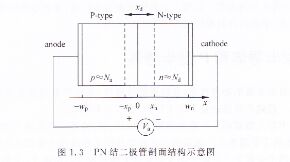
上一篇:界面层
上一篇:半导体绝缘介质的填充
 热门点击
热门点击
- n-阱和p-阱的形成
- 自对准硅化物工艺
- 工序与工步
- sACVD薄膜生长的选择性
- 源漏极及轻掺杂源漏极的掺杂浓度相对越来越高
- PN结自建电压
- 存储器技术和制造工艺
- 与传统的PVD相比较,ALPs主要有三个方面
- 接触窗薄膜工艺
- HKMG(高七介质层+金属栅极)整合工艺
 推荐技术资料
推荐技术资料
- 循线机器人是机器人入门和
- 循线机器人是机器人入门和比赛最常用的控制方式,E48S... [详细]


 公网安备44030402000607
公网安备44030402000607





