自对准多晶硅化物,接触孔和钨塞的形成
发布时间:2017/10/14 11:11:57 访问次数:1568
自对准多晶硅化物,接触孔R1EX24256BTAS0I和钨塞的形成如图3.11所示。在湿法清洁去除有源区(AA)和多晶硅栅表面的氧化物以后,溅射一薄层(200A)钴(Co),紧接着进行第一次RTA(55o℃),和硅接触的钴将会发生反应。然后,氧化硅上剩余的没有反应的钴将用SC1溶剂去掉,并进行第二次RTA(740℃)。因此,有源区和多晶硅栅区域会以自对准的方式形成 钴的硅化物,这被称为自对准多晶硅化物工艺然后,通过沉积氮氧硅(150A)和磷硅玻璃(PSG,5,5kA)形成多金属介质(PMD),并使用CMP进行平坦化。沉积一层CVD氧化物(Teos o蛀de)用来密封PSG。然后形成打开接触孔的掩模(掩模CT),随后刻蚀接触孔上的PSG和⒏N。接下来溅射Ti(150A)和TiN(50A),用CVD法沉积钨(W,3kA)并用RTA(700℃)进行退火。△层对于减小接触电阻十分重要,侧壁上覆盖的TiN用以保证W填充工艺的完整性[12],使得填充到接触孔中的W没有空隙。对钨表面进行抛光(使用CMP)直到露出Teos°xid表面,此时接触孔内的钨塞就形成了。
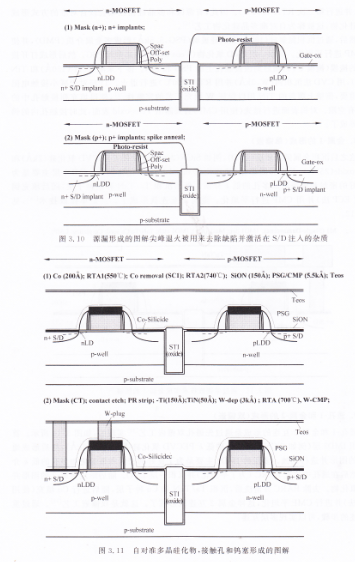
自对准多晶硅化物,接触孔R1EX24256BTAS0I和钨塞的形成如图3.11所示。在湿法清洁去除有源区(AA)和多晶硅栅表面的氧化物以后,溅射一薄层(200A)钴(Co),紧接着进行第一次RTA(55o℃),和硅接触的钴将会发生反应。然后,氧化硅上剩余的没有反应的钴将用SC1溶剂去掉,并进行第二次RTA(740℃)。因此,有源区和多晶硅栅区域会以自对准的方式形成 钴的硅化物,这被称为自对准多晶硅化物工艺然后,通过沉积氮氧硅(150A)和磷硅玻璃(PSG,5,5kA)形成多金属介质(PMD),并使用CMP进行平坦化。沉积一层CVD氧化物(Teos o蛀de)用来密封PSG。然后形成打开接触孔的掩模(掩模CT),随后刻蚀接触孔上的PSG和⒏N。接下来溅射Ti(150A)和TiN(50A),用CVD法沉积钨(W,3kA)并用RTA(700℃)进行退火。△层对于减小接触电阻十分重要,侧壁上覆盖的TiN用以保证W填充工艺的完整性[12],使得填充到接触孔中的W没有空隙。对钨表面进行抛光(使用CMP)直到露出Teos°xid表面,此时接触孔内的钨塞就形成了。
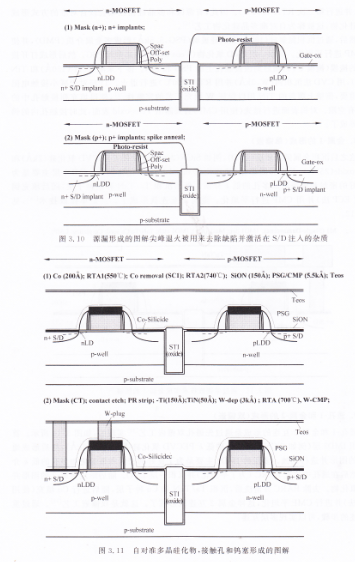
上一篇:隔离的形成
上一篇:金属-1的形成(单镶嵌)



 公网安备44030402000607
公网安备44030402000607





