在硅中高斯分布的硼经热
发布时间:2017/5/12 21:53:14 访问次数:628
图⒋28所示是在硅中高斯分布的硼经热氧化后的浓度分布情况。图中虚ORIONC1线表示的是热氧化前理想的高斯分布,圆点表示的是热氧化后硼分布的实验结果。图中实线是按Κ=0.1计算的再分布情形。
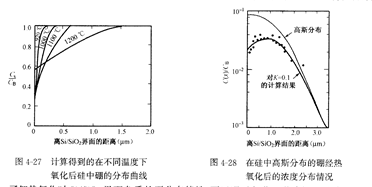
图⒋28 在硅中高斯分布的硼经热
了解热氧化时s/SiO2界面杂质的再分布特性,可以通过氧化工艺来调整硅表面的杂质浓度。例如,在3DK4硼扩散预淀积工序中,当杂质浓度偏大时,就可以通过二次氧化(也就是再分布)来调整硅表面的杂质浓度:将干氧――湿氧一干氧I艺的初次干氧时间缩短,甚至直接进行湿氧,湿氧时间增加,但氧化总时间不变。工次氧化后,硅表面硼浓度将有所降低,这是因为在氧化引起杂质再分布的几个因素中,⒊/SiO2界面移动速率是主要因素:湿氧氧化速率快,预淀积在硅表面的硼在还未扩散到硅内部时就被迅速生长的二氧化硅吸收。其次,由于杂质的分凝效应,二氧化硅吸收硼(K:=0.3)。
图⒋28所示是在硅中高斯分布的硼经热氧化后的浓度分布情况。图中虚ORIONC1线表示的是热氧化前理想的高斯分布,圆点表示的是热氧化后硼分布的实验结果。图中实线是按Κ=0.1计算的再分布情形。
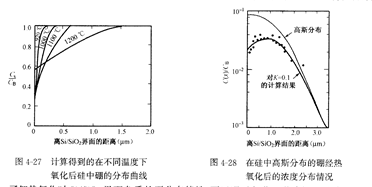
图⒋28 在硅中高斯分布的硼经热
了解热氧化时s/SiO2界面杂质的再分布特性,可以通过氧化工艺来调整硅表面的杂质浓度。例如,在3DK4硼扩散预淀积工序中,当杂质浓度偏大时,就可以通过二次氧化(也就是再分布)来调整硅表面的杂质浓度:将干氧――湿氧一干氧I艺的初次干氧时间缩短,甚至直接进行湿氧,湿氧时间增加,但氧化总时间不变。工次氧化后,硅表面硼浓度将有所降低,这是因为在氧化引起杂质再分布的几个因素中,⒊/SiO2界面移动速率是主要因素:湿氧氧化速率快,预淀积在硅表面的硼在还未扩散到硅内部时就被迅速生长的二氧化硅吸收。其次,由于杂质的分凝效应,二氧化硅吸收硼(K:=0.3)。
上一篇:热氧化后硅片中硼的表面浓度
上一篇:氧化层的质量及检测
 热门点击
热门点击
- 菲克(Fick)第一扩散定律
- 测量光学系统实际分辨率的鉴别率板
- 界面陷阱电荷
- 自制接触型近场探头
- 磷扩散
- 固溶体主要可分为两类
- 晶面通过一系列称为米勒指数的三个数字组合来表
- 二氧化硅薄膜的结构缺陷主要是氧化层错
- 单晶硅特性
- 系统性能的提高并不需要全部用在提高系统信噪比
 推荐技术资料
推荐技术资料
- 泰克新发布的DSA830
- 泰克新发布的DSA8300在一台仪器中同时实现时域和频域分析,DS... [详细]


 公网安备44030402000607
公网安备44030402000607





