热氧化后硅片中硼的表面浓度
发布时间:2017/5/12 21:50:06 访问次数:782
图⒋26所示是热氧化后硅片中硼的表面浓度,它代表的含义是均匀掺硼的硅片,经无掺OPA2211AIDRGT杂干氧和水汽氧化之后,硅表面浓度Cs与硅内浓度咣之比随氧化温度变化关系的计算结果,其中硼的分凝系数按0,3计算。由图可见,在相同温度下,快速的水汽氧化所引起的再分布程度高于干氧氧化,即水汽氧化的Cs/咣小于干氧氧化。同样也可以看到,不论是水汽氧化,还是干氧氧化,Cs/G都随温度的升高而变大,这是因为扩散速率加快而补偿了硅表面杂质的损耗。
图⒋26 热氧化后硅片中硼的表面浓度
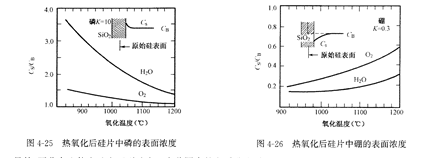
另外,再分布也使由硅表面到硅内一定范围内的杂质分布受到影响。受影响的程度和深度与被扰动的范围有关。受扰动范围的大小近似地等于杂质扩散长度√0r。图⒋27给出的是计算得到的
在不同温度下氧化后硅中硼的分布曲线,每次氧化厚度均控制在0,2um。上面讨沦的是均匀掺杂的硅片经热氧化后的杂质再分布情况。而实际情况并不一定是均匀掺杂,因此再分布之后的情况变得更复杂。
图⒋26所示是热氧化后硅片中硼的表面浓度,它代表的含义是均匀掺硼的硅片,经无掺OPA2211AIDRGT杂干氧和水汽氧化之后,硅表面浓度Cs与硅内浓度咣之比随氧化温度变化关系的计算结果,其中硼的分凝系数按0,3计算。由图可见,在相同温度下,快速的水汽氧化所引起的再分布程度高于干氧氧化,即水汽氧化的Cs/咣小于干氧氧化。同样也可以看到,不论是水汽氧化,还是干氧氧化,Cs/G都随温度的升高而变大,这是因为扩散速率加快而补偿了硅表面杂质的损耗。
图⒋26 热氧化后硅片中硼的表面浓度
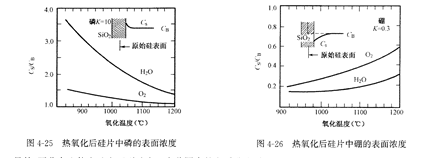
另外,再分布也使由硅表面到硅内一定范围内的杂质分布受到影响。受影响的程度和深度与被扰动的范围有关。受扰动范围的大小近似地等于杂质扩散长度√0r。图⒋27给出的是计算得到的
在不同温度下氧化后硅中硼的分布曲线,每次氧化厚度均控制在0,2um。上面讨沦的是均匀掺杂的硅片经热氧化后的杂质再分布情况。而实际情况并不一定是均匀掺杂,因此再分布之后的情况变得更复杂。
上一篇:再分布对硅表面杂质浓度的影响
上一篇:在硅中高斯分布的硼经热



 公网安备44030402000607
公网安备44030402000607





