反应剂浓度对生长速率的影响
发布时间:2017/5/9 21:47:13 访问次数:829
硅源无须还原剂,通过自身分解就生成了⒊和H2,夕卜延气体中的H2只是用来作为稀释气体。sH1可以在低于900℃的温度下生长很薄的外延层,LD1117S50TR而且有较高的生长速率,也是当前采用较多的外延硅源。另外,新硅源s2H6是一种在低温外延中使用的硅源,目前应用得还不多。
反应剂浓度对生长速率的影响
外延气体中硅源浓度越高,质量传递到达衬底表面的外延剂也就越多,表面外延过程也就越快, 外延生长速率理所当然地就提高了。但实际上并不是反应剂浓度高外延生长速率就一定高。
图38所示是硅源为slC1时,实测得到⒊C1在H2中的摩尔浓度与外延生长速率的关系曲线。当⒏C11浓度很低时,增加其浓度直至A点,质量传递到达衬底表面的SiC增多,表面外延过程加快,外延生长速率也就提高了;而后再继续增加⒊C14浓度,尽管生长速率继续提高,但表面外延过程中化学反应释放硅原子速度大于硅原子在衬底表面的排列速度,这样生长的是多晶硅,此时硅原子在衬底表面的排列速度控制着外延生长速率;进一步增大浓度到达B点,再增加⒏Cl】浓度,生长速率反而开始减小,这是由于sC11的H2还原反应是可逆的;当H2中SiCL摩尔分数增至大于0,28时,只存在⒏的腐蚀反应
了。因此,采用⒏C14为硅源时,通常控制其在对衬底无腐蚀的低浓度区,外延生长速率大约为1um/min。
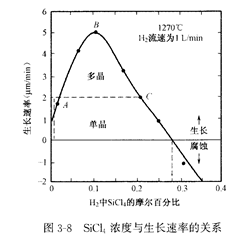
以sH1为硅源时,⒊Hl在载气氢中的浓度也存在临界值,sH1浓度超过与温度相关的临界值时,⒏H1在气相中就将发生分解反应,生成细小硅粒,并淀积到衬底上,而不是在衬底上发生分解反应,所以得不到单晶硅外延层。
硅源无须还原剂,通过自身分解就生成了⒊和H2,夕卜延气体中的H2只是用来作为稀释气体。sH1可以在低于900℃的温度下生长很薄的外延层,LD1117S50TR而且有较高的生长速率,也是当前采用较多的外延硅源。另外,新硅源s2H6是一种在低温外延中使用的硅源,目前应用得还不多。
反应剂浓度对生长速率的影响
外延气体中硅源浓度越高,质量传递到达衬底表面的外延剂也就越多,表面外延过程也就越快, 外延生长速率理所当然地就提高了。但实际上并不是反应剂浓度高外延生长速率就一定高。
图38所示是硅源为slC1时,实测得到⒊C1在H2中的摩尔浓度与外延生长速率的关系曲线。当⒏C11浓度很低时,增加其浓度直至A点,质量传递到达衬底表面的SiC增多,表面外延过程加快,外延生长速率也就提高了;而后再继续增加⒊C14浓度,尽管生长速率继续提高,但表面外延过程中化学反应释放硅原子速度大于硅原子在衬底表面的排列速度,这样生长的是多晶硅,此时硅原子在衬底表面的排列速度控制着外延生长速率;进一步增大浓度到达B点,再增加⒏Cl】浓度,生长速率反而开始减小,这是由于sC11的H2还原反应是可逆的;当H2中SiCL摩尔分数增至大于0,28时,只存在⒏的腐蚀反应
了。因此,采用⒏C14为硅源时,通常控制其在对衬底无腐蚀的低浓度区,外延生长速率大约为1um/min。
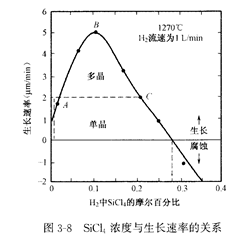
以sH1为硅源时,⒊Hl在载气氢中的浓度也存在临界值,sH1浓度超过与温度相关的临界值时,⒏H1在气相中就将发生分解反应,生成细小硅粒,并淀积到衬底上,而不是在衬底上发生分解反应,所以得不到单晶硅外延层。
上一篇:影响外延生长速率的因素
上一篇:对生长速率有影响的其他因素



 公网安备44030402000607
公网安备44030402000607





