��Դ�����γ�
����ʱ��:2016/6/18 20:43:02 ���ʴ���:3772
����,��P��ĵ�(St��b�atc)/P������(Epitaxial)������������һ����������(Sio2),OP2177ARZ-REEL7�ò���������Ϊ�ĵ�������(Pad oxide),��������Ϊ�˻�����������ĵ�����(Si3N4)���ĵ�֮���Ӧ��,������ΪSi3N4��֮�����������ͬ,����֮������Žϴ��Ӧ��,��si3N4��siֱ�ӽӴ�,���������Ƭ���ѡ������ٳ���Si3N4�����Ϳ����ʹ��1#��̰�����ع����Ӱ,��Ӱ��������������Ĺ�̽���ȥ�������Ÿ�ʴSi3N4��Sio2��Si,��ʱδ����̽����ǵ������si3N4��Sio2��Si������ʴ��,��ԲƬ���γ��˹��dz��,��ͼ4,3��ʾ��
ͼ43 sTI��ʴ������������ͼ
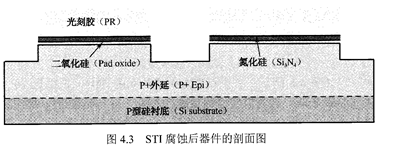
����,��P��ĵ�(St��b�atc)/P������(Epitaxial)������������һ����������(Sio2),OP2177ARZ-REEL7�ò���������Ϊ�ĵ�������(Pad oxide),��������Ϊ�˻�����������ĵ�����(Si3N4)���ĵ�֮���Ӧ��,������ΪSi3N4��֮�����������ͬ,����֮������Žϴ��Ӧ��,��si3N4��siֱ�ӽӴ�,���������Ƭ���ѡ������ٳ���Si3N4�����Ϳ����ʹ��1#��̰�����ع����Ӱ,��Ӱ��������������Ĺ�̽���ȥ�������Ÿ�ʴSi3N4��Sio2��Si,��ʱδ����̽����ǵ������si3N4��Sio2��Si������ʴ��,��ԲƬ���γ��˹��dz��,��ͼ4,3��ʾ��
ͼ43 sTI��ʴ������������ͼ
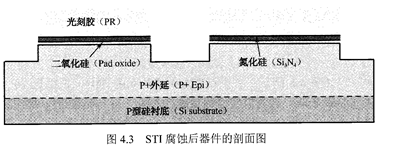
��һƪ��CMOs���ɵ�·�Ļ������칤��
��һƪ��sTI�γɺ�����������ͼ
 �������
�������
- PCBA��װͨ����ת���չ淶
- ��Դ�����γ�
- ��������ע�����
- �������IJ���
- ������ָ��ȷ���ֱ�Ҫ�Ͳ���Ҫ����Ʒ
- ������sC�D1��Һ�е��������ܽ�
- �뵼��������ʹ�õ�ˮ�dz���ȥ����ˮ
- ����·���ܷ���
- ����ע�����������Ũ��
- ע��
 �Ƽ���������
�Ƽ���������
- ��ѩ��������
- ������һ��dz���Ȥ��ͬʱ����һ�������Ѷȵ��淨��EDE2116AB... [��ϸ]


 ��������44030402000607
��������44030402000607





