高密度等离子体CVD
发布时间:2015/11/7 22:17:11 访问次数:1043
金属层间介质(IDL)层对多层金属的结构极为重要。其主要的难题在对高深宽比(大于3:1)孔的填充上。GF1B-E3/67A一种途径是使淀积和原位( in situ)刻蚀有序进行。初始淀积时,通常底部较薄。将肩部刻蚀掉,然后再淀积,从而形成均匀的淀积层和较为平坦的表面。
实现这种工艺的系统是高密度等离子体CVD(High-DensityPlasma CVD, HDPCVD)n。在CVD反应室的内部形成等离子体场、,该等离子场含有氧气和硅烷( Silane),用以淀积二氧化
硅。此外,还含有由等离子体中提供能量的氩离子,直接撞击晶圆表面,该现象称为溅射反应(见9.5节),从晶圆表面和沟槽中去除材料。HDPCVD具有淀积多种材料的潜能,用于IMD层、刻蚀终止层和最后的钝化层。
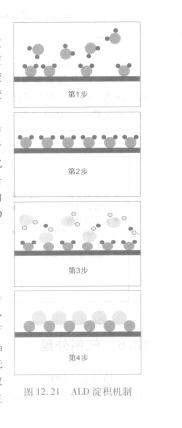
金属层间介质(IDL)层对多层金属的结构极为重要。其主要的难题在对高深宽比(大于3:1)孔的填充上。GF1B-E3/67A一种途径是使淀积和原位( in situ)刻蚀有序进行。初始淀积时,通常底部较薄。将肩部刻蚀掉,然后再淀积,从而形成均匀的淀积层和较为平坦的表面。
实现这种工艺的系统是高密度等离子体CVD(High-DensityPlasma CVD, HDPCVD)n。在CVD反应室的内部形成等离子体场、,该等离子场含有氧气和硅烷( Silane),用以淀积二氧化
硅。此外,还含有由等离子体中提供能量的氩离子,直接撞击晶圆表面,该现象称为溅射反应(见9.5节),从晶圆表面和沟槽中去除材料。HDPCVD具有淀积多种材料的潜能,用于IMD层、刻蚀终止层和最后的钝化层。
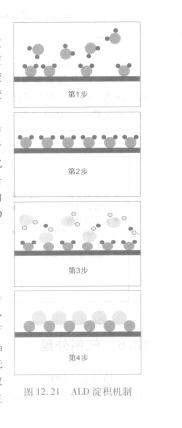
上一篇:水平垂直流PECVD
上一篇:原子层淀积
 热门点击
热门点击


 公网安备44030402000607
公网安备44030402000607





