原子层淀积
发布时间:2015/11/7 22:19:27 访问次数:694
与其他每种微芯片工艺类似,CVD已经随着尺寸改变而改变。下一代CVD系统加入了原子层淀积(Atomic Layer Deposition,ALD)。GL2576除了独特的脉冲调制技术,它基于基本的CVD。【艺方法。一个典犁的CVD系统将先驱化学物引入腔室,在那里在晶圆表面上淀积期望的材料( Si、Si0,、S13 N。)层。在ALD中,先
驱物被依次引入腔室,但是被一种吹扫气体分开。在表面的效应如图12. 21所示。ALD还是一种自限制工艺,因为反应发生在晶圆的表面上,而不是腔室内。由于每种薄膜台阶是以单层速率生的,所以控制非常精确。另外,这种慢速率有助于晶圆表面高的共面性水平和致密薄膜成分。ALD的薄层厚度已经从通常的CVD的300 A水平降到12 A的范围。
艺在真空中进行。一种常用示意系统如图12. 22所示。
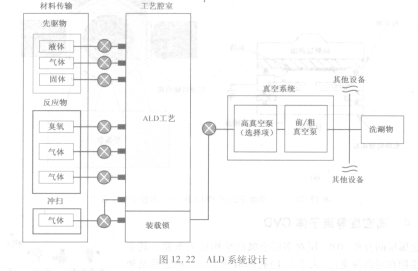
与其他每种微芯片工艺类似,CVD已经随着尺寸改变而改变。下一代CVD系统加入了原子层淀积(Atomic Layer Deposition,ALD)。GL2576除了独特的脉冲调制技术,它基于基本的CVD。【艺方法。一个典犁的CVD系统将先驱化学物引入腔室,在那里在晶圆表面上淀积期望的材料( Si、Si0,、S13 N。)层。在ALD中,先
驱物被依次引入腔室,但是被一种吹扫气体分开。在表面的效应如图12. 21所示。ALD还是一种自限制工艺,因为反应发生在晶圆的表面上,而不是腔室内。由于每种薄膜台阶是以单层速率生的,所以控制非常精确。另外,这种慢速率有助于晶圆表面高的共面性水平和致密薄膜成分。ALD的薄层厚度已经从通常的CVD的300 A水平降到12 A的范围。
艺在真空中进行。一种常用示意系统如图12. 22所示。
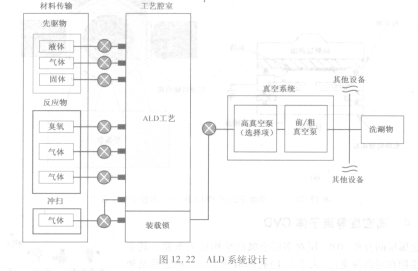
上一篇:高密度等离子体CVD
上一篇:气相外延



 公网安备44030402000607
公网安备44030402000607





