有两种类型的化学显影液用于正光刻胶
发布时间:2015/11/1 18:46:53 访问次数:1450
有两种类型的化学显影液用于正光刻胶,碱水溶液和非离子溶液。碱一水KTS6029-2溶液可以是氢氧化钠或氢氧化钾。因为这两种溶液都含有可动的离子污染物,所以在制造敏感的电路时不能使用。大多数用正光刻胶的工艺线使用非离子的四甲基氢氧化铵( TMAH)溶液。有时要添加表面活性剂来去除表面张力,使溶液更易亲合晶圆表面。正光刻胶的水溶性使它们在环保上比有机溶液的负光刻胶更具吸引力。
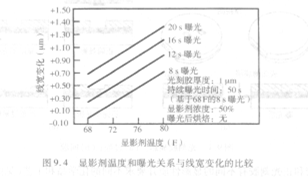
接着的显影步骤是为了停止显影过程和从晶圆表面去除显影液的冲洗。对正光刻胶冲洗用的是水,它带来的是更简单的处理和成本的降低,并有利于环境。
正光刻胶的显影工艺比负光刻胶更为敏感¨j。影响结果的因素是软烘焙时间和温度、曝光度、显影液浓度、时间、温度,以及显影方法。显影工艺参数由所有变量的测试来决定、图9.4显示了一个特定的工艺参数对线宽昀影响。
当使用正光刻胶时,显影和清洗工艺的严格控制是尺寸控制的关键。对正光刻胶显影液清洗的化学品是水。它的作用与负光刻胶清洗液相同,但是更便宜、使用更安全,更容易处理。
有两种类型的化学显影液用于正光刻胶,碱水溶液和非离子溶液。碱一水KTS6029-2溶液可以是氢氧化钠或氢氧化钾。因为这两种溶液都含有可动的离子污染物,所以在制造敏感的电路时不能使用。大多数用正光刻胶的工艺线使用非离子的四甲基氢氧化铵( TMAH)溶液。有时要添加表面活性剂来去除表面张力,使溶液更易亲合晶圆表面。正光刻胶的水溶性使它们在环保上比有机溶液的负光刻胶更具吸引力。
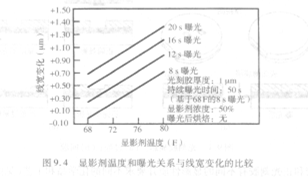
接着的显影步骤是为了停止显影过程和从晶圆表面去除显影液的冲洗。对正光刻胶冲洗用的是水,它带来的是更简单的处理和成本的降低,并有利于环境。
正光刻胶的显影工艺比负光刻胶更为敏感¨j。影响结果的因素是软烘焙时间和温度、曝光度、显影液浓度、时间、温度,以及显影方法。显影工艺参数由所有变量的测试来决定、图9.4显示了一个特定的工艺参数对线宽昀影响。
当使用正光刻胶时,显影和清洗工艺的严格控制是尺寸控制的关键。对正光刻胶显影液清洗的化学品是水。它的作用与负光刻胶清洗液相同,但是更便宜、使用更安全,更容易处理。
 热门点击
热门点击


 公网安备44030402000607
公网安备44030402000607





