多层堆叠装配的返修
发布时间:2014/5/29 20:45:03 访问次数:671
POP返修变得相当困难。SDP410Q_PFLG如何将需要返修的元件移除并成功重新贴装,而不影响其他堆叠元件和周围元件及电路板是值得研究的重要课题。
POP的返修步骤与BGA的返修步骤基本相同。
①拆除芯片。拆除芯片的正确方法是一次性将POP整体从PCB上取下来。
OK公司开发的镊形喷嘴[见图21-44 (a)]是采用特殊材料制成的卡子,在200℃时会自动弯曲大约2mm,能够整体夹住POP,一次性将POP整体从PCB上取下来如图21-44 (b)所示。
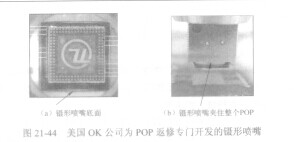
②清理PCB焊盘。
③浸蘸膏状助焊剂或焊膏。浸蘸要求与贴装POP的方法相同。
④放置器件。用返修台的真空吸嘴拾取器件,将底部器件贴放在PCB相应的位置,然后逐层蘸取、放置上层器件,如图21-45所示。贴装时注意压力(Z轴高度)的控制。
图21-45逐层蘸取、放置器件

⑤再流焊。再流焊时需要细致地优化温度曲线。由于返修台再流焊是敞开在空气中进行的,散热快,因此更要注意底部预热和提高加热效率。POP再流焊接要注意充分预热,必须保证PCB和芯片平整、不变形,尽量缩短液相时间。顶部温度达到265℃会造成芯片封装变形。
POP返修常用的美国OK公司APR5000XL返修站的加热系统见第4章图4-61 (a)。
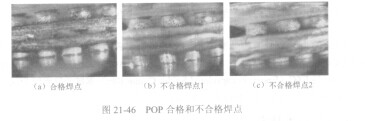
图21-46 (a)是合格焊点,图21-46 (b)是由于芯片变形造成的不合格焊点,图21-46 (c)是由于PCB变形、造成底部芯片焊球压扁而不合格。
POP返修变得相当困难。SDP410Q_PFLG如何将需要返修的元件移除并成功重新贴装,而不影响其他堆叠元件和周围元件及电路板是值得研究的重要课题。
POP的返修步骤与BGA的返修步骤基本相同。
①拆除芯片。拆除芯片的正确方法是一次性将POP整体从PCB上取下来。
OK公司开发的镊形喷嘴[见图21-44 (a)]是采用特殊材料制成的卡子,在200℃时会自动弯曲大约2mm,能够整体夹住POP,一次性将POP整体从PCB上取下来如图21-44 (b)所示。
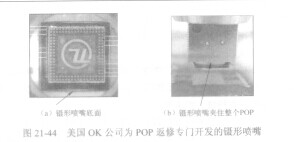
②清理PCB焊盘。
③浸蘸膏状助焊剂或焊膏。浸蘸要求与贴装POP的方法相同。
④放置器件。用返修台的真空吸嘴拾取器件,将底部器件贴放在PCB相应的位置,然后逐层蘸取、放置上层器件,如图21-45所示。贴装时注意压力(Z轴高度)的控制。
图21-45逐层蘸取、放置器件

⑤再流焊。再流焊时需要细致地优化温度曲线。由于返修台再流焊是敞开在空气中进行的,散热快,因此更要注意底部预热和提高加热效率。POP再流焊接要注意充分预热,必须保证PCB和芯片平整、不变形,尽量缩短液相时间。顶部温度达到265℃会造成芯片封装变形。
POP返修常用的美国OK公司APR5000XL返修站的加热系统见第4章图4-61 (a)。
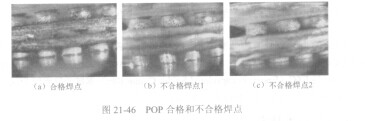
图21-46 (a)是合格焊点,图21-46 (b)是由于芯片变形造成的不合格焊点,图21-46 (c)是由于PCB变形、造成底部芯片焊球压扁而不合格。



 公网安备44030402000607
公网安备44030402000607





