TSV技术
发布时间:2011/8/25 10:31:47 访问次数:25488
1.TSV及其技术优势 A1280XL-PC84C
TSV(through silicon via)技术是穿透硅通孔技术的缩写,一般简称硅通孔技术,是三维集成电路中堆叠芯片实现互连的一种新的技术解决方案。由于TSV能够使芯片在三维方向堆叠的密度最大、芯片之间的互连线最短、外形尺寸最小,并且大大改善芯片速度和低功耗的性能,成为目前电子封装技术中最引人注目的一种技术。如图5.5.8所示是4层芯片采用带载封装方法(tape carrier package,TCP)(见图5.5.8(a))和采用TSV方法(见图5.5.8(b))封装的外形比较。业内人士将TSV称为继引线键合(wire bonding)、载带键合(TAB)和倒装芯片(FC)乏后的第4代封装技术。

TSV技术的优势:
①缩小封装尺寸;
②高频特性出色,减小传输延时、降低噪声;
③降低芯片功耗,据称,TSV可将硅锗芯片的功耗降低大约40%;
④热膨胀可靠性高。
2.TSV的主要技术环节
1)通孔的形成
晶片上的通孔加工是TSV技术的核心,目前通孔加工的技术主要有两种,一种是深反应离子刻蚀,另一种是激光打孔。
激光技术作为一种不需掩模的工艺,避免了光刻胶涂布、光刻曝光、显影和去胶等工艺步骤,已取得重大进展。然而,未来当TSV的尺寸通孔降到lOUm以下时,激光钻孔就面临着新的挑战。
目前这两种技术的细节及其选择仍然在探索中,不过一些先期进入的厂商已经推出相应的加工设备。
此外,形成通孔后还有绝缘层、阻挡层和种子层的淀积以及孔金属化等工艺技术。图5.5.9是6个芯片堆叠采用TSV封装的存储器示意图。
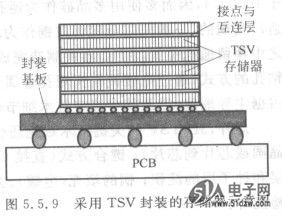
2)晶片减薄
如果不用于3D封装,目前0.3~0.4mm的晶片厚度没有问题,但如果晶片用于3D封装则需要减薄,以保证形成通孔的孔径与厚度比例在合理范围,并且最终封装的厚度可以接受。即使不考虑层堆叠的要求,单是芯片间的通乳互连技术就要求上层芯片的厚度在20~30μm,这是现有等离子开孔及金属沉积技术比较适用的厚度。目前较为先进的多层封装使用的芯片厚度都在lOOlum以下。未来芯片厚
度将达到25μm甚至更小。
晶片减薄目前采用磨削加工,要经过粗磨、精磨和抛光等不同的加工工序。
晶片减薄技术中需要解决磨削过程晶片始终保持平整状态,减薄后不发生翘曲、下垂、表面损伤扩大、晶片破裂等问题。
3) TSV键合
完成通孔金属化和连接端子的晶片之间的互连通常称为TSV键合技术。这种技术采用的工艺有金属一金属键合技术和高分子黏结键合等,而目前以金属一金属键合技术为主要方式,因为这种技术可以同时实现机械和电学的接触界面。例如铜一铜键合在350~4000C温度下施加一定压力并保持一段时间,接着在氮气退火炉中经过一定时间退火而完成TSV键合。现在这种TSV键合已经有相应设备问世。
图5.5.10是已经完成通孔处理并将多层芯片键合的TSV封装剖面图。
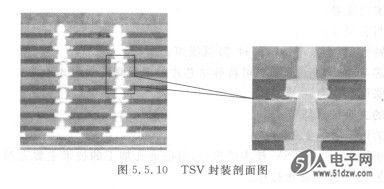
3.TSV的技术关键
3D IC技术继续向细微化方向发展,硅通孔3D IC互连尚待解决的关键技术之一是通孔的刻蚀。TSV穿孔主要有两种工艺取向――先通孔(via first)和后通孔(via last),前者是在IC制造过程中制作通孔,后者在IC制造完成之后制作通孔。先通孑L工艺又分为两种――前道互连型和后道互连型。前者是在所有CMOS工艺开始之前在空白的硅晶圆上,通过深度离子蚀刻( DRIE)实现,由于穿孑L后必须承受后续工艺的热冲击(通常高于1000℃),因而多使用多晶硅作为通孔填充材料;而后道互连型则是在制造流程中在制造厂实现的,一般使用金属钨或铜作为填充材料。显然,先通孔方法必须在设计IC布线之中预留通孔位置,在IC器件制造完成之后,在预留的空白区域进行穿孔,一般采用激光钻孔的方式,通过电镀镀铜实现孔金属化,因而具
有更好的导电性能。这两种方法哪个会占据主导地位,以及其中诸多技术细节仍然需要探索研究。
此外,3D TSV的关键技术难题还包括:通孔的形成;堆叠形式(晶圆到晶圆、芯片到晶圆或芯片到芯片);键合方式(直接Cu-Cu键合、粘接、直接熔合、焊接);绝缘层、阻挡层和种子层的淀积;铜的填克(电镀)、去除;再分布引线(RDL)电镀;晶圆减薄;测量和检测等。
4.展望
据国际半导体技术路线图ITRS的预测,TSV技术将在垂直方向堆叠层数、硅品圆片厚度、硅穿孑L直径、引脚间距等方面继续向微细化方向发展。在垂直方向上堆叠层数上将由3~7层裸芯片(DIE)堆叠演进到多达14层裸芯片的堆叠;而为使堆叠14层芯片的封装仍能符合封装总厚度小于1mm的要求,在硅晶圆片减薄上也将由20~50μm进一步缩小至8μm的厚度;硅穿孔的直径也由4.Oμm缩小至1.6μm;引脚间距由10μm缩小至3.3μm。
此外,TSV技术的发展重点还包括制造工艺开发、3D IC设计测试、多尺寸穿孔技术、静电保护等。
TSV技术的发展趋势预测如图5.5.11所示。 A1302EUA-T
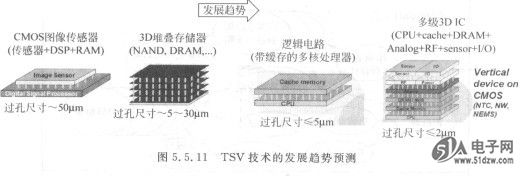
1.TSV及其技术优势 A1280XL-PC84C
TSV(through silicon via)技术是穿透硅通孔技术的缩写,一般简称硅通孔技术,是三维集成电路中堆叠芯片实现互连的一种新的技术解决方案。由于TSV能够使芯片在三维方向堆叠的密度最大、芯片之间的互连线最短、外形尺寸最小,并且大大改善芯片速度和低功耗的性能,成为目前电子封装技术中最引人注目的一种技术。如图5.5.8所示是4层芯片采用带载封装方法(tape carrier package,TCP)(见图5.5.8(a))和采用TSV方法(见图5.5.8(b))封装的外形比较。业内人士将TSV称为继引线键合(wire bonding)、载带键合(TAB)和倒装芯片(FC)乏后的第4代封装技术。

TSV技术的优势:
①缩小封装尺寸;
②高频特性出色,减小传输延时、降低噪声;
③降低芯片功耗,据称,TSV可将硅锗芯片的功耗降低大约40%;
④热膨胀可靠性高。
2.TSV的主要技术环节
1)通孔的形成
晶片上的通孔加工是TSV技术的核心,目前通孔加工的技术主要有两种,一种是深反应离子刻蚀,另一种是激光打孔。
激光技术作为一种不需掩模的工艺,避免了光刻胶涂布、光刻曝光、显影和去胶等工艺步骤,已取得重大进展。然而,未来当TSV的尺寸通孔降到lOUm以下时,激光钻孔就面临着新的挑战。
目前这两种技术的细节及其选择仍然在探索中,不过一些先期进入的厂商已经推出相应的加工设备。
此外,形成通孔后还有绝缘层、阻挡层和种子层的淀积以及孔金属化等工艺技术。图5.5.9是6个芯片堆叠采用TSV封装的存储器示意图。
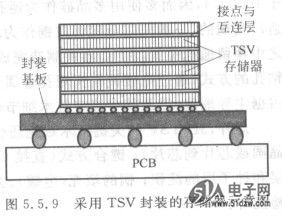
2)晶片减薄
如果不用于3D封装,目前0.3~0.4mm的晶片厚度没有问题,但如果晶片用于3D封装则需要减薄,以保证形成通孔的孔径与厚度比例在合理范围,并且最终封装的厚度可以接受。即使不考虑层堆叠的要求,单是芯片间的通乳互连技术就要求上层芯片的厚度在20~30μm,这是现有等离子开孔及金属沉积技术比较适用的厚度。目前较为先进的多层封装使用的芯片厚度都在lOOlum以下。未来芯片厚
度将达到25μm甚至更小。
晶片减薄目前采用磨削加工,要经过粗磨、精磨和抛光等不同的加工工序。
晶片减薄技术中需要解决磨削过程晶片始终保持平整状态,减薄后不发生翘曲、下垂、表面损伤扩大、晶片破裂等问题。
3) TSV键合
完成通孔金属化和连接端子的晶片之间的互连通常称为TSV键合技术。这种技术采用的工艺有金属一金属键合技术和高分子黏结键合等,而目前以金属一金属键合技术为主要方式,因为这种技术可以同时实现机械和电学的接触界面。例如铜一铜键合在350~4000C温度下施加一定压力并保持一段时间,接着在氮气退火炉中经过一定时间退火而完成TSV键合。现在这种TSV键合已经有相应设备问世。
图5.5.10是已经完成通孔处理并将多层芯片键合的TSV封装剖面图。
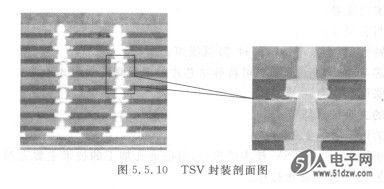
3.TSV的技术关键
3D IC技术继续向细微化方向发展,硅通孔3D IC互连尚待解决的关键技术之一是通孔的刻蚀。TSV穿孔主要有两种工艺取向――先通孔(via first)和后通孔(via last),前者是在IC制造过程中制作通孔,后者在IC制造完成之后制作通孔。先通孑L工艺又分为两种――前道互连型和后道互连型。前者是在所有CMOS工艺开始之前在空白的硅晶圆上,通过深度离子蚀刻( DRIE)实现,由于穿孑L后必须承受后续工艺的热冲击(通常高于1000℃),因而多使用多晶硅作为通孔填充材料;而后道互连型则是在制造流程中在制造厂实现的,一般使用金属钨或铜作为填充材料。显然,先通孔方法必须在设计IC布线之中预留通孔位置,在IC器件制造完成之后,在预留的空白区域进行穿孔,一般采用激光钻孔的方式,通过电镀镀铜实现孔金属化,因而具
有更好的导电性能。这两种方法哪个会占据主导地位,以及其中诸多技术细节仍然需要探索研究。
此外,3D TSV的关键技术难题还包括:通孔的形成;堆叠形式(晶圆到晶圆、芯片到晶圆或芯片到芯片);键合方式(直接Cu-Cu键合、粘接、直接熔合、焊接);绝缘层、阻挡层和种子层的淀积;铜的填克(电镀)、去除;再分布引线(RDL)电镀;晶圆减薄;测量和检测等。
4.展望
据国际半导体技术路线图ITRS的预测,TSV技术将在垂直方向堆叠层数、硅品圆片厚度、硅穿孑L直径、引脚间距等方面继续向微细化方向发展。在垂直方向上堆叠层数上将由3~7层裸芯片(DIE)堆叠演进到多达14层裸芯片的堆叠;而为使堆叠14层芯片的封装仍能符合封装总厚度小于1mm的要求,在硅晶圆片减薄上也将由20~50μm进一步缩小至8μm的厚度;硅穿孔的直径也由4.Oμm缩小至1.6μm;引脚间距由10μm缩小至3.3μm。
此外,TSV技术的发展重点还包括制造工艺开发、3D IC设计测试、多尺寸穿孔技术、静电保护等。
TSV技术的发展趋势预测如图5.5.11所示。 A1302EUA-T
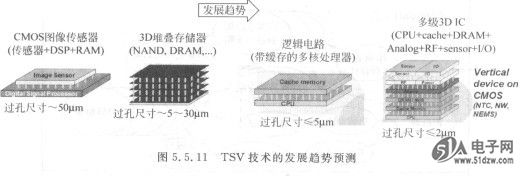
 热门点击
热门点击
- TSV技术
- LM393/LM2903低功率低偏移电压双路
- 怎样用万用表对电阻器进行简单测试?
- 出租车里程计价表
- 常用敏感元件
- 自制简易金属传感器电路
- 电子封装
- 电阻器的标志代号、型号和名称的定义
- 可靠性分析工具与CAD/CAE
- 集成电路设计原则
 推荐技术资料
推荐技术资料
- 中国传媒大学传媒博物馆开
- 传媒博物馆开馆仪式隆童举行。教育都i国家广电总局等部门... [详细]


 公网安备44030402000607
公网安备44030402000607





