三维集成电路
发布时间:2011/8/25 10:06:33 访问次数:3546
1. 3D IC与摩尔定律
三维集成电路(3D IC)又称立体集成电路,本质上说仍然属于传统的以硅材料为主的半导体集成电路,并不是一种新型的集成电路品种,只是一种新的封装形式。
传统的集成电路封装是在一个封装内放置一个晶片(裸芯片)或平面放置多个晶片(MCM),这种封装形式称为2D,即晶片在XY二维平面分布。而3D IC则是将多个晶片堆叠放置,如图5.5.1所示,从而捉高了封装效率(封装效率≥100%),对于集成电路产品而言则是提高了集成度和性能。
随着半导体工艺特征尺寸的不断缩小,特别是进入纳米尺寸范围(小于0.1μm即100nm)后,半导体制造技术难度越来越大。传统的技术越来越接近物理尺寸极限,而新的技术一时还难以接替,因而摩尔定律难以为继的预言已经多次提出,只是由于科技界不懈的努力使传统半导体技术得以延续,90nm.65nm、45nm.32nm、22nm、…实际上,不可否认的是如果近年来半导体技术不能有重大突破,摩尔定律难免寿终正寝。
正是3D IC,这个在半导体领域被视为技术含量不高的封装技术上的新进展,使传统半导体技术出现新的契机,利用封装技术提高集成度,继续电子信息产品微小型化、多功能化和智能化的进程,从而使濒临失效的摩尔定律暂时得以延续,因而受到业界高度重视,成为电子制造领域的热门技术,并且对电子产品发展产生重大影响。
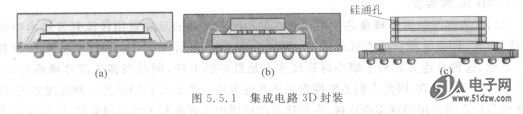
2. 3D lC的特点
1)缩小封装尺寸
与同样数量晶片的2D封装比,3D IC最直观的优点就是可以大幅缩小封装的平面尺寸,提高芯片的晶体管密度。3D封装增加了最终封装的高度,但在电路板的各种元器件中,IC的高度不是问题,一般电解电容、连接器都比较高(大于3~5mm),目前一个晶片厚度约0. 2mm,在3D封装中经过减厚可达0.Imm或更薄。
2)提高互连效率
在传统的集成电路技术中,作为互连层的金属位于2D有源电路上方,互连的基本挑战是互连造成的传输延迟,特别随着高速电路的应用,延迟问题就更为突出。为了避免这种延迟,同时也为了满足性能、频宽和功耗的要求,采用垂直方向上将芯片盏层的新技术,可以缩短互连线(见图5.5.2),实现高效互连,从而提升芯片运行速度。

3)降低芯片的功耗
3D架构使互连线缩短不仅有利于信号传输,而且可以降低芯片的功耗。随着数字电路开关速度的提高,在互连线上消耗的功率相当惊人。据统计,在一种高工作频率的数字集成电路中,90%以上的功率实际上是由10%的长互连线消耗的。减小互连线长度,不仅会提高电路速度,还会有效地降低电路的功耗。
4)较低的成本
与单芯片系统SoC相比,3D IC系统封装电路的开发难度低、周期短,因而可以降低研发成本。
另一方面,对于复杂系统来说,在设计阶段导人3D IC的概念,可以将一个完整、复杂的芯片,拆分成若干子功效芯片、在不同层实现,既增强了芯片功能,又避免了相关的成本、设计复杂度增加等问题。
当然,3D IC也不全是优点。其主要缺点是:如果堆叠中的一层集成电路出现问题,所有堆叠的裸片都将失效;此外,封装技术难度的提高也会增加一部分成本。
3. 3D IC的实现
3D IC的实现关键是堆叠芯片的互连。早期的芯片间的互连采用传统封装技术中的“打线”方式,即金丝球焊的方式来完成,如图5.5.1(a)所示,由于技术成熟,实现比较容易。显然,这种互连方式对于缩小封装尺寸不是最好的方法,同时当多个芯片堆叠时,对
金丝球焊的要求提高,因此人们不断探索其他互连方法。图5.5.1(b)是另一种连接方式,即在堆叠芯片之间使用焊球实现连接,它相比金丝球焊的方式有利于缩小封装尺寸,但这种方式对于3层以上堆叠,例如要实现第一层与第三层的连接就比较困难。目前最受推崇的连接技术是所谓硅通孔(TSV)技术,如图5.5.1(c)所示,有关TSV将在下面单独介绍。
4. 3D IC的应用
目前3D IC已经逐步进入实用阶段,首先在部分高端电子产品中,例如基于TSV的微机电系统( MEMS)和影像传感器(CMOS)等产品中得到应用。未来可扩展至DSP.NAND Flash、DRAM、RF和通信IC等产品领域,进而延伸至绘图芯片、多核处理器、电源供应器和功率放大器、FPGA等芯片产品领域。同时各种逻辑组件、传感器、模拟组件、射频、徽处理器等堆叠构成的多功能系统芯片也将成为3D IC的主要发展方向。据有关机构预测,未来3D芯片的年均复合增长率将超过60%,在半导体市场的比重将持续上升。 QMV50ADA
1. 3D IC与摩尔定律
三维集成电路(3D IC)又称立体集成电路,本质上说仍然属于传统的以硅材料为主的半导体集成电路,并不是一种新型的集成电路品种,只是一种新的封装形式。
传统的集成电路封装是在一个封装内放置一个晶片(裸芯片)或平面放置多个晶片(MCM),这种封装形式称为2D,即晶片在XY二维平面分布。而3D IC则是将多个晶片堆叠放置,如图5.5.1所示,从而捉高了封装效率(封装效率≥100%),对于集成电路产品而言则是提高了集成度和性能。
随着半导体工艺特征尺寸的不断缩小,特别是进入纳米尺寸范围(小于0.1μm即100nm)后,半导体制造技术难度越来越大。传统的技术越来越接近物理尺寸极限,而新的技术一时还难以接替,因而摩尔定律难以为继的预言已经多次提出,只是由于科技界不懈的努力使传统半导体技术得以延续,90nm.65nm、45nm.32nm、22nm、…实际上,不可否认的是如果近年来半导体技术不能有重大突破,摩尔定律难免寿终正寝。
正是3D IC,这个在半导体领域被视为技术含量不高的封装技术上的新进展,使传统半导体技术出现新的契机,利用封装技术提高集成度,继续电子信息产品微小型化、多功能化和智能化的进程,从而使濒临失效的摩尔定律暂时得以延续,因而受到业界高度重视,成为电子制造领域的热门技术,并且对电子产品发展产生重大影响。
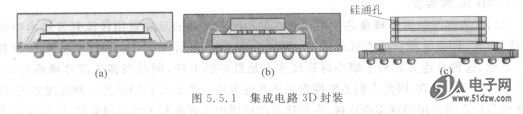
2. 3D lC的特点
1)缩小封装尺寸
与同样数量晶片的2D封装比,3D IC最直观的优点就是可以大幅缩小封装的平面尺寸,提高芯片的晶体管密度。3D封装增加了最终封装的高度,但在电路板的各种元器件中,IC的高度不是问题,一般电解电容、连接器都比较高(大于3~5mm),目前一个晶片厚度约0. 2mm,在3D封装中经过减厚可达0.Imm或更薄。
2)提高互连效率
在传统的集成电路技术中,作为互连层的金属位于2D有源电路上方,互连的基本挑战是互连造成的传输延迟,特别随着高速电路的应用,延迟问题就更为突出。为了避免这种延迟,同时也为了满足性能、频宽和功耗的要求,采用垂直方向上将芯片盏层的新技术,可以缩短互连线(见图5.5.2),实现高效互连,从而提升芯片运行速度。

3)降低芯片的功耗
3D架构使互连线缩短不仅有利于信号传输,而且可以降低芯片的功耗。随着数字电路开关速度的提高,在互连线上消耗的功率相当惊人。据统计,在一种高工作频率的数字集成电路中,90%以上的功率实际上是由10%的长互连线消耗的。减小互连线长度,不仅会提高电路速度,还会有效地降低电路的功耗。
4)较低的成本
与单芯片系统SoC相比,3D IC系统封装电路的开发难度低、周期短,因而可以降低研发成本。
另一方面,对于复杂系统来说,在设计阶段导人3D IC的概念,可以将一个完整、复杂的芯片,拆分成若干子功效芯片、在不同层实现,既增强了芯片功能,又避免了相关的成本、设计复杂度增加等问题。
当然,3D IC也不全是优点。其主要缺点是:如果堆叠中的一层集成电路出现问题,所有堆叠的裸片都将失效;此外,封装技术难度的提高也会增加一部分成本。
3. 3D IC的实现
3D IC的实现关键是堆叠芯片的互连。早期的芯片间的互连采用传统封装技术中的“打线”方式,即金丝球焊的方式来完成,如图5.5.1(a)所示,由于技术成熟,实现比较容易。显然,这种互连方式对于缩小封装尺寸不是最好的方法,同时当多个芯片堆叠时,对
金丝球焊的要求提高,因此人们不断探索其他互连方法。图5.5.1(b)是另一种连接方式,即在堆叠芯片之间使用焊球实现连接,它相比金丝球焊的方式有利于缩小封装尺寸,但这种方式对于3层以上堆叠,例如要实现第一层与第三层的连接就比较困难。目前最受推崇的连接技术是所谓硅通孔(TSV)技术,如图5.5.1(c)所示,有关TSV将在下面单独介绍。
4. 3D IC的应用
目前3D IC已经逐步进入实用阶段,首先在部分高端电子产品中,例如基于TSV的微机电系统( MEMS)和影像传感器(CMOS)等产品中得到应用。未来可扩展至DSP.NAND Flash、DRAM、RF和通信IC等产品领域,进而延伸至绘图芯片、多核处理器、电源供应器和功率放大器、FPGA等芯片产品领域。同时各种逻辑组件、传感器、模拟组件、射频、徽处理器等堆叠构成的多功能系统芯片也将成为3D IC的主要发展方向。据有关机构预测,未来3D芯片的年均复合增长率将超过60%,在半导体市场的比重将持续上升。 QMV50ADA
上一篇:封装/组装交融――微组装简介
上一篇:SiP技术
 热门点击
热门点击


 公网安备44030402000607
公网安备44030402000607





