离子植人后清除
发布时间:2017/11/6 21:26:14 访问次数:653
离子植人后清除。在IC器件的制作中,有关井(WELL)、低掺杂(I'DD)、重掺杂(P/N十)的离子植人是器件成活的关键。在不同的步骤,浓度有高低之分,深浅有能量之分,S912XEG128J2MAA而光阻在高浓度或高能量轰击下,有机分子结构发生变化,大分子之间形成铰链,在离子植入后,晶片表面被一层有机物硬壳覆盖。这层有机物去除依然是有氧电浆、无氧电浆灰化和湿法组合(SPM―)RCA),湿法组合也会选用极稀的氢氟酸和臭氧水(V()HP9¤()3)(未来可能成为主流)。这里需要强调的是氧电浆的使用,每次会损失少量硅,但步骤增多后,这个量渐渐增多,如图9.8所示。
(a,离子植人形成的铰链或尢定形碳硬壳 (b)灰化诱导氧化和晶格损伤 (c)混法清洗产生硅凹陷和植人剂损失光阻的灰化和湿法清洗
图9.8 光阻灰化和湿法清洗
在低端制程以前,较少考虑硅的损失,但65nm以后的CM(B制程,源极和漏极硅的损耗对器件的特性影响很大,所以氧电浆灰化未来可能会被其他方法取代,如全湿法去除,如图9.9所示。
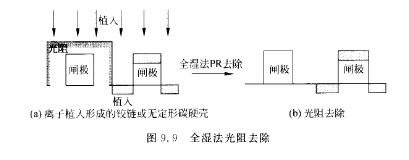
离子植人后清除。在IC器件的制作中,有关井(WELL)、低掺杂(I'DD)、重掺杂(P/N十)的离子植人是器件成活的关键。在不同的步骤,浓度有高低之分,深浅有能量之分,S912XEG128J2MAA而光阻在高浓度或高能量轰击下,有机分子结构发生变化,大分子之间形成铰链,在离子植入后,晶片表面被一层有机物硬壳覆盖。这层有机物去除依然是有氧电浆、无氧电浆灰化和湿法组合(SPM―)RCA),湿法组合也会选用极稀的氢氟酸和臭氧水(V()HP9¤()3)(未来可能成为主流)。这里需要强调的是氧电浆的使用,每次会损失少量硅,但步骤增多后,这个量渐渐增多,如图9.8所示。
(a,离子植人形成的铰链或尢定形碳硬壳 (b)灰化诱导氧化和晶格损伤 (c)混法清洗产生硅凹陷和植人剂损失光阻的灰化和湿法清洗
图9.8 光阻灰化和湿法清洗
在低端制程以前,较少考虑硅的损失,但65nm以后的CM(B制程,源极和漏极硅的损耗对器件的特性影响很大,所以氧电浆灰化未来可能会被其他方法取代,如全湿法去除,如图9.9所示。
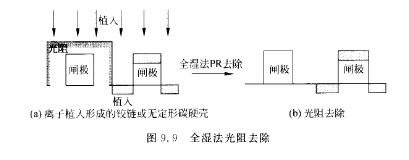
上一篇:红外灯辐射SPM光阻去除



 公网安备44030402000607
公网安备44030402000607





