改进气泡的问题需要从源头上阻止气泡的产生
发布时间:2017/10/29 13:24:16 访问次数:618
改进气泡的问题需要从源头上阻止气泡的产生,如阻止空气在浸没使用的超纯净水中的过量溶解。 V52C4258K70还有,如果在快速扫描时(通常最快速度可以达到600~700mm/s)产生了气泡,需要通过真空系统将其抽除。通常这样的真空抽吸装置存在于水罩上和硅片平台(wafer table)边缘。
衬底上的引人的缺陷一般会造成硅片表面突起,引起涂胶(包括光刻胶和抗反射层)不良。此种缺陷一般为颗粒。这种颗粒可以是从前层工艺带来的。例如,干法刻蚀(等离子体刻蚀)中,从腔体内表面掉下的颗粒或者片状物(flakes),也可以是物理气相沉积(PhysicalVapor Deposition,PVD)工艺带来的颗粒等。
缺陷的检测一般通过紫外光对硅片表面做成像,并且通过一定方式的比较来得到。缺陷在硅片上的分布分为周期性和非周期性分布。周期性分布一般指在每一个曝光区域(shot)或者芯片区域(die)的固定地方都出现。而非周期性的分布一般并不固定出现在硅片的某一区域,他可以以硅片圆心为对称点,呈中央一四周分布,也可以偏向硅片某一边缘,如缺口(n。tch)附近。对于非周期性的缺陷,如果每一个曝光区域中有不止一个相同的芯片区域,那么,可以通过比较两个芯片区域的不同点来得出缺陷的位置。这种方法叫做“芯片和芯片”比较(dieto die∞mparison)。如果每一个曝光区域只有一个芯片,那么缺陷的检查要么通过图形大小、形状的甄别,要么通过同设计图样的比较,所谓的“芯片和数据库”比较(die to database∞mparison)。对于现代光刻工艺来讲(<0.25um),由于受到衍射的影响,这种比较方法必
须考虑到设计图形经过衍射成像后的变化。如图7.51(a)、图7.51(b)所示,图中的线端明显变圆。
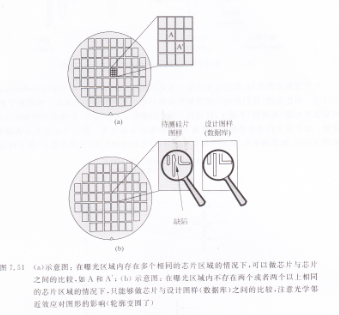
改进气泡的问题需要从源头上阻止气泡的产生,如阻止空气在浸没使用的超纯净水中的过量溶解。 V52C4258K70还有,如果在快速扫描时(通常最快速度可以达到600~700mm/s)产生了气泡,需要通过真空系统将其抽除。通常这样的真空抽吸装置存在于水罩上和硅片平台(wafer table)边缘。
衬底上的引人的缺陷一般会造成硅片表面突起,引起涂胶(包括光刻胶和抗反射层)不良。此种缺陷一般为颗粒。这种颗粒可以是从前层工艺带来的。例如,干法刻蚀(等离子体刻蚀)中,从腔体内表面掉下的颗粒或者片状物(flakes),也可以是物理气相沉积(PhysicalVapor Deposition,PVD)工艺带来的颗粒等。
缺陷的检测一般通过紫外光对硅片表面做成像,并且通过一定方式的比较来得到。缺陷在硅片上的分布分为周期性和非周期性分布。周期性分布一般指在每一个曝光区域(shot)或者芯片区域(die)的固定地方都出现。而非周期性的分布一般并不固定出现在硅片的某一区域,他可以以硅片圆心为对称点,呈中央一四周分布,也可以偏向硅片某一边缘,如缺口(n。tch)附近。对于非周期性的缺陷,如果每一个曝光区域中有不止一个相同的芯片区域,那么,可以通过比较两个芯片区域的不同点来得出缺陷的位置。这种方法叫做“芯片和芯片”比较(dieto die∞mparison)。如果每一个曝光区域只有一个芯片,那么缺陷的检查要么通过图形大小、形状的甄别,要么通过同设计图样的比较,所谓的“芯片和数据库”比较(die to database∞mparison)。对于现代光刻工艺来讲(<0.25um),由于受到衍射的影响,这种比较方法必
须考虑到设计图形经过衍射成像后的变化。如图7.51(a)、图7.51(b)所示,图中的线端明显变圆。
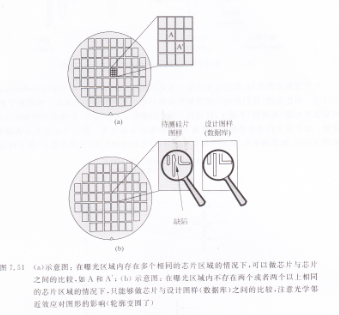
上一篇:水罩相对硅片禁止时的接触角
上一篇:光刻成像模型,调制传递函数
 热门点击
热门点击
- 光刻工艺流程
- 相移掩膜版
- 前处理工艺
- 金属栅极有效功函数的调制
- 闲置输入端处理方法
- 生成合金层的基本条件
- 氮的加人可以很大程度上提高金属栅的热稳定性和
- 模拟电路的工作频率比较低、灵敏度较高
- 永磁体和铁磁体产生的磁场
- 系统图和框图的绘制
 推荐技术资料
推荐技术资料
- 自制智能型ICL7135
- 表头使ff11CL7135作为ADC,ICL7135是... [详细]


 公网安备44030402000607
公网安备44030402000607





