�������е�4�����Բ����������
����ʱ��:2017/10/28 10:16:24 ���ʴ���:1730
ƽ̨,��X��Y����IJ�����ͨ��X��Y�����ϵĸ���������Ƶ�,�����ij���Ҳ��������;����,����ɨ��,����Y�����ϵ��˶���һ����ֱ�ں�����X������,��������������������:�ǶԳƷŴ���(assymet��c magni��cation)������(orthogonality)����Ϊɨ��ʽ���̻���Y�����ϵķŴ���������Ĥ���Ƭ�����ɨ���ٶȾ����ġ�����״̬��,��Ĥ����ɨ���ٶ��ǹ�Ƭ��4���������Ĥ���ɨ���ٶȿ�һ��,���ڹ�Ƭƽ̨δ���ɨ��ʱ��Ĥ���ɨ���Ѿ�������,��ô,ͼ�ε�Y����ķŴ��ʻ��С������,�����ɨ��ʱ��Ƭƽ̨���ں���(X)������Ư��,��ôɨ�������ͼ�ν���������,y��ͬX������ǽ�����90��,Ҳ����˵,�����Բ��ٴ��ڡ���ô�Ŵ��ʽ�����ΪX,y:Mx,M����ת��Ҳ�ɱ���ΪX,Y:Rx dY������ʽ(729)�����Ա�д��: ����ʽ(730)����6������,�汻����6����ģ�͡�
ǰ���������̵�6�����Բ�������ʵ,�����������н��̷�Ϊ����(gh-)���ع���(shot)��������(grid o��day)���ɹ�̻���ƽ̨�ľ�ȷ�ƶ���������;���ع�������������Ĥ�汾���Ŀ��ƾ����Լ���ͷ�Ŵ��ʺ��������������ġ������̵�4�����������ڹ�Ƭ���ϵı�����ͼ7.42��ʾ��
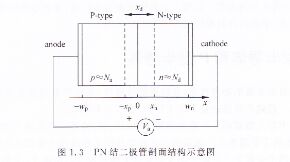
ƽ̨,��X��Y����IJ�����ͨ��X��Y�����ϵĸ���������Ƶ�,�����ij���Ҳ��������;����,����ɨ��,����Y�����ϵ��˶���һ����ֱ�ں�����X������,��������������������:�ǶԳƷŴ���(assymet��c magni��cation)������(orthogonality)����Ϊɨ��ʽ���̻���Y�����ϵķŴ���������Ĥ���Ƭ�����ɨ���ٶȾ����ġ�����״̬��,��Ĥ����ɨ���ٶ��ǹ�Ƭ��4���������Ĥ���ɨ���ٶȿ�һ��,���ڹ�Ƭƽ̨δ���ɨ��ʱ��Ĥ���ɨ���Ѿ�������,��ô,ͼ�ε�Y����ķŴ��ʻ��С������,�����ɨ��ʱ��Ƭƽ̨���ں���(X)������Ư��,��ôɨ�������ͼ�ν���������,y��ͬX������ǽ�����90��,Ҳ����˵,�����Բ��ٴ��ڡ���ô�Ŵ��ʽ�����ΪX,y:Mx,M����ת��Ҳ�ɱ���ΪX,Y:Rx dY������ʽ(729)�����Ա�д��: ����ʽ(730)����6������,�汻����6����ģ�͡�
ǰ���������̵�6�����Բ�������ʵ,�����������н��̷�Ϊ����(gh-)���ع���(shot)��������(grid o��day)���ɹ�̻���ƽ̨�ľ�ȷ�ƶ���������;���ع�������������Ĥ�汾���Ŀ��ƾ����Լ���ͷ�Ŵ��ʺ��������������ġ������̵�4�����������ڹ�Ƭ���ϵı�����ͼ7.42��ʾ��
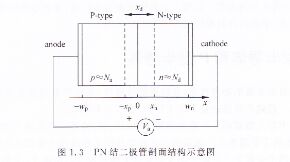
��һƪ�������̾���
 �������
�������
- ���������ĨD�ַ�ʽ
- ͼֽ�ķ���������߶ȶ�Ӧ��ϵ
- �������е�4�����Բ����������
- ĩ��ЧӦ(terminaI effeCt)
- ˫��Ӧ������NMOS��PMOs
- ��ѵ�����������ż������
- MM440��Ƶ���ĵ�·
- ����������
- ��̬��������
- ͨ��-1�ͽ���-z���γ�(˫��Ƕ)
 �Ƽ���������
�Ƽ���������
- ̩���·�����DSA830
- ̩���·�����DSA8300��һ̨������ͬʱʵ��ʱ���Ƶ�������DS... [��ϸ]


 ��������44030402000607
��������44030402000607





