末端效应(terminaI effeCt)
发布时间:2017/10/24 20:09:46 访问次数:1322
在化学电镀的过程中,硅片土某一点的电流越大,电镀的速度会越快。由于电XC17512LPD8I流是从硅片的边缘加到硅片上的,相对于硅片的边缘,硅片的中心需要加上铜种子层的阻值R2,见图6.38(a)。这样,中心的电流r2将小于边缘的电流I1,使得硅片边缘铜的厚度大于中间,这就是所谓的末端效应。当铜种子层的厚度变薄时,R2会变大,将加大末端效应,如图6,38(b)所示。末端效应宏观上增加了化学机械研磨的难度,微观上使硅片的边缘和中心的电镀速率产生差异,从而产生填洞能力的差异L32。
从图6,38(a)的电镀电路图可以看出,要想减小硅片边缘和中心电镀速率的差异,可以有两个方向:减小R2和增加R1。随着线宽的缩小,铜种子层的厚度会越来越薄,这样R2只 会越来越大,囚此,只有增加R1。降低酸的浓度可以有效地降低Rl,目前先进的化学电镀都采用低酸电镀液。另外,当发展到45nm以下的技术时,仅仅用低酸已不再满足制程的需要,需要在电镀液中加人额外的高电阻的装置以增加R1或者在电镀头的旁边增加一个阴极以改变硅片边缘的电流分布,从而达到降低硅片边缘和中心电镀速率差异的问题。
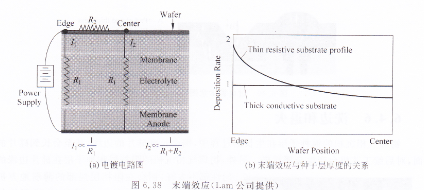
在化学电镀的过程中,硅片土某一点的电流越大,电镀的速度会越快。由于电XC17512LPD8I流是从硅片的边缘加到硅片上的,相对于硅片的边缘,硅片的中心需要加上铜种子层的阻值R2,见图6.38(a)。这样,中心的电流r2将小于边缘的电流I1,使得硅片边缘铜的厚度大于中间,这就是所谓的末端效应。当铜种子层的厚度变薄时,R2会变大,将加大末端效应,如图6,38(b)所示。末端效应宏观上增加了化学机械研磨的难度,微观上使硅片的边缘和中心的电镀速率产生差异,从而产生填洞能力的差异L32。
从图6,38(a)的电镀电路图可以看出,要想减小硅片边缘和中心电镀速率的差异,可以有两个方向:减小R2和增加R1。随着线宽的缩小,铜种子层的厚度会越来越薄,这样R2只 会越来越大,囚此,只有增加R1。降低酸的浓度可以有效地降低Rl,目前先进的化学电镀都采用低酸电镀液。另外,当发展到45nm以下的技术时,仅仅用低酸已不再满足制程的需要,需要在电镀液中加人额外的高电阻的装置以增加R1或者在电镀头的旁边增加一个阴极以改变硅片边缘的电流分布,从而达到降低硅片边缘和中心电镀速率差异的问题。
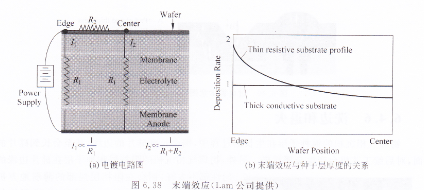
上一篇:入水方式(entry)
上一篇:过电镀(orr p1athg)
 热门点击
热门点击
- 图纸的幅面与字体高度对应关系
- 网格套刻中的4个线性参量及其表现
- 末端效应(terminaI effeCt)
- 双极应力对于NMOS和PMOs
- 设置背景空气域
- 静态工作电流
- 通孔-1和金属-z的形成(双镶嵌)
- 一个PCB的构成是在垂直叠层上使用了一系列的
- 材料特性函数
- 覆铜板的标准、特点和用途
 推荐技术资料
推荐技术资料
- 泰克新发布的DSA830
- 泰克新发布的DSA8300在一台仪器中同时实现时域和频域分析,DS... [详细]


 公网安备44030402000607
公网安备44030402000607





