镍铂合金沉积
发布时间:2017/10/23 20:34:30 访问次数:678
当集成电路技术发展到65nm以下时,必须使用Ni si1icide。但如果使用纯镍的薄膜作为形成silicide的金属,由于镍原子的扩散能力很强,则会在源漏极上出现如图6.12所示的 侵蚀(encroachment)缺陷。Encroachment缺陷会增加漏电,降低良率。 OPA129U冈此,在实际的集成电路制造工艺中,常常采用含铂5~10atom%的镍铂合金作为形成silicide的金属。
随着技术的发展,除了需要N卜Pt合金之外,传统的PVD镀膜的机台已经不再满足制程的需要。尤其是当发展到65nm时,线宽进一步缩小,镀膜之前的深宽比(aspect ratio)进一步增加,这就要求镀N←Pt薄膜的机台具有比较好的台阶覆盖率(stepcoverage),另外,物理气相沉积长膜方式会受到硅片上几何结构的影响而存在不对称性(asymmctry),对 于槽(trench)和通孔(via)而言,离硅片中心较远的一边比较容易沉积,厚度较厚,而离硅片中心较近的一边由于受到侧壁的遮挡效应(shadow effect),厚度较薄,如图6,13所示。在对N←Pt薄膜进行热处理形成硅化物的过程中,较厚的一边所形成的硅化物的厚度较厚,严重的情况下甚至会钻到栅极(gate)下面,形成如图6,14所示的encr。achment defect,增加漏电,严重降低器件的良率。因此,必须使用型号为ALPS(Advanced Low PressurcSputtering)的Ni Pt沉积腔。
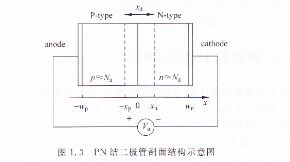
当集成电路技术发展到65nm以下时,必须使用Ni si1icide。但如果使用纯镍的薄膜作为形成silicide的金属,由于镍原子的扩散能力很强,则会在源漏极上出现如图6.12所示的 侵蚀(encroachment)缺陷。Encroachment缺陷会增加漏电,降低良率。 OPA129U冈此,在实际的集成电路制造工艺中,常常采用含铂5~10atom%的镍铂合金作为形成silicide的金属。
随着技术的发展,除了需要N卜Pt合金之外,传统的PVD镀膜的机台已经不再满足制程的需要。尤其是当发展到65nm时,线宽进一步缩小,镀膜之前的深宽比(aspect ratio)进一步增加,这就要求镀N←Pt薄膜的机台具有比较好的台阶覆盖率(stepcoverage),另外,物理气相沉积长膜方式会受到硅片上几何结构的影响而存在不对称性(asymmctry),对 于槽(trench)和通孔(via)而言,离硅片中心较远的一边比较容易沉积,厚度较厚,而离硅片中心较近的一边由于受到侧壁的遮挡效应(shadow effect),厚度较薄,如图6,13所示。在对N←Pt薄膜进行热处理形成硅化物的过程中,较厚的一边所形成的硅化物的厚度较厚,严重的情况下甚至会钻到栅极(gate)下面,形成如图6,14所示的encr。achment defect,增加漏电,严重降低器件的良率。因此,必须使用型号为ALPS(Advanced Low PressurcSputtering)的Ni Pt沉积腔。
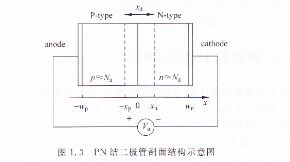
 热门点击
热门点击
- n-阱和p-阱的形成
- 自对准硅化物工艺
- 工序与工步
- sACVD薄膜生长的选择性
- 光刻胶形貌
- 源漏极及轻掺杂源漏极的掺杂浓度相对越来越高
- PN结自建电压
- 存储器技术和制造工艺
- 与传统的PVD相比较,ALPs主要有三个方面
- 接触窗薄膜工艺
 推荐技术资料
推荐技术资料
- 循线机器人是机器人入门和
- 循线机器人是机器人入门和比赛最常用的控制方式,E48S... [详细]


 公网安备44030402000607
公网安备44030402000607





