sCoNl反应腔的结构
发布时间:2017/10/23 20:29:56 访问次数:1185
pedestal等主要部件。remote plasma产生器的主要作用是将NF3和NH3的混合气体在plasma作用下生成活性粒子。l・ot showerhead的温度为180℃左右,硅片上OPA128SM的⒏o2生成易升华的化合物(NH4)2⒏F6后,会被升举而靠近hot showerhead,将(NH犭)2SiF6升华。由于 (NH砭)2SiF6只有在低温条件下才会生成,因此,∞1d pedestal的温度较低,接近室温,为(NH1)2SiF6的生成提供条件。图6.10为SiCoNi工艺过程,硅片进人反应腔后,NF3和NH3的混合气体在rem。te plasma发生器中产生活性粒子,活性粒子进人反应腔后与硅片表面的⒏O2反应生成易升华的化合物(NH4)2SiF6,然后将硅片升举到hot showOrhead附近,利用辐射加热的方式将硅片表面的(NH4)2⒏F6升华,然后由真空泵将气体抽走。在实际工艺过程中,有时一步升华很难把硅片表面的副产物去除干净,往往采用两步或多步升华以达到彻底除去副产物的目的。
在实际的集成电路制造工艺中,为了确保机台在生产产品时不会出现问题,需机台进行测试(monitor),对于siCoNi反应腔来说,当用长有⒏O2的空白硅片测试在工艺过程中的颗粒(particle)缺陷时,发现将经过sCoNi preclean的硅片放置一段时间之后,在硅片的中心会出现大量的particle,随着时间的增加,这种particle会自动减少,直至消失,这就是所谓的“幽灵(gh°st)”缺陷,见图6.11,这会影响对机台实际状况的评估。为了克服这个缺陷,得到没有gl・ost效应的测试结果,可采用裸露的硅片作为测试硅片。
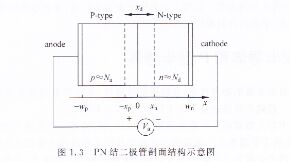
pedestal等主要部件。remote plasma产生器的主要作用是将NF3和NH3的混合气体在plasma作用下生成活性粒子。l・ot showerhead的温度为180℃左右,硅片上OPA128SM的⒏o2生成易升华的化合物(NH4)2⒏F6后,会被升举而靠近hot showerhead,将(NH犭)2SiF6升华。由于 (NH砭)2SiF6只有在低温条件下才会生成,因此,∞1d pedestal的温度较低,接近室温,为(NH1)2SiF6的生成提供条件。图6.10为SiCoNi工艺过程,硅片进人反应腔后,NF3和NH3的混合气体在rem。te plasma发生器中产生活性粒子,活性粒子进人反应腔后与硅片表面的⒏O2反应生成易升华的化合物(NH4)2SiF6,然后将硅片升举到hot showOrhead附近,利用辐射加热的方式将硅片表面的(NH4)2⒏F6升华,然后由真空泵将气体抽走。在实际工艺过程中,有时一步升华很难把硅片表面的副产物去除干净,往往采用两步或多步升华以达到彻底除去副产物的目的。
在实际的集成电路制造工艺中,为了确保机台在生产产品时不会出现问题,需机台进行测试(monitor),对于siCoNi反应腔来说,当用长有⒏O2的空白硅片测试在工艺过程中的颗粒(particle)缺陷时,发现将经过sCoNi preclean的硅片放置一段时间之后,在硅片的中心会出现大量的particle,随着时间的增加,这种particle会自动减少,直至消失,这就是所谓的“幽灵(gh°st)”缺陷,见图6.11,这会影响对机台实际状况的评估。为了克服这个缺陷,得到没有gl・ost效应的测试结果,可采用裸露的硅片作为测试硅片。
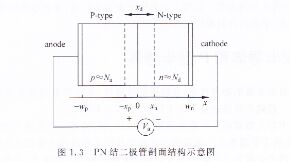
上一篇:镍铂合金沉积
 热门点击
热门点击
- n-阱和p-阱的形成
- 自对准硅化物工艺
- 工序与工步
- sACVD薄膜生长的选择性
- 光刻胶形貌
- 源漏极及轻掺杂源漏极的掺杂浓度相对越来越高
- PN结自建电压
- 存储器技术和制造工艺
- 与传统的PVD相比较,ALPs主要有三个方面
- 接触窗薄膜工艺
 推荐技术资料
推荐技术资料
- 循线机器人是机器人入门和
- 循线机器人是机器人入门和比赛最常用的控制方式,E48S... [详细]


 公网安备44030402000607
公网安备44030402000607





