CMP设备和工艺基础
发布时间:2017/5/30 12:02:21 访问次数:1507
超大规模集成电路的制备经过多次光刻、氧化等工艺,使得硅片表面不平整,台阶高,这样在进PAM2305AAB120行电连接时,台阶处的金属薄膜连线易断裂,且光刻难。需要通过平面化技术来解决这一问题。平面化技术目前主要有:双层光刻胶技术;PSG、BPsG回流;化学机械抛光(CMP)。
导电层间的绝缘介质的平坦化目前主要采用化学机械抛光(CMP)技术。这是一种通过使用软膏状的化学研磨剂在机械研磨的同时伴有化学反应的抛光平坦化方法,如图127所示为CMP方法示意图。CMP技术的关键是研磨剂组成成分,硅片表面平坦化物质不同采用的研磨剂成分就不同。研磨剂主要由氧化剂和摩擦剂组成,磨料中包含摩擦剂颗粒的硬度与所磨蚀材料基本相同;磨料化学成分及其酸碱度,摩擦剂颗粒尺寸、形状、浓度等亦都是重要参数。CMP主要应用于多层互连工艺。
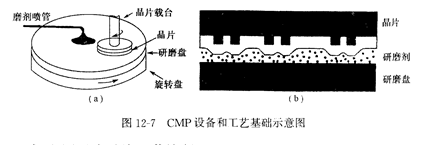
超大规模集成电路的制备经过多次光刻、氧化等工艺,使得硅片表面不平整,台阶高,这样在进PAM2305AAB120行电连接时,台阶处的金属薄膜连线易断裂,且光刻难。需要通过平面化技术来解决这一问题。平面化技术目前主要有:双层光刻胶技术;PSG、BPsG回流;化学机械抛光(CMP)。
导电层间的绝缘介质的平坦化目前主要采用化学机械抛光(CMP)技术。这是一种通过使用软膏状的化学研磨剂在机械研磨的同时伴有化学反应的抛光平坦化方法,如图127所示为CMP方法示意图。CMP技术的关键是研磨剂组成成分,硅片表面平坦化物质不同采用的研磨剂成分就不同。研磨剂主要由氧化剂和摩擦剂组成,磨料中包含摩擦剂颗粒的硬度与所磨蚀材料基本相同;磨料化学成分及其酸碱度,摩擦剂颗粒尺寸、形状、浓度等亦都是重要参数。CMP主要应用于多层互连工艺。
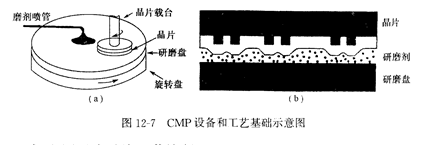
上一篇:绝缘介质材料的选取
上一篇:铜多层互连系统工艺流程



 公网安备44030402000607
公网安备44030402000607





