多晶硅的干法刻蚀
发布时间:2017/5/28 14:55:50 访问次数:1902
在MOSFET器件的制备中,需要严格地控制栅极的宽度,因为它决定了MOSFET器件的沟道长度,进而与器件的特性息息相关。刻蚀多晶硅时,OPA2188AID必须准确地将掩膜上的尺寸转移到多晶硅上。除此之外,刻蚀后的轮廓也很重要,如多晶硅刻蚀后栅极侧壁有倾斜时,将会屏蔽后续工艺中源极和漏极的离子注人,造成杂质分布不均,沟道的长度会随栅极倾斜的程度而改变。另外,⒊对s02的刻蚀选择比也要足够高,这是囚为:①为了去除阶梯残留,必须有足够的过度刻蚀才能避免多晶硅电极间短路的发生;②多晶硅一般覆盖在很薄(刂、于9O nm)的栅极氧化层上,如果氧化层被完全刻蚀,则氧化层下的源极和漏极区域的⒏将被快速地刻蚀。若⒊/Si()2刻蚀选择比太小将对器件造成严重的影响,所以利用CF4、SF6等F原子为主的等离子体刻蚀多晶硅就不太合适了。此外,这类气体也有负载效应(Loa山llg Effect),即被刻蚀材料裸露在等离子体中面积较大的区域时刻蚀速率比在面积较小的区域时慢,也就是出现局部刻蚀速率的不均匀。改用C炻的刻蚀速率则比F原子慢很多,C炻和多晶硅的反应方程式为 此保护膜可以保护多晶硅的侧壁,造成各向异性刻蚀。为兼顾刻蚀速率和选择比,有人使用SF6气体中添加CC妩和CHC辶,SF6的比例越高刻蚀速率越快;而CC虹或CHds的比例越高,对于sO2的刻蚀选择比越高,刻蚀越趋于各向异性。
除了Cl和F的气体之外,溴化氢(H【Jr)也是现在常用的气体之一,因为在小于0.5um制程中,栅极氧化层的厚度小于10nm,而以Hh刻蚀的多晶硅对sK)2的选择比高于以Cl为主的等离子体。
在MOSFET器件的制备中,需要严格地控制栅极的宽度,因为它决定了MOSFET器件的沟道长度,进而与器件的特性息息相关。刻蚀多晶硅时,OPA2188AID必须准确地将掩膜上的尺寸转移到多晶硅上。除此之外,刻蚀后的轮廓也很重要,如多晶硅刻蚀后栅极侧壁有倾斜时,将会屏蔽后续工艺中源极和漏极的离子注人,造成杂质分布不均,沟道的长度会随栅极倾斜的程度而改变。另外,⒊对s02的刻蚀选择比也要足够高,这是囚为:①为了去除阶梯残留,必须有足够的过度刻蚀才能避免多晶硅电极间短路的发生;②多晶硅一般覆盖在很薄(刂、于9O nm)的栅极氧化层上,如果氧化层被完全刻蚀,则氧化层下的源极和漏极区域的⒏将被快速地刻蚀。若⒊/Si()2刻蚀选择比太小将对器件造成严重的影响,所以利用CF4、SF6等F原子为主的等离子体刻蚀多晶硅就不太合适了。此外,这类气体也有负载效应(Loa山llg Effect),即被刻蚀材料裸露在等离子体中面积较大的区域时刻蚀速率比在面积较小的区域时慢,也就是出现局部刻蚀速率的不均匀。改用C炻的刻蚀速率则比F原子慢很多,C炻和多晶硅的反应方程式为 此保护膜可以保护多晶硅的侧壁,造成各向异性刻蚀。为兼顾刻蚀速率和选择比,有人使用SF6气体中添加CC妩和CHC辶,SF6的比例越高刻蚀速率越快;而CC虹或CHds的比例越高,对于sO2的刻蚀选择比越高,刻蚀越趋于各向异性。
除了Cl和F的气体之外,溴化氢(H【Jr)也是现在常用的气体之一,因为在小于0.5um制程中,栅极氧化层的厚度小于10nm,而以Hh刻蚀的多晶硅对sK)2的选择比高于以Cl为主的等离子体。
 热门点击
热门点击
- 氮化硅薄膜性质与用途
- 直拉法生长单晶硅的主要工艺流程
- 氧化增强扩散
- 边界层厚度主要受气体压力和气流状态(或流速)
- 影响氧化速率的各种因素
- 衬底晶向对氧化速率的影响
- 外延工艺种类
- 二氧化硅的干法刻蚀
- 离子注入机
- PⅤD概述
 推荐技术资料
推荐技术资料
- 自制经典的1875功放
- 平时我也经常逛一些音响DIY论坛,发现有很多人喜欢LM... [详细]

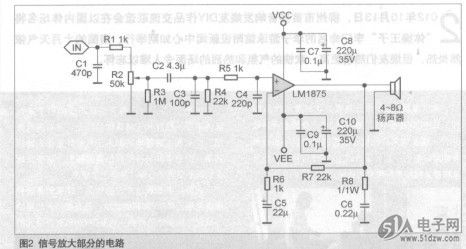
 公网安备44030402000607
公网安备44030402000607





