掺磷硅在湿氧氧化时的氧化层厚度与温度、掺杂浓度的关系
发布时间:2017/5/11 22:48:19 访问次数:3811
图417所示是掺磷硅在湿氧氧化时的氧化层厚度与温度、掺杂浓度的关系。高温下M1TSVB1SHI磷的分凝效应显著,大部分杂质被分凝到硅中,氧化膜中磷杂质不足以引起加强氧化。而在较低温度下,分凝作用减弱,氧化膜中磷含量随掺杂浓度的增加而升高,因此氧化速率增加。 掺杂浓度对氧化速率的影响一般在高浓度下(如大于101l菠°ms/cm3)才明显,低浓度时可不必考虑。如图⒋18为900℃时干氧氧化的速率常数与掺磷浓度的关系,可见B/A在高浓度时基本上随 浓度增加而增加,这时氧化受界面处反应速率控制。
相对来讲与浓度关系不大,它反映了氧化速率受氧化剂通过氧化膜的扩散限制。
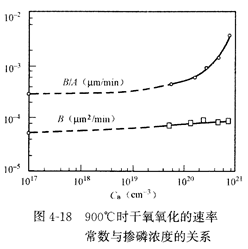
19所示为氧化层在不同掺杂浓度下的生长厚度差异的示意图。这一差异造成芯片表面的不平整,对后期工艺过程中的光刻、刻蚀、金属化等工艺过程会产生影响。
些杂质,虽然分凝作用使杂质进人SlC l~,,但进氧化膜的杂质又很快地通过氧化膜扩散掉,如铝、镓、铟就是这种情况。这样的杂质和轻掺杂一样,并不显示出加速氧化的作用。在氧化过程中,⒊/SiO2界面情况比较复杂,目前尚属并不完全理解的区域,在高浓度下这个问题就更加复杂。为了解释掺杂浓度高对氧化速率的加强,有人还提出了一个称之为费米能级移动效应的理论模型,那就是在高掺杂的情况下,费米能级会移动使半导体中空位浓度增加。空位浓度的增加使氧化剂的扩散系数增加,同时这些点缺陷也能提供使Sl变成sOz的化学反应的反应位置,从而使氧化反应速率增加。
图417所示是掺磷硅在湿氧氧化时的氧化层厚度与温度、掺杂浓度的关系。高温下M1TSVB1SHI磷的分凝效应显著,大部分杂质被分凝到硅中,氧化膜中磷杂质不足以引起加强氧化。而在较低温度下,分凝作用减弱,氧化膜中磷含量随掺杂浓度的增加而升高,因此氧化速率增加。 掺杂浓度对氧化速率的影响一般在高浓度下(如大于101l菠°ms/cm3)才明显,低浓度时可不必考虑。如图⒋18为900℃时干氧氧化的速率常数与掺磷浓度的关系,可见B/A在高浓度时基本上随 浓度增加而增加,这时氧化受界面处反应速率控制。
相对来讲与浓度关系不大,它反映了氧化速率受氧化剂通过氧化膜的扩散限制。
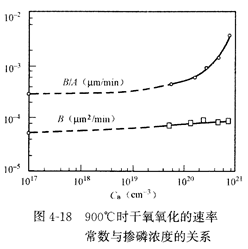
19所示为氧化层在不同掺杂浓度下的生长厚度差异的示意图。这一差异造成芯片表面的不平整,对后期工艺过程中的光刻、刻蚀、金属化等工艺过程会产生影响。
些杂质,虽然分凝作用使杂质进人SlC l~,,但进氧化膜的杂质又很快地通过氧化膜扩散掉,如铝、镓、铟就是这种情况。这样的杂质和轻掺杂一样,并不显示出加速氧化的作用。在氧化过程中,⒊/SiO2界面情况比较复杂,目前尚属并不完全理解的区域,在高浓度下这个问题就更加复杂。为了解释掺杂浓度高对氧化速率的加强,有人还提出了一个称之为费米能级移动效应的理论模型,那就是在高掺杂的情况下,费米能级会移动使半导体中空位浓度增加。空位浓度的增加使氧化剂的扩散系数增加,同时这些点缺陷也能提供使Sl变成sOz的化学反应的反应位置,从而使氧化反应速率增加。
上一篇:钠等杂质
 热门点击
热门点击
- 距离平方反比定律
- MTF与光学系统的分辨率
- 风云四号(FY-4)卫星
- 表面浓度的数值基本上就是扩散温度下杂质在硅中
- 掺磷硅在湿氧氧化时的氧化层厚度与温度、掺杂浓
- 大气密度
- 真空( vacuum)也是在半导体工艺中要遇
- 针栅阵列是一种专为更大的芯片设计的封装形式
- 用高压气体节流效应制冷
- 虽然Hgcdte材料相对于以往的红外探测器材
 推荐技术资料
推荐技术资料
- 自制智能型ICL7135
- 表头使ff11CL7135作为ADC,ICL7135是... [详细]


 公网安备44030402000607
公网安备44030402000607





