一气体供给系统
发布时间:2016/11/4 21:23:00 访问次数:541
MOCVD系统的外延生长是在常压或低压的冷壁反应器中进行,利用高纯的氢气或高纯氮气作为载气, H9TP32A4GDBCPR-KGM将金属有机前驱物蒸气和气态的非金属氢化物送入反应器中,然后两种前驱物在加热的衬底(衬底基片一般放置于石墨基座上)表面进行化学反应,形成外延层的原子沉积,并按一定的晶体结构排列形成外延薄膜。外延薄膜的组成和生长速率可以通过精确地控制气体流量及衬底温度来实现。常用的Ⅲ族金属有机化合物包括三甲基镓、三甲基铝、三甲基铟或其混合物,一般在常温下为液态存在。以GaAs外延生长为例,三甲
基镓和AsH3作为为原料,反应方程式如下:
GatCH3)3(gl+AsH3(g)-’GaAs6)+3CH4(g)
作为反应副产物的CH4往往会导致GaAs外延薄膜掺杂碳,这也取决于反应原料的摩尔比(V族/III族)和反应温度。以两种或两种以上Ⅲ族金属有机化合物为原料可以制备可以在相应的衬底上生长Ⅲ-V族合金半导体化合物外延薄膜,如G‰In1~As和G‰In【~P。 MOCVD系统主要包括气体处理系统(反应气的供给和传输)、反应室和尾气处理系统,其典型的实验装置如图5-12所示。MOCVD系统最关键的问题是保证外延材料生长的均匀性和重复性,需要精确控制不同组分气体的流量和温度。
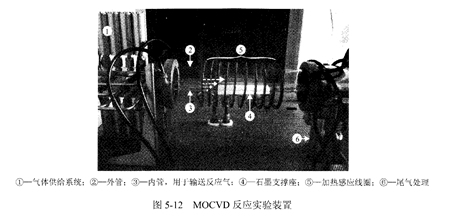
MOCVD系统的外延生长是在常压或低压的冷壁反应器中进行,利用高纯的氢气或高纯氮气作为载气, H9TP32A4GDBCPR-KGM将金属有机前驱物蒸气和气态的非金属氢化物送入反应器中,然后两种前驱物在加热的衬底(衬底基片一般放置于石墨基座上)表面进行化学反应,形成外延层的原子沉积,并按一定的晶体结构排列形成外延薄膜。外延薄膜的组成和生长速率可以通过精确地控制气体流量及衬底温度来实现。常用的Ⅲ族金属有机化合物包括三甲基镓、三甲基铝、三甲基铟或其混合物,一般在常温下为液态存在。以GaAs外延生长为例,三甲
基镓和AsH3作为为原料,反应方程式如下:
GatCH3)3(gl+AsH3(g)-’GaAs6)+3CH4(g)
作为反应副产物的CH4往往会导致GaAs外延薄膜掺杂碳,这也取决于反应原料的摩尔比(V族/III族)和反应温度。以两种或两种以上Ⅲ族金属有机化合物为原料可以制备可以在相应的衬底上生长Ⅲ-V族合金半导体化合物外延薄膜,如G‰In1~As和G‰In【~P。 MOCVD系统主要包括气体处理系统(反应气的供给和传输)、反应室和尾气处理系统,其典型的实验装置如图5-12所示。MOCVD系统最关键的问题是保证外延材料生长的均匀性和重复性,需要精确控制不同组分气体的流量和温度。
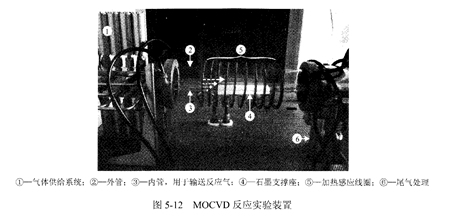
上一篇:反应方程式如下
上一篇:气体供给系统前驱体反应气



 公网安备44030402000607
公网安备44030402000607





