封 装
发布时间:2015/11/14 16:40:11 访问次数:659
晶圆电测后,每个芯片IR3094MTR仍是晶圆整体中的一部分。在应用于电路或电子产品之前,单个芯片必须从晶圆整体中分离出来,多数情况下,被置人一个保护性管壳中(见图18.1).随着芯片器件密度…直增大,它们的封装和封装工艺也有所改进。对于分立式器件单个管壳典型的是“罐式”( can),而对于单个的集成电路是直插式封装。但是正在爆发的移动终端已经要求多个电路功能在一个单芯片上( SoC),还要将单芯片以三维排列堆叠在同一个管壳内。这类封装方案有些与传统的罐式硬壳方式和直插包封方式相去甚远。
这些芯片也可以直接安装在陶瓷衬底的表面作为混合电路的一部分,或与其他芯片一起安装到一个大型管壳中,作为多芯片模块( MCM)的一部分,或是直接安装在印制电路板上,或是做成“板上芯片”( COB)或直接贴芯片(DCA)(见图18.1)。这3种封装形式有一些共同的工艺。除了保护芯片、封装工艺提供和系统的电连接,可以使芯片集成到一个电子系统中,并提供环境保护和散热。这一系列工艺被称为封装( packaging)、组装(assembly)或后端( back-end)工序,,在封装工艺中,芯片被称为“dies”或“dice“。
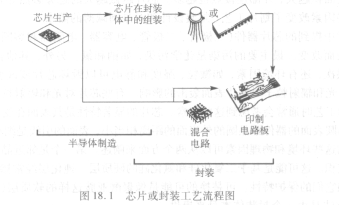
晶圆电测后,每个芯片IR3094MTR仍是晶圆整体中的一部分。在应用于电路或电子产品之前,单个芯片必须从晶圆整体中分离出来,多数情况下,被置人一个保护性管壳中(见图18.1).随着芯片器件密度…直增大,它们的封装和封装工艺也有所改进。对于分立式器件单个管壳典型的是“罐式”( can),而对于单个的集成电路是直插式封装。但是正在爆发的移动终端已经要求多个电路功能在一个单芯片上( SoC),还要将单芯片以三维排列堆叠在同一个管壳内。这类封装方案有些与传统的罐式硬壳方式和直插包封方式相去甚远。
这些芯片也可以直接安装在陶瓷衬底的表面作为混合电路的一部分,或与其他芯片一起安装到一个大型管壳中,作为多芯片模块( MCM)的一部分,或是直接安装在印制电路板上,或是做成“板上芯片”( COB)或直接贴芯片(DCA)(见图18.1)。这3种封装形式有一些共同的工艺。除了保护芯片、封装工艺提供和系统的电连接,可以使芯片集成到一个电子系统中,并提供环境保护和散热。这一系列工艺被称为封装( packaging)、组装(assembly)或后端( back-end)工序,,在封装工艺中,芯片被称为“dies”或“dice“。
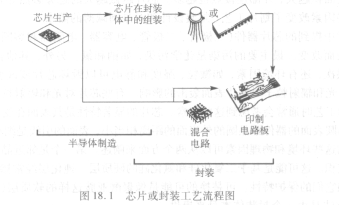
上一篇:冗余电路




 公网安备44030402000607
公网安备44030402000607





