水平对流热传导LPCVD
发布时间:2015/11/7 22:10:56 访问次数:447
一种应用于生产的LPCVD系统中采用水平炉管式反应炉(见图12. 18),GD-G M346GD02具有三个特殊性:首先,反应管与真空泵连接,将系统的压为降 压力至0. 25~2.0托-6。;其次,中心区域的温度沿炉管传感器倾斜以补偿气体的反应损耗;第三,在气体注入端配置了特殊的气体注入口,以改善气体的混合和淀积的均匀性。在一些系统中,注入器直接安装在晶圆的上方。这类系统设计的不足之处在于,微粒会在墙体的内表面形成(热壁反应),气流的均匀程度沿着炉管的方向变化、、在晶圆的周围设置栅形装置町降低微粒污染,但由于经常清洗将引起较长的停机时间。
这类系统广泛应用于多晶硅、氧化物和氮化物的淀积。典型的厚度均匀性达到±5%。此类系统的主要淀积参数是温度、压力、气体流量、气相气体人口压力和晶圆间距。对每一种淀积工艺,均需要仔细调整这些参数及参数间的平衡。该系统的淀积率与AP系统相比,低于100~soo Armin,但由于采用垂直装载密度,生产效率明显提高。每次淀积的晶圆数可接近200片。
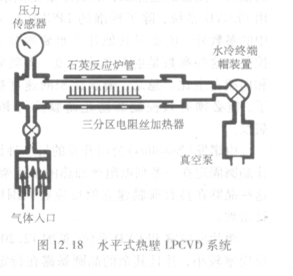
一种应用于生产的LPCVD系统中采用水平炉管式反应炉(见图12. 18),GD-G M346GD02具有三个特殊性:首先,反应管与真空泵连接,将系统的压为降 压力至0. 25~2.0托-6。;其次,中心区域的温度沿炉管传感器倾斜以补偿气体的反应损耗;第三,在气体注入端配置了特殊的气体注入口,以改善气体的混合和淀积的均匀性。在一些系统中,注入器直接安装在晶圆的上方。这类系统设计的不足之处在于,微粒会在墙体的内表面形成(热壁反应),气流的均匀程度沿着炉管的方向变化、、在晶圆的周围设置栅形装置町降低微粒污染,但由于经常清洗将引起较长的停机时间。
这类系统广泛应用于多晶硅、氧化物和氮化物的淀积。典型的厚度均匀性达到±5%。此类系统的主要淀积参数是温度、压力、气体流量、气相气体人口压力和晶圆间距。对每一种淀积工艺,均需要仔细调整这些参数及参数间的平衡。该系统的淀积率与AP系统相比,低于100~soo Armin,但由于采用垂直装载密度,生产效率明显提高。每次淀积的晶圆数可接近200片。
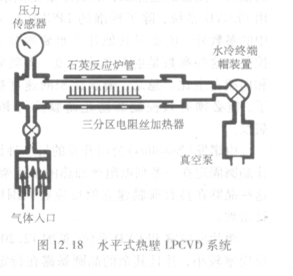
上一篇:连续传导加热APCVD
上一篇:超高真空CVD
 热门点击
热门点击


 公网安备44030402000607
公网安备44030402000607





