漏极附近电场强度的增加是引发沟道热载流子效应的原因
发布时间:2015/6/23 19:16:31 访问次数:2602
漏极附近电场强度的增加是引发沟道热载流子效应的原因,因此,要减轻漏极附近的场强,AD8361ARMZ比较有效的措施是采用轻掺杂源一漏(Lightly Doped Drain-Source,LDDS)结构,使雪崩注入区向硅衬底下移,离开栅界面处,其情况如图4. 11所示。
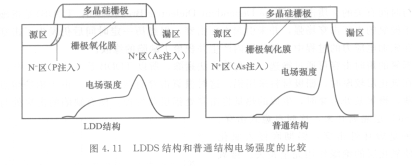
图4. 11 LDDS结构和普通结构电场强度的比较
对深亚微米器件,还可采用P-I-N漏MOSFET结构来抑制热载流子效应,所谓P-I-N漏结构是在常规沟道区的源一漏端赴降低掺杂浓度至接近本征的lois/cn3~l016/Cm3(N沟道仍为P区),可进一步降低近漏端电场强度。
此外,工作时限制V DS及VBS的大小,也可改善热载流子效应。
在MOS器件及IC中,栅极下面存在一薄层Si0。,即通称的栅氧(化层)。栅氧的漏电与栅氧质量关系极大,漏电增加到一定程度即可构成击穿,导致器件失效。
当前由于VLSI技术的进步,一方面器件尺寸在不断缩小,要求栅氧厚度不断减薄,但电源电压并不能随之按比例减小,栅介质所承受的电场强度在不断增加。例如,原来64k位DRAM,栅氧厚度40nm,电源电压为5V,栅氧场强为1.25MV/cm。1M位
DRAM栅氧厚lOnm,内部电压降至2.5V,场强为2.5MV/cm。目前64M位DRAM,栅氧厚度仅为7nm,电压降为3.3V,器件内部不降压时场强将达到4.7MV/cm。这对栅氧质量及厚度的均匀性都提出了严格要求,以保证栅氧有一定寿命。另一方面,随着IC集成度的提高,电路功能的扩大,可将一个系统集成在一块芯片上,芯片面积不断扩大,相应地芯片上栅氧总面积增大,存在缺陷的概率增加,加上受到高电场作用,栅氧发生击穿的地方增多,可靠性问题变得严重。
漏极附近电场强度的增加是引发沟道热载流子效应的原因,因此,要减轻漏极附近的场强,AD8361ARMZ比较有效的措施是采用轻掺杂源一漏(Lightly Doped Drain-Source,LDDS)结构,使雪崩注入区向硅衬底下移,离开栅界面处,其情况如图4. 11所示。
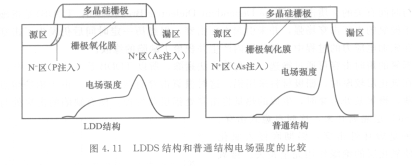
图4. 11 LDDS结构和普通结构电场强度的比较
对深亚微米器件,还可采用P-I-N漏MOSFET结构来抑制热载流子效应,所谓P-I-N漏结构是在常规沟道区的源一漏端赴降低掺杂浓度至接近本征的lois/cn3~l016/Cm3(N沟道仍为P区),可进一步降低近漏端电场强度。
此外,工作时限制V DS及VBS的大小,也可改善热载流子效应。
在MOS器件及IC中,栅极下面存在一薄层Si0。,即通称的栅氧(化层)。栅氧的漏电与栅氧质量关系极大,漏电增加到一定程度即可构成击穿,导致器件失效。
当前由于VLSI技术的进步,一方面器件尺寸在不断缩小,要求栅氧厚度不断减薄,但电源电压并不能随之按比例减小,栅介质所承受的电场强度在不断增加。例如,原来64k位DRAM,栅氧厚度40nm,电源电压为5V,栅氧场强为1.25MV/cm。1M位
DRAM栅氧厚lOnm,内部电压降至2.5V,场强为2.5MV/cm。目前64M位DRAM,栅氧厚度仅为7nm,电压降为3.3V,器件内部不降压时场强将达到4.7MV/cm。这对栅氧质量及厚度的均匀性都提出了严格要求,以保证栅氧有一定寿命。另一方面,随着IC集成度的提高,电路功能的扩大,可将一个系统集成在一块芯片上,芯片面积不断扩大,相应地芯片上栅氧总面积增大,存在缺陷的概率增加,加上受到高电场作用,栅氧发生击穿的地方增多,可靠性问题变得严重。


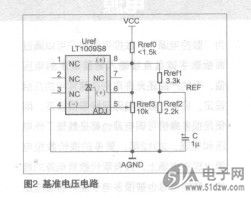
 公网安备44030402000607
公网安备44030402000607





