SMT与IC、SMT与高密度封装技术
发布时间:2014/5/19 18:25:53 访问次数:1366
SMT与IC、SMT与高密度封装技术、SMT与PCB制造技术相结合推动封装技术从2D向3D发展,向模块化、系统化发展目前,元器件尺寸已日益面临极限,PCB设计、PCB加工难度及自动印刷机、贴装机精度也趋于极限。ZXSC310E5TA但是在信息时代里,无法阻止人们对通信设备,特别是便携电子设备提出更薄、更轻及无正境的多功能、高性能等要求。为了满足电子产品多功能、小型化要求,在提高lC集成度的基础上,目前已研制出复合化片式无源元件;将上百个无源元件和有源器件集成到一个封装内,组成.个功能系统;25~15 ym薄芯片技术和薄型封装层叠技术组成三维立体组件。目前已经有3芯片、8芯片、10芯片堆叠模块,三维晶圆级堆叠正处在研发阶段。SMD封装技术从二维向三维发展。另外,SOC单片系统、微电子机械系统MEMS等新型封装器件也在开发应用。表1-7概括了传统与新型元器件封装形式。
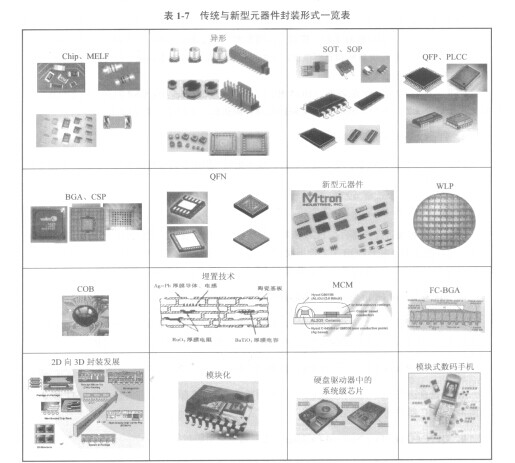
SMT与高密度封装技术、SMT与PCB制造技术相结合的新型模块化组件、系统化组件具有体积明显缩小,提高频率特性和散热性,提高可靠性,增加电子产品的使用寿命,提高SMT生产效率、组装质量,降诋组装、检测难度和SMT制造加工成本等优点。
总之,模块化、系统化推动SMT向更简单、更优化、低成本、高速度、高可靠方向发展,推动电子产品走向更高级、更经济、更可靠的方向发展。
思考题
1.简述表面组装元器件( SMC/SMD)的定义。
2.简述表面组装元件( SMC)和表面组装器件(SMD)的发展趋势。
3.简述SMT对表面组装元器件的基本要求。
4.简述表面组装电阻器、电容器标称值及误差表示方法。常用表面组装器件的外形封装名
SMT与IC、SMT与高密度封装技术、SMT与PCB制造技术相结合推动封装技术从2D向3D发展,向模块化、系统化发展目前,元器件尺寸已日益面临极限,PCB设计、PCB加工难度及自动印刷机、贴装机精度也趋于极限。ZXSC310E5TA但是在信息时代里,无法阻止人们对通信设备,特别是便携电子设备提出更薄、更轻及无正境的多功能、高性能等要求。为了满足电子产品多功能、小型化要求,在提高lC集成度的基础上,目前已研制出复合化片式无源元件;将上百个无源元件和有源器件集成到一个封装内,组成.个功能系统;25~15 ym薄芯片技术和薄型封装层叠技术组成三维立体组件。目前已经有3芯片、8芯片、10芯片堆叠模块,三维晶圆级堆叠正处在研发阶段。SMD封装技术从二维向三维发展。另外,SOC单片系统、微电子机械系统MEMS等新型封装器件也在开发应用。表1-7概括了传统与新型元器件封装形式。
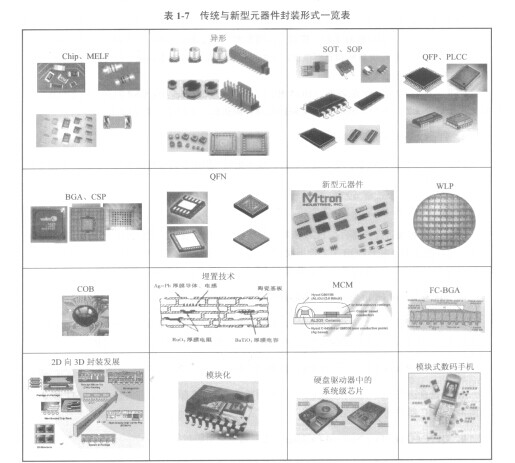
SMT与高密度封装技术、SMT与PCB制造技术相结合的新型模块化组件、系统化组件具有体积明显缩小,提高频率特性和散热性,提高可靠性,增加电子产品的使用寿命,提高SMT生产效率、组装质量,降诋组装、检测难度和SMT制造加工成本等优点。
总之,模块化、系统化推动SMT向更简单、更优化、低成本、高速度、高可靠方向发展,推动电子产品走向更高级、更经济、更可靠的方向发展。
思考题
1.简述表面组装元器件( SMC/SMD)的定义。
2.简述表面组装元件( SMC)和表面组装器件(SMD)的发展趋势。
3.简述SMT对表面组装元器件的基本要求。
4.简述表面组装电阻器、电容器标称值及误差表示方法。常用表面组装器件的外形封装名
上一篇:各种印制电路板
 热门点击
热门点击
- PCB的元器件贴装位置有偏移,可用以下两种方
- 三极管的极限参数有集电极最大允许电流
- Sn-Ag-Cu三元合金
- 人体模型
- 焊点形成过程
- 电感性负载
- 电气规则检查
- PCB定位孔和夹持边的设置
- 由555时基电路组成的开关电源
- 冷焊、锡球熔化不完全
 推荐技术资料
推荐技术资料
- DS2202型示波器试用
- 说起数字示波器,普源算是国内的老牌子了,FQP8N60... [详细]



 公网安备44030402000607
公网安备44030402000607





