薄型小外形封装焊盘设计
发布时间:2014/5/6 21:05:32 访问次数:897
TSOP (Thin SmallOutline Packages)薄型小外形封装焊盘设计
TSOP是薄型小外形封装,R2J10160GC-A00FPX2RF0其元件参数如下。
引脚间距:0.65mm、0.5mm、0.4mm、0.3rnm,属于窄间距(Fine Pitch)范畴。
封装体尺寸有4种规格:短端(A)有6mm、8mm、lOmm、12mm,长端(三)有14mm、16mm、18mm. 20mm。
元件高度(H):1.27mm。
引脚数:有16种(16~76)。
封装名称表示方法:TSOP引脚数,如TSOP 8x20 52。
设计时需要考虑以下内容。
①所有的TSOP封装都存在公英制累积误差。
②为了避免回流焊时产生桥接,应优选椭圆形焊盘形状。
③焊盘外侧间距:2=/+0.8 (mm)(其中,三为元件长度方向公称尺寸)。
④单个焊盘长×宽( YxX)设计:见表5-7。
⑤验证焊盘内侧距离:G<S-0.3~0.6mm。
CFP(Ceramic Flat Packages)陶瓷扁平封装焊盘设计
CFP是陶瓷体扁平封装,其特点是不吸潮、耐260℃离温,适用于军品和高可靠性产品。在组装前,需要对其引脚进行预成型。CFP元件参数如下。
引脚间距:1.27mm。
引脚数:有10种(10~50)。
元件高度(H):有两种(2.5mm、3.Omm)。
封装体宽度有7种规格:5.08mm、7.62mm、10.16mm、12.70mm、15.24mm、17.78mm、22.86mm。
封装名称表示方法:CFP引脚数,如CFP10、CFP28等。
建议采用椭圆形焊盘,单个焊盘的尺寸:舣Y=0.65mmx 2.2mm。
SOP单个焊盘设计总结(见表5-7)
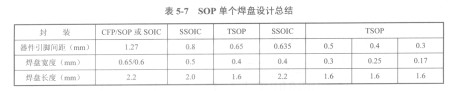
TSOP (Thin SmallOutline Packages)薄型小外形封装焊盘设计
TSOP是薄型小外形封装,R2J10160GC-A00F2RF0其元件参数如下。
引脚间距:0.65mm、0.5mm、0.4mm、0.3rnm,属于窄间距(Fine Pitch)范畴。
封装体尺寸有4种规格:短端(A)有6mm、8mm、lOmm、12mm,长端(三)有14mm、16mm、18mm. 20mm。
元件高度(H):1.27mm。
引脚数:有16种(16~76)。
封装名称表示方法:TSOP引脚数,如TSOP 8x20 52。
设计时需要考虑以下内容。
①所有的TSOP封装都存在公英制累积误差。
②为了避免回流焊时产生桥接,应优选椭圆形焊盘形状。
③焊盘外侧间距:2=/+0.8 (mm)(其中,三为元件长度方向公称尺寸)。
④单个焊盘长×宽( YxX)设计:见表5-7。
⑤验证焊盘内侧距离:G<S-0.3~0.6mm。
CFP(Ceramic Flat Packages)陶瓷扁平封装焊盘设计
CFP是陶瓷体扁平封装,其特点是不吸潮、耐260℃离温,适用于军品和高可靠性产品。在组装前,需要对其引脚进行预成型。CFP元件参数如下。
引脚间距:1.27mm。
引脚数:有10种(10~50)。
元件高度(H):有两种(2.5mm、3.Omm)。
封装体宽度有7种规格:5.08mm、7.62mm、10.16mm、12.70mm、15.24mm、17.78mm、22.86mm。
封装名称表示方法:CFP引脚数,如CFP10、CFP28等。
建议采用椭圆形焊盘,单个焊盘的尺寸:舣Y=0.65mmx 2.2mm。
SOP单个焊盘设计总结(见表5-7)
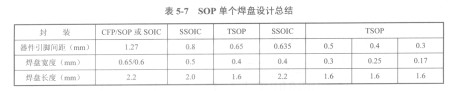
上一篇:字电路接地
 热门点击
热门点击
- 工艺流程的设计原则
- 功率晶体管的开关作用
- PQFP (Plastic Quad Fl
- 电子系统中静电放电感应效应可分为以下三类
- 铬在焊料中的作用
- 在近场金属屏蔽层磁衰减实验数据
- SMC/SMD的焊端结构
- 选择性屏蔽示例
- 静电测量仪器
- 贴装头
 推荐技术资料
推荐技术资料
- FU-19推挽功放制作
- FU-19是国产大功率发射双四极功率电二管,EPL20... [详细]

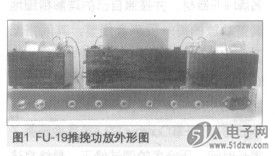
 公网安备44030402000607
公网安备44030402000607





