球形格栅阵排列封装
发布时间:2012/8/4 12:55:29 访问次数:1207
球形格栅阵排C2012Y5V0J106Z列封装(Ball Grid Array,BGA)是大规模集成电路的一种极富生命力的新型封装方法,它将原来器件PLCC的J形封装和QFP翼形封装的电极引脚改变成球形引脚,把从器件本体四周“单线性”序列引出的电极改变成体腹之下“全平面”式的格栅阵排列。这样,既可以增大引脚间距,又能够增加引脚数目。
按封装材料的不同,BGA封装主要分为以下几种:PBGA(Plastic BGA,塑料封装的BGA), CBGA(Ceramic BGA,陶瓷封装的BGA),CCBGA(Ceramic Column BGA,陶瓷柱状封装的BGA),TBGA(Tape BGA,载带状封装的BGA),CSP(Chip Scale Package或UBGA)。
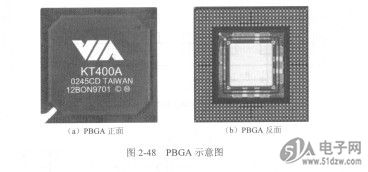
PBGA是目前使用较多的BGA,如图2-48所示。它使用63Sn/37Pb成分的焊锡球,焊锡的熔化温度约为183℃。焊锡球直径在焊接前直径为0.75mm,再流焊以后,焊锡球直径减至0.46~0.41mm。PBGA的优点是成本较低,容易加工。不过应该注意,由于采用塑料封装,容易吸潮。
CBGA焊球的成分为90Pb/lOSn,它与PCB连接处的焊锡成分仍为63Sn/37Pb。CBGA的焊锡球高度比PBGA高,因此它的焊锡熔化温度比PBGA高,不容易吸潮,且封装更牢靠。CBGA芯片底部焊点直径要比PCB上的焊盘大,拆除CBGA芯片后,焊锡不会黏在
PCB的焊盘上。
CCBGA的焊锡柱直径为0.51mm,高度为2.2mm,焊锡柱间距一般为1.27mm,焊锡柱的成分是90Pb/lOSn。
TBGA的焊锡球直径为0.76mm,球间距为1.27mm。与CBGA相比,TBGA对环境温度要求控制严格,因芯片受热时,热张力集中在4个角,焊接时容易产生缺陷。
CSP芯片的封装尺寸仅略大于裸芯片尺寸,但不超过20%,这是CSP与BGA的主要区别。CSP与BGA相比,除了体积小之外,还有更短昀导电通路、更低的电抗性,更容易达到500~600MHz的频率范围。
球形格栅阵排C2012Y5V0J106Z列封装(Ball Grid Array,BGA)是大规模集成电路的一种极富生命力的新型封装方法,它将原来器件PLCC的J形封装和QFP翼形封装的电极引脚改变成球形引脚,把从器件本体四周“单线性”序列引出的电极改变成体腹之下“全平面”式的格栅阵排列。这样,既可以增大引脚间距,又能够增加引脚数目。
按封装材料的不同,BGA封装主要分为以下几种:PBGA(Plastic BGA,塑料封装的BGA), CBGA(Ceramic BGA,陶瓷封装的BGA),CCBGA(Ceramic Column BGA,陶瓷柱状封装的BGA),TBGA(Tape BGA,载带状封装的BGA),CSP(Chip Scale Package或UBGA)。
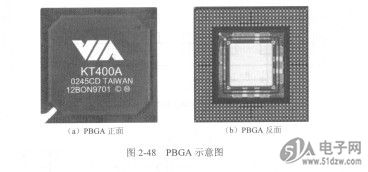
PBGA是目前使用较多的BGA,如图2-48所示。它使用63Sn/37Pb成分的焊锡球,焊锡的熔化温度约为183℃。焊锡球直径在焊接前直径为0.75mm,再流焊以后,焊锡球直径减至0.46~0.41mm。PBGA的优点是成本较低,容易加工。不过应该注意,由于采用塑料封装,容易吸潮。
CBGA焊球的成分为90Pb/lOSn,它与PCB连接处的焊锡成分仍为63Sn/37Pb。CBGA的焊锡球高度比PBGA高,因此它的焊锡熔化温度比PBGA高,不容易吸潮,且封装更牢靠。CBGA芯片底部焊点直径要比PCB上的焊盘大,拆除CBGA芯片后,焊锡不会黏在
PCB的焊盘上。
CCBGA的焊锡柱直径为0.51mm,高度为2.2mm,焊锡柱间距一般为1.27mm,焊锡柱的成分是90Pb/lOSn。
TBGA的焊锡球直径为0.76mm,球间距为1.27mm。与CBGA相比,TBGA对环境温度要求控制严格,因芯片受热时,热张力集中在4个角,焊接时容易产生缺陷。
CSP芯片的封装尺寸仅略大于裸芯片尺寸,但不超过20%,这是CSP与BGA的主要区别。CSP与BGA相比,除了体积小之外,还有更短昀导电通路、更低的电抗性,更容易达到500~600MHz的频率范围。
上一篇:方形扁平封装
上一篇:表面组装元器件的包装



 公网安备44030402000607
公网安备44030402000607





